
文章链接:https://www.nature.com/articles/s41928-024-01269-y
亮点:
1.使用范德华金属材料:通过采用石墨烯或铂二碲化物作为阴极,研究者们实现了具有高开关比的模拟记忆电阻器,克服了传统材料的局限性。
2.调节离子运动的策略:不同于以往通过改变电阻开关层或阳极的方式,我们的方法依赖于范德华阴极的插层/去插层特性,有效提高了开关比。
3.高开关比以及多导电状态与低功耗:该记忆电阻器开关闭高达10⁸,实现了超过8位的导电状态,并在阿托焦耳级别的功耗下运行,展现了优越的性能。
摘要
基于记忆电阻器的类脑计算能够满足人工智能等数据密集型计算应用日益增长的需求。具有多种导电状态的模拟记忆电阻器在高效能类脑计算中尤其重要,但其权重映射能力通常受到较小开关比的限制。在这里,我们展示了使用二维范德华金属材料(如石墨烯或铂二碲化物)作为阴极,可以创建具有模拟电阻开关和大开关比的记忆电阻器。这些记忆电阻器使用银作为上电极,以磷化铟硫作为开关介质。以往的方法主要集中在通过改变电阻开关层或阳极来调节离子运动,这可能会降低开关比。相比之下,我们的方法依赖于范德华阴极,允许银离子的插层/去插层,从而创建一个高扩散势垒以调节离子运动。该策略可以实现模拟电阻开关,开关比高达10⁸,超过8位导电状态,并具有阿托焦耳级别的功耗。我们利用这种模拟特性进行卷积神经网络的芯片级模拟,提供高识别精度。
研究背景和主要内容
人工智能应用的增长正在突破基于传统冯·诺依曼架构的数字计算的极限。神经形态计算是一种很有前途的替代方案,可以高速高效地执行数据密集型计算。忆阻器通常用于创建神经形态硬件,因为它们可以实现内存和模拟计算。具有多个存储级别的模拟忆阻器是高效神经形态计算的理想选择,而高开/关比则可以实现高精度和权重映射能力,是实现高精度所必需的。然而,大多数模拟忆阻器的开/关比仅为 20 以下,这限制了电导状态的数量。
两种主要的纳米离子忆阻器是价态变化机制 (VCM) 忆阻器和电化学金属化 (ECM) 忆阻器。VCM 忆阻器依赖于阴离子(通常是氧离子)的迁移,具有更模拟电阻开关 (RS) 特性。然而,它们表现出较窄的开/关比和较高的关断电流,导致高功耗。ECM忆阻器通常使用银 (Ag) 作为活性阳极和惰性金属作为阴极,依靠金属离子迁移来形成或断裂导电丝。与VCM忆阻器相比,由于金属离子的高电化学活性和快速的离子迁移过程,ECM 忆阻器表现出更高的开/关比、更低的开关电压、更快的开关速度和更低的功耗。然而,这种移动性会导致低电阻状态 (LRS) 和高电阻状态 (HRS) 之间的突然切换。因此,ECM 忆阻器通常表现出类似数字的 RS 行为和非线性权重更新。
调节ECM 忆阻器中的离子迁移率和氧化还原速率可用于调节 RS 行为,因为它们会影响细丝生长和断裂动力学。因此,已经探索了几种这样的方法来改善模拟特性 。一种方法是插入具有低离子迁移率的切换介质屏障层以引入慢动力学因子( SKF )来限制金属离子的运动。然后,插入层可以充当储存器,而原始层可以充当切换层。调节 ECM 忆阻器中 RS 行为的另一种方法是结合氧空位来创建混合细丝,或者使用活性较低的阳极/金属离子(如合金阳极或钛离子)作为 SKF 。然而
,这些方法通常会导致残留细丝或引入缺陷,导致电导增加和开/关比变差。因此,设计用于模拟切换的 ECM 忆阻器的开/关比通常约为 20,类似于 VCM 忆阻器 。因此,在这种系统中,开/关比和模拟切换之间似乎存在权衡,即高开/关比伴随着类似数字的切换,而模拟切换会导致较小的开/关比。
在本文中,我们通过在阴极引入 SKF 来报告具有大开/关比的低功耗模拟忆阻器。我们采用离子嵌入/脱嵌策略,其中二维 (2D) 范德华 (vdW) 金属材料(石墨烯 (GR) 或铂二碲化物 (PtTe2 ))作为底部阴极,Ag 作为顶部阳极,铟磷硫化物 (IPS) 作为开关介质。在 SET/RESET 操作下,来自阳极的银离子可以迁移通过开关介质,也可以从 vdW 电极插入/脱嵌。阴极中的嵌入/脱嵌过程引入了额外的高扩散屏障以限制 Ag 离子迁移,从而调节开关过程并触发更模拟和线性的开关行为。但是,与具有金底部电极(Ag/IPS/Au)的数字忆阻器相比,该方法提供相似的开/关比。因此,我们的忆阻器表现出高达108 的开/关比、超过8位的电导状态、56 aJ的低功耗以及合理的线性度和对称性等模拟开关性能。基于我们的忆阻突触的特性,我们对具有高图像识别精度的卷积神经网络(CNN)进行了芯片级模拟。
利用二维范德华金属阴极进行模拟切换
通常,在 ECM 忆阻器中,活性金属(如银或铜)用作顶部电极以及迁移离子源,而惰性金属(如金、铂或钨)用作底部电极和离子阻挡层。 这里,我们首先制作一个典型的 ECM 忆阻器,其中顶部阳极、底部阴极和开关介质分别为银、金和 In2P3S9 (IPS)(即 Ag/IPS/Au;补充图1a)。 在执行 SET 和 RESET 操作时,银导电丝将形成并完全断裂(图1a)。 这会导致典型的突然 SET 和 RESET 过程,如电流-电压(I - V)曲线所示(图1b )。 尽管具有约 6 × 10 8的大开/关比,但类似数字的 RS 行为使其难以实现多级切换(补充图3)。为了提高模拟能力,通常使用诸如插入阻挡层或引入活性较低的移动物质(例如氧空位或 Ti 离子)等方法作为 SKF 来限制离子运动。如图1c、d所示,当使用 Ti 离子作为移动物质(即 Ti/IPS/Au 忆阻器)时,出现了模拟开关。然而,Ti 离子的低迁移率可能会引入大量残留细丝,导致电导率大大增加,同时开/关比降低至约 20。在已报道的使用 Ti 作为阳极的金属磷三硫族化物基忆阻器中也发现了类似的现象。
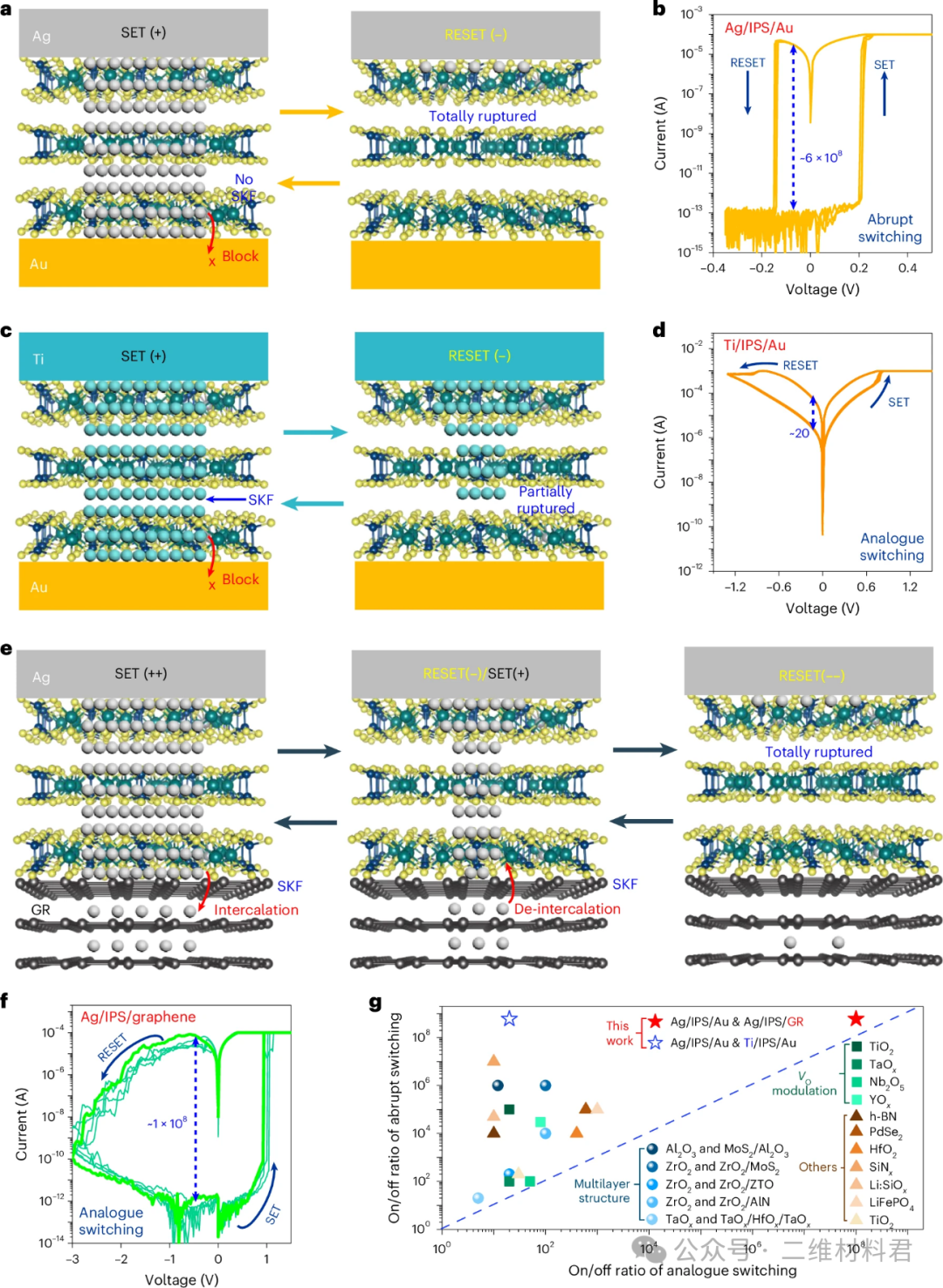
图 1:使用 vdW 金属 GR 作为阴极的具有大开/关比的模拟开关。a、Ag/IPS/Au 忆阻器中的 SET 和 RESET 过程示意图,其中导电丝完全断裂。x 表示被 Au 电极阻挡的离子。b 、具有突然 SET/RESET 过程的Ag/IPS/Au 忆阻器的I - V曲线。c 、 Ti/IPS/Au 忆阻器中的模拟 SET 和 RESET 过程示意图,其中 Ti 离子是移动物质。x 表示被 Au 电极阻挡的离子。d 、具有模拟开关和较小开/关比的 Ti/IPS/Au 忆阻器的 I-V 曲线。e 、Ag/IPS/GR 忆阻器中处于中间状态的 SET 和 RESET 过程示意图。GR 中的嵌入/脱嵌过程充当 SKF。f,具有模拟开关和大开/关比的 Ag/IPS/GR 忆阻器的I - V曲线
。g,基准图,将报告的方法与我们的模拟忆阻器策略进行比较。补充表1提供了详细的参考资料。在重复的I - V循环之前,Au 和 GR 忆阻器都需要进行电铸工艺(补充图2)。
相比之下,这里通过使用 2D vdW 金属 GR 代替 Au 作为底部阴极(即 Ag/IPS/GR 忆阻器)实现了具有大开/关比的模拟切换过程。其结构如补充图1b所示。众所周知,2D 层状材料允许插入各种外来物质,例如原子、离子和分子。它促进了不同的应用,其中层状材料用作可充电电池中的阴极和忆阻设备中的开关介质与会阻止离子渗透到忆阻器中的传统惰性阴极不同,金属 vdW 阴极允许 Ag 离子渗透,并被证明可在 ECM 细胞中获得模拟 RS 行为。超高的扩散屏障会诱导少量可逆的 Ag 嵌入/脱嵌(图1e ),这可以调节细丝的形成/断裂,以实现更模拟的 RS 行为(图1f)。详细机理将在后面讨论。值得注意的是,随着电压的增加,RESET 过程比 SET 过程更加平缓,这表明嵌入/脱嵌过程对 RESET 过程的影响更大。更重要的是,Ag/IPS/GR 忆阻器在 HRS 处表现出相似的电阻,并且与突变的 Ag/IPS/Au 忆阻器具有相当的约 10 8的开/关比。此外,HRS 和 LRS 处的电阻在不同温度下表现出良好的保持力, 在室温下可以保持超过 10 4 s 而没有明显的下降(补充图4 )。此外,无论批次、器件面积和开关介质和阴极厚度如何差异,这种模拟 RS 都可以在不同器件中重现(补充图5-8 )。同时,模拟 RS 行为在不同 GR 厚度的忆阻器中表现出超过 300 次I - V循环的良好循环耐久性,并且在储存近三个月后可以维持 1,000 次循环(补充图9和10),表明 GR 阴极策略的可靠性。性能基准测试(图1g)表明,与其他报告的方法相比,使用 vdW 金属材料几乎没有损耗,并且具有较大的模拟开/关比。更大的开/关比将实现高权重映射能力。
为了进一步表征 Ag/IPS/GR 忆阻器的模拟开关能力,采用准静态直流扫描和动态电脉冲对忆阻器进行了多级测量。当 RESET 电压不断增加时,Ag/IPS/GR 忆阻器中实现了渐进的 RESET 过程(补充图11)。通过施加一系列增加的 RESET 电压,可以实现超过 8 位的电导状态(总共 278 种状态)(图2a)。图2a (插图)展示了低电导状态下的I - V曲线的放大,显示了易于区分的状态。从三个不同的电流区域((i)、(ii)和(iii)),三个最近邻状态的保持特性如图2b所示,其中 0.05 V 的恒定电压读取每个状态 500 秒。在邻近状态下没有观察到大的重叠。这表明 Ag/IPS/GR 忆阻器能够在较大的电导范围内以非易失性、可调和渐进(模拟)的方式可靠地创建多种状态,这与通过 RESET 电压具有不可调电导状态的 Ag/IPS/Au 忆阻器形成对比(补充图3)。

图 2:Ag/IPS/GR 忆阻器中的多级切换。a、通过使用连续增加的 RESET 电压,Ag/IPS/GR 忆阻器可调整为 278 个电阻级别。每个电阻级别都通过从 0 V 到 0.05 V 扫描的直流电压读取。插图是低电导状态下电阻级别的放大图。b 、 a中三个电流区域中三个最近邻状态的保留特性。通过 0.05 V 的恒定电压读取每个状态的电流。c – e ,对Ag /IPS/Au 忆阻器中不同脉冲方案的电导响应:相同脉冲(c
)、非相同脉冲(d)和 SET 设备(e)使用宽度/幅度为 50 ns/0.8 V 的脉冲。功耗,0.8 V × 3.9 μA × 50 ns = 每个尖峰 156 fJ 和 0.8 V × 14 μA × 50 ns = 每个尖峰 560 fJ。f – h,Ag/IPS/GR 忆阻器对不同脉冲方案的电导响应:相同脉冲(f)、不同脉冲(g)和 SET 设备(h),使用宽度/幅度为 20 ns/1.3 V 的脉冲。功耗为 1.3 V × 45 nA × 20 ns = 1.17 fJ/尖峰和 1.3 V × 114 nA × 20 ns = 2.96 fJ/尖峰。脉冲数的增量电流(如e和h所示)表示脉冲的非易失性切换,这通过直流扫描进一步证实(补充图15 ) 。c、d、f和g中 LTP 和 LTD 测试的脉冲宽度和间隔分别固定为 1 μs 和 1 μs,I Max / I Min是脉冲操作下最大电流与最小电流之比。非线性(NL)以f和g标记。计算方法在补充说明5中讨论。
接下来我们测试了忆阻器电导对电脉冲的响应,这与长期突触可塑性有关,包括长期增强 (LTP) 和长期抑制 (LTD)。LTP 和 LTD 是人脑的基本功能,也是神经形态计算的基本工作原理。正如预期的那样,由于 ECM 忆阻器的突变开关特性,Ag/IPS/Au 器件在相同脉冲下对 LTP 和 LTD 过程都表现出高度非线性和不对称的电导更新(图2c和补充图12a)。这是 ECM 忆阻器的固有局限性。据报道,使用非相同脉冲可以提高线性度和对称性。然而,即使使用幅度增加的非相同脉冲,也只会出现渐进的 LTP 过程,在 LTD 过程中仍然显示数字电导更新,并且 LTP 和 LTD 的对称性变差(图2d)。脉冲操作下电导的突然跳跃也会导致功耗的巨大变化,从第一个尖峰的 156 fJ 变为第五个尖峰的 560 fJ(图2e)。相反,当底部刚性金被范德华 GR 取代时,在相同脉冲(脉冲幅度,1.9 V;图2f )下出现具有合理线性和对称性的渐进 LTP 和 LTD 过程,而不是数字行为。电流逐渐从不到 1 μA 变化到超过 40 μA,模拟比接近 50。高开/关比有利于抵抗噪声以实现可靠的电导状态。进一步应用较小(0.8 V)或较大(3 V)的脉冲幅度,可以获得较低(低至 200 nA)或较高(高达 80 μA)的电导状态(补充图12b,c)。这表明通过调整脉冲幅度可以获得很大的电导范围。与直流模式下电流随电压的逐渐变化相对应,当施加幅度从 1.7 V 增加到 3.0 V 的非相同脉冲时,实现了线性和对称的 LTP 和 LTD 过程,模拟开/关比高达 380(图2g),这与金阴极器件中看到的高度不对称的 LTP/LTD 过程(尤其是数字 LTD)形成对比(图2d )。也就是说,电导可以线性更新两个数量级以上。模拟动态开/关比高于大多数已报道的使用脉冲的突触装置,这些脉冲通常具有低于 15 的动态开/关比(补充表2和补充图13)。高开/关比有利于抵抗非理想因素(如噪声)以实现高权重映射能力。此外,模拟 LTP 和 LTD 过程在相同和非相同脉冲方案下均可重复(补充图14
)。具有宽范围的模拟电导使低电导状态可以打开设备。如图2h和补充图15所示,Ag/IPS/GR 忆阻器可通过宽度为 20 ns 的超窄脉冲和较小的 LRS 电流进行非挥发性 SET,从而实现每尖峰约 1.17 fJ 的超低功耗。功耗从 1.17 fJ 逐渐变化到 2.96 fJ,而 Ag/IPS/Au 忆阻器的功率则大幅跳跃。同时,还测试了开关耐久性,器件可以在 1,500 个脉冲周期内进行置位和复位(补充图16),表明可以获得稳定的性能。因此,我们证明了范德华阴极策略可以将开关行为从数字转换为模拟,具有低功耗和高模拟开/关比。大开/关比提供了广泛的可访问电导状态范围,而线性模拟开关进一步确保了众多电导状态的实现。
为了进一步验证所提出的范德华金属阴极策略的有效性,我们使用范德华材料 PtTe2作为金属阴极。Ag/IPS/PtTe2的忆阻结构如补充图17所示,层状 PtTe2中嵌入/脱嵌过程的示意图如图3a所示。Ag /IPS/PtTe2忆阻器的I - V曲线(图3b)显示出模拟 RS 行为,尤其是逐渐的 RESET 过程。有趣的是,实现了约 107的模拟开/关比。HRS 和 LRS 可以在不同的温度下维持(补充图19 )。此外,在不同的 Ag/IPS/PtTe2器件中也可以观察到这种模拟 RS (补充图20),表明该策略是稳健的。在具有不同厚度 PtTe2的忆阻器之间也是如此(补充图21)。此外,模拟I - V曲线在薄和厚 PtTe2阴极忆阻器中都是可重复的,并且在近三个月后可重复 1,000 次循环(补充图22和23)。发现薄 PtTe2阴极装置比厚 PtTe2装置显示出更大的开/关比,但 SET 电压分布更宽。与具有 GR 阴极的忆阻器相比,具有 PtTe2阴极的忆阻器在 HRS 下显示出更低的电阻和更小的工作电压(补充图24)。关于不同材料和阴极厚度的作用的详细讨论包含在补充说明4中。通过逐渐增加 RESET 电压,可以获得 7 位电导状态(图3c和补充图25)。同时,在 Ag/IPS/PtTe2忆阻器中也可以通过动态脉冲实现可调模拟电导状态(图3d、e)。与直流
I - V曲线(图1f和3b)一致,对于模拟 LTP/LTD 过程,PtTe2阴极装置的工作电压低于 GR 阴极装置。LTD/LTP 过程可以通过脉冲幅度进行调整,其中较小的幅度可带来更好的线性度和对称性(补充图26)。同样,由于具有良好的模拟特性,动态开/关比超过 102,并且在施加非相同脉冲串时表现出良好的线性度和对称性(图3e)。此外,模拟 LTD/LTP 过程对于两种模式都是可重复的(补充图27)。使用 20 ns 的短脉冲可获得每尖峰约 56 aJ 的超低功耗(图3f)。这表明每尖峰的功耗可以从使用 Au 阴极的 156 fJ 降低到使用 PtTe2阴极的 56 aJ。图3g显示了报告的人工忆阻设备的功耗摘要。此外,当使用不同的切换介质时,可以观察到从数字到模拟 RS 的类似转变。如补充图29所示,当 CuInP2S6取代 IPS 作为开关介质时,Ag/CuInP2S6/Au 忆阻器表现出类似数字的 RS 行为,而 Ag/CuInP2S6/GR 忆阻器则显示出更多的模拟开关。

图 3:使用多层 vdW PtTe2作为阴极的 IPS 忆阻器的模拟开关性能。a 、Ag/IPS/PtTe2忆阻器中的 SET 和 RESET 过程以及嵌入/脱嵌过程的示意图。b 、具有模拟切换的Ag /IPS/PtT2忆阻器的I - V曲线。在正常的忆阻切换之前,需要一个成型过程(补充图18)。c 、使用不同的 RESET 电压将 Ag/IPS/ PtTe2忆阻器调整为 128 个电阻级别。每个电阻级别都通过从 0 V 到 0.05 V 的直流电压读取。插图显示了低电导状态下电阻级别的放大。d 、e、对不同脉冲方案的电导响应:相同(d)和不相同(e)脉冲。脉冲宽度和间隔分别固定为 1 μs 和 1 μs。f、SET 器件使用脉冲宽度/幅度为 20 ns/0.4 V 的脉冲。通过脉冲操作前后的脉冲数和直流扫描增量电流确认了非挥发性切换(补充图28)。g 、基准图比较了已报道的忆阻器和我们的忆阻器的功耗和切换时间。补充表3提供了详细的参考资料。
采用二维范德华金属阴极的模拟开关机制
研究潜在的 RS 机制以揭示模拟 RS 机制。首先,为了验证 Ag 在范德华阴极中的渗透,收集了忆阻器的横截面 (CS) 透射电子显微镜 (TEM) 图像以及能量色散 X 射线光谱 (EDS) 映射。未运行的 Ag/IPS/GR 忆阻器的 CS-TEM 图像如图4a-c所示,其中 IPS 显示出明确的晶格条纹,晶面间距d为 0.638 nm,对应于 (100) 晶面(图4a),多层 GR 呈现平行条纹,均匀的层间距约为 0.34 nm,与其 (100) 平面一致(图4b)。在明场 (BF) 和暗场 (DF) CS-TEM 图像中(分别为图4b、c),多层 GR 中均未观察到明显的 Ag 原子。当在重复的忆阻开关循环后将忆阻器设置为 LRS 时,可以观察到清晰的 Ag 丝(图4d)。此外,在 BF TEM 图像中观察到具有较大且不均匀的层间距(例如 0.373 nm;图4e,绿色虚线框)的扭曲 GR 晶格条纹,这是离子插层的典型特征31、33。相应的 DF TEM 图像显示扭曲区域中有一些离散的 Ag 原子(例如,图4f (绿色虚线框)),而在具有清晰晶格条纹的区域没有发现明显的 Ag 原子(图4f,黄色虚线框),表明有少量的 Ag 渗透。通过在高顺从电流下重复 SET 操作,将 Ag/IPS/GR 器件卡在 LRS 中,可以进一步验证 Ag 在 GR 中的插入。如图4g-h中的 CS-TEM 图像和相应的 EDS 映射所示,观察到大量 Ag 渗透到层状 GR 中。同样,在 Ag/IPS/PtTe2忆阻器中,在正常运行的忆阻器中观察到清晰的银丝(补充图30a),以及 Ag 渗透到卡住器件中的层状 PtTe2中(补充图30b、c)。所有这些都证实了 SET 后 Ag 在 vdW 阴极中的渗透。同时,还收集了 RESET 后的忆阻器的 CS-TEM 图像。与 LRS 中的忆阻器相比,在重复的忆阻开关循环后重置到 HRS 时,GR 中没有观察到明显的 Ag 原子(图4i-k这表明插入的Ag原子已经从GR中脱嵌,即Ag嵌入/脱嵌是可逆的。Ag嵌入/脱嵌导致局部区域晶格条纹扭曲。然而,GR仍然保持层状结构,具有清晰的快速傅里叶变换图案(图4e、j和补充图31 ),表明结构扭曲有限。在PtTe 2阴极忆阻器中也发现了类似的现象(补充图32)。与CS-TEM结果一致,在计算结构中没有发现由于Ag迁移而引起的明显结构变化(补充图















