
来源:本文由半导体行业观察翻译自semiengineering
,
谢谢。
半导体行业正在向持续小型化和日益增长的复杂度发展,也推动着系统级封装(SiP)技术的更广泛采用。
SiP 的一大优势是可以将越来越多的功能压缩进越来越小的外形尺寸中,比如可穿戴设备或医疗植入设备。所以尽管这种封装的单个芯片中的单个 die 上集成的功能更少了,但整体封装通过更小的空间占用而包含了更多功能。在效果上,这就实现了在一个封装中封装一个完整的电子系统,其中 IC 是平坦排布或垂直堆叠的,也或者是两者的结合。
此外,SiP 技术是在已经存在了多年的技术上的扩展。它构建于已有的封装技术之上,比如倒装芯片、wire bonding、fan-out 晶圆级封装。
多芯片模块(MCM)是系统级封装的前身。MCM 最初是为数据存储(比如 1960 和 1970 年代的 bubble memory)和特定的军事/航空航天电子设备开发的。现在仍然还有一些产品在使用它们,比如任天堂的 Wii U 游戏机。但由于摩尔定律的不断发展,这种封装方案被没有得到大范围的采用,因为摩尔定律能更便宜和更轻松地将所有东西放置到单一一块芯片上。
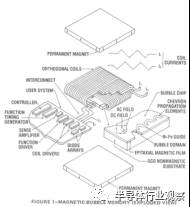
图 1:TI 的 bubble memory 模块
在 16/14nm 节点时,情况发生了变化,这时候继续减小器件尺寸已经变得更加困难。而且随着新节点的到来,难度还会继续增大。比如在 5nm 节点时,预计会引入全新的晶体管结构,并且人们还在考虑用钴或钌等新材料来替代互连中的铜。此外,动态功率密度和自热在 16/14nm 节点时就已经成为问题了。而在 10nm 及以后,这些问题还需要更大的关注和高级电源管理电路。在设计方面,布线阻塞的问题也越来越大,并且 RC 延迟、电迁移以及热、静电放电和电磁干扰等物理效应还在加剧这个问题。
先进的封装技术为解决这些问题提供了一些替代方法。首先,其通过物理的分离而提供了一种最小化物理效应的方法。比如说,一个对数字噪声和热效应敏感的模拟模块可以通过使用分开的芯片而更轻松地缓冲。其次,因为所有芯片或 chiplet 都可以在一个封装中复用,所以会使得 IP 复用更加简单。第三,通过增加芯片之间的连接的直径和缩短信号传输的距离,可以提升性能并降低功耗,这反过来又可以降低驱动这些信号所需的功率。
“SiP 在实现方面还处于起步阶段,”ASE Group 销售和业务开发副总裁 Yin Chang 说,“我们仍然在学习 SiP 的所有可能性。这是 SiP 的真正开始。”
但高级封装显然已经不再处于涉及多种封装方法的可行性和可靠性的基础研究阶段了。现在的挑战是实现与摩尔定律通过将所有东西放置到单个 die 上所带来的一样的规模经济。半导体行业已经拿出了稳定的选项和技术发展趋势以帮助转型。
“技术进步是双重的,”Chang 说,“一是 2.5D 方面,其中可以使用硅 interposer 连接各种类型的高密度硅。这允许实现最大化的集成,而且可以在小空间内带来性能提升。其次,将过去的各种功能放到一起可能会导致芯片的冲突或互相干扰。在这些冲突的硅性能之间放入动态屏蔽和将这些放入一个非常小的外形之中的能力使其可以被用于需要这类外形需求的应用——主要是在可穿戴和物联网应用中。”
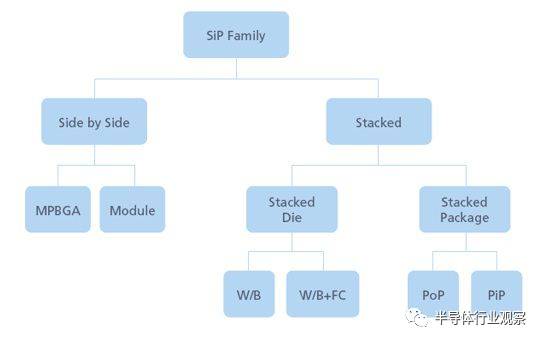
图2:SiP 全景图,来自 ASE
也有其它公司正在改进这项工艺。
“这种技术的进展主要是关于多个 die 的异构集成以及(这也是一个关键组件)在最小尺寸上无源器件的有效混合和匹配。” STATS ChipPAC 高级总监 Urmi Ray 说,“这就是过去几年发生的事情,因为这些模式已经出现在了非常小外形尺寸中无源器件和有源器件的优化的关键领域。此外,我们在组装方面已经看到了非常有效的处理、贴装、小、非常薄的 die 和两种相对大的器件。很薄的 die 正在变得越来越明显,很显然,其外形正在变小。”
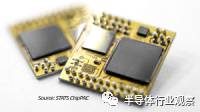
图 3:一种现代 SiP,来自 STATS ChipPAC
Yole Développement 总裁兼 CEO Jean-Christophe Eloy 观察得到了类似的结论。他指出苹果由台积电生产和组装的 A10 处理器设计已经允许无源器件回到芯片设计中了,而不再只是将其看作是 PCB 上的分立元件。他说:“多亏台积电和苹果的 A10,集成无源器件回归到了移动应用中。”
Amkor Technology SiP/系统集成部门副总裁 Nozad Karim 上个月在加州 Rohnert Park 通过这个问题启动了最早的 System in Package (SiP) Technology 会议和展览会(由国际微电子组装与封装协会(IMAPS)主办)。
“它有很多很多定义,”他说,“它是系统,也是封装。”
TechSearch International 总裁 Jan Vardaman 补充了更多背景信息:“这个行业需要清楚我们定义 SiP 的方式。”她解释说,SiP 涉及到“两个或多个不相似的 die”并且“构成一个功能模块”。
Vardaman 补充说:“SiP 并不是指单一一种封装。fan-out 晶圆级封装也可以成为 SiP。”但她也指出台积电的 InFO 层叠封装(package-on-package )技术并不满足 SiP 的定义。
Vardaman 估计 2016 年会出货 149 亿 SiP 封装。移动设备、可穿戴和其他消费产品占到了 SiP 总量的 82%。Vardaman 预计从 2016 年到 2020 年 SiP 的年复合增长率为 13.7%。
Vardaman 说,iPhone 7 和 7 Plus 智能手机各自有大约 15 个 SiP,而 Apple Watch Series 2 包含 3 个 SiP,三星 Galaxy S8 有 13 个 SiP。
另外参考一点,Yole Développement 预测从 2022 年开始,将有 450 万晶圆(以 12 英寸晶圆计算)将包含透硅通孔(through-silicon vias),这种通孔是 interposer 和其它高级封装所需的。
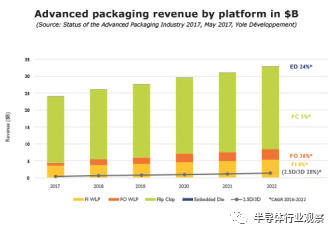
图 4:高级封装增长预测,来自Yole Développement
SiP 最早是用在高端的网络应用市场,其中吞吐量很关键,而价格并不是一个重要因素;另一些则在消费电子和移动市场,其中早期开发的成本可以通过高销量和系统的整体价格抵消。
今天主要的实现包括将处理器、内存、逻辑和传感器集成到一个模块中,从而为一些客户提供一站式解决方案。但随着成本降低,这些产品预计将对物联网设备开发者尤其有用,它们往往需要快速推陈出新。
“模块化这种解决方案能让我们快速创建非常快速的上市时间解决方案。”ASE 的 Chang 说,“所以我们可以使用特定性能的 SiP,这让公司可以非常快速地将它组装到一起,并将产品推向市场。这些针对的是可穿戴和 IoT,其中市场变化得非常快。这些是 SiP 可以一起满足的两个不同的要求。”
由于其能够以更小的外形实现更长的电池寿命,SiP 也在渗透进汽车、工业和医疗电子领域。在人工智能和神经引擎等有高性能需求的应用中,SiP 也很合适。Chang 说:“SiP 可以进入广泛多样的行业领域。”而且这项技术也适合自动汽车、增强现实、5G 无线通信等等。














