
文章链接:
https://advanced.onlinelibrary.wiley.com/doi/full/10.1002/adfm.202422120?saml_referrer
亮点
1.创新设计
o构建了具有范德华间隙的MoS₂浮栅晶体管,有效降低了泄漏电流。
2.性能卓越
o存储器展现了超低泄漏电流(0.1 fA µm⁻¹)、高数据保持能力(>10⁵秒)和10⁷的高开关比。
3.多功能实现
o实现了逻辑存算一体功能,可通过多级编程操作生成NAND和NOR逻辑序列。
4.高稳定性
o器件在21天后仍然保持稳定性能,并拥有超过1000次的循环耐久性。
摘要
浮栅(FG)存储器能够在无电源情况下保存数据数十年。本文中,研究者展示了高性能MoS₂浮栅晶体管(FGT),其稳定操作得益于在隧穿氧化层和沟道之间构建的范德华(vdW)间隙,有效防止了泄漏现象的发生。通过臭氧处理对HfS₂薄片进行一步原子结构改性,实现了FG结构的构建,同时界面处的过饱和氧原子形成了vdW间隙。这种结构的MoS₂ FGT展现出优异性能,包括21天后的稳定操作、极低泄漏电流(0.1 fA µm⁻¹)、超过10⁵秒的出色数据保持能力、10⁷的高开关比以及良好的循环耐久性(>1000次循环)。通过多门控结构的多级编程操作,成功实现了可配置的逻辑存算一体设备,能够生成NAND和NOR逻辑序列输出。这种设计的FG存储器为发展存算一体系统提供了前景广阔的可能性。
研究背景和主要内容
闪存因其高存储容量而成为当前广泛使用的非易失性设备。标准闪存基本上是浮栅 (FG) 结构,它由沟道层和数据 FG 层组成,两者通过隧道层和控制氧化物完全电隔离。FG 晶体管的有限保留时间阻碍了其非易失性存储器的潜力,这是由于与栅极结构和 FG 层内存储的电荷泄漏相关的复杂挑战所致。具有理想原子平面和超薄层的二维层状过渡金属二硫属化物,例如二硫化钼 (MoS2),由于其有效的静电控制,有利于减少寄生缺陷捕获和内存计算系统的缩放。然而,MoS2表面的非悬挂带性质使沉积高质量电介质变得具有挑战性,限制了制造复杂性和设备存储性能。由于电介质在实现高性能FG存储器件中起着重要作用,尽管已有基于MoS2的非挥发性FG存储器的报道,但在工作电压和保留时间之间存在权衡。而这取决于FG结构中电介质层的厚度和质量。在超薄厚度的MoS2表面沉积高k电介质可以实现栅极电位的高度可控性以及较长的保留时间。然而,典型的沉积策略,例如原子层沉积(ALD),基于键合介质(例如预先制备的颗粒)在2D材料表面形成成核,因此不可避免地会引入杂质并产生高度粗糙或多孔的电介质/沟道界面,导致制备的FG晶体管的电性能恶化。此外,隧穿氧化物/通道界面处的陷阱和缺陷会导致存储电荷的逐渐丢失,从而导致存储保留能力受损。
因此,为避免存储器性能下降,需要高质量的隧穿氧化物以及完美的电介质/通道界面设计以获得低漏电流。VdW 集成策略有助于设计所需的设备界面而无需相互扩散。此外,物理吸附发生在 3 埃以上的距离,扩大沟道和电介质之间的 vdW 距离可以大大避免陷阱辅助隧穿效应,正如我们在之前的工作中所报告的那样。合理设计栅极结构可以
轻松最小化泄漏路径。在这种情况下,FG 结构的静电势能长时间保持,从而可以轻松调整沟道的状态。因此,可以实现可配置逻辑的存储器操作。在此,我们证明可以通过臭氧处理从 HfS2薄片中获得高质量的 HfOx电介质层,从而得到由 HfS2 FG 层及其绝缘氧化物 HfOx组成的 FG 结构。电荷以高于传统闪存的密度注入 HfS2 FG 层,隧穿氧化物/沟道处的范德华间隙可防止泄漏。高分辨率透射电子显微镜 (TEM) 图像显示 HfOx/HfS2/HfOx FG 结构形成了具有高质量原子级尖锐无缺陷界面。制备的范德华间隙 MoS2 FG 晶体管具有稳定可靠的电气性能以及出色的保持力和耐久性特性。
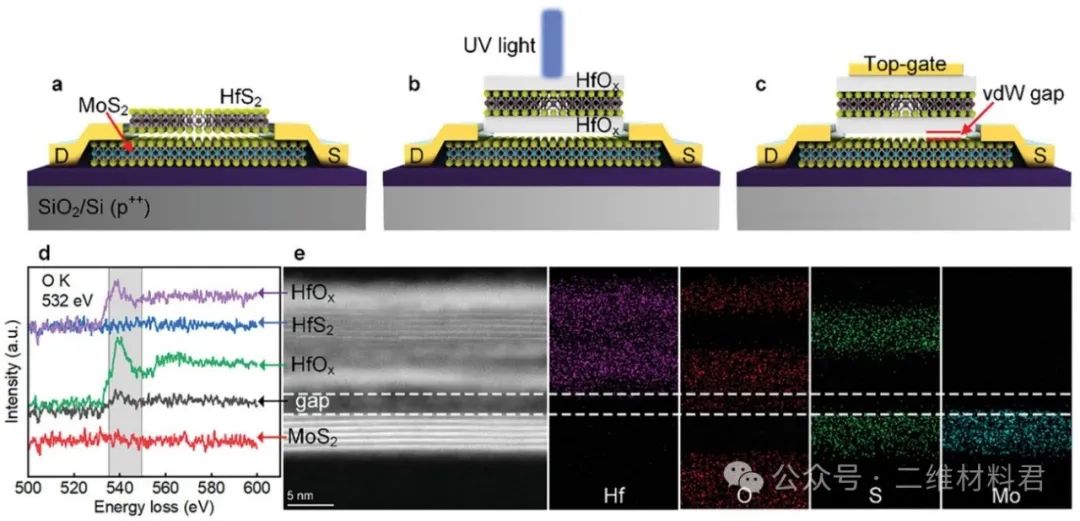
图1 隧道氧化物/MoS2沟道界面处的示意图和范德华能隙。a) 背栅 MoS2晶体管,在 SiO2 /Si(p ++)衬底上具有 Cr/Au(10/50 nm)触点,HfS2薄片堆叠在 MoS2沟道上。b) 引入臭氧处理以形成 HfOx电介质。c) 顶栅电极形成。d) 从不同层总结的 OK 核心级边缘的 EELS 光谱。e) 横截面 TEM 图像和元素分布。
MoS2用作沟道材料,HfS2用作存储 FG 层。两侧的 HfOx层用作隧穿和控制栅极氧化物电介质,这有利于降低等效氧化物厚度和亚阈值摆幅值而不会增加漏电流,因为它们与沟道/FG 架构的无缺陷界面形成陡峭界面。vdW 能隙来源于 HfS2/MoS2界面处的 vdW 接触,氧化过程中 MoS2 /HfS2界面的演变如图S3 (Supporting Information) 所示。当臭氧处理时间为 10 min 时,HfS2薄片可从两侧部分氧化。由于氧在 HfOx中的扩散 MoS2薄膜以较低的活化能(≈0.52 eV)被热激活,通过逐层氧化 HfS2薄片可共形形成 HfOx电介质,富氧条件导致元素氧在范德华间隙处积累,从而进一步扩大了间隙距离。能量色散谱映射和电子能量损失谱(EELS)线扫描相结合,可以直接显示氧分布,如图 1d所示。FG 堆栈中的 OK 分态密度表明元素氧在隧穿氧化物层和 MoS 2通道之间的范德华间隙处积累。横截面 TEM 图像显示了明显的范德华间隙,并且在界面处没有观察到界面无序或损坏(图 1e)。

图2 vdW 间隙 MoS2 FG 晶体管的电气性能。a) vdW 间隙 MoS2 FG 晶体管的扫描范围相关转移特性。在固定VDS 0.05 V下,顺时针磁滞窗口随着VTG 的增加而扩大。b) 提取的 ΔVTH和开关比与最大顶栅电压的关系,同时获得最大 ΔVTH 5.6 V 和开关比≈107。c ) vdW 间隙 MoS2





















