该文章介绍了南京大学黎松林教授团队通过化学气相沉积在台阶切向蓝宝石衬底上外延生长晶圆级高度定向WS 2 单层的研究成果。该材料具有高晶体质量、低缺陷密度、晶圆级均匀性、优异的电子性能和低接触电阻等特点,为开发未来低功耗电子器件提供了新的见解。文章还介绍了该研究的主要成果和亮点,包括高度定向WS 2 单层的制备、表征、电子性能和在高性能纳米电子器件中的应用前景。
通过化学气相沉积在台阶切向蓝宝石衬底上外延生长晶圆级高度定向WS 2 单层,实现了晶体和电子性能的协同优化。
高度晶体取向、低缺陷密度、晶圆级均匀性、高载流子迁移率、低接触电阻,与最先进的硅基器件相当的饱和电流密度。
为使用宽带隙WS 2 单层开发未来低功耗电子器件提供了重要参考,有望促进二维材料在高性能纳米电子器件中的应用。
该研究由南京大学的黎松林教授、郝玉峰教授和邓昱教授团队合作完成。
为了方便各位同学交流学习,解决讨论问题,我们建立了一些微信群,作为互助交流的平台。2.告知:姓名-课题组-研究方向,由编辑审核后邀请至对应交流群(生长,物性,器件);欢迎投稿欢迎课题组投递中文宣传稿,免费宣传成果,发布招聘广告,具体联系人:13162018291(微信同号) 【研究背景】
【研究背景】
二维半导体过渡金属硫族化合物(TMDCs)因其原子级厚度、无悬挂键表面以及高载流子迁移率等特性,在突破硅基摩尔定律方面展现出重要潜力。TMDC单层通常表现出比硅更大的带隙值。而研究表明,使用宽带隙半导体沟道材料(如GaN、SiC和金刚石)可以降低静态漏电流、提高击穿场强,并改善电子电路的偏压耐受性,这得益于其高界面能垒和低量子隧穿率(即优异的绝缘特性)。这些优势对于构建低功耗和长期稳定的电路至关重要。在典型的TMDC单层中,二硫化钨(WS2)表现出最高的电子带隙(2.3 eV),使其成为开发低功耗和高可靠性电子器件的优异宽带隙沟道材料。此外,WS2是最稳定的二维半导体之一,具有较高的氧化反应势垒和环境稳定性,这使其更适合制造工艺。
尽管高度定向的MoS2晶圆在电子性能指标(如载流子迁移率μ和电流密度)方面取得了快速进展,但关于同时具备高晶体取向和电子性能(即晶体质量、载流子迁移率和载流能力)的高质量WS2单层晶圆的合成报道仍然较少。除晶体质量外,WS2与电极之间的接触质量也是一个技术挑战,这是由于存在较大的注入势垒和费米能级钉扎效应。目前报道的单层WS2 FETs最高电流密度为520 µA µm−1(在1.5 V偏压下)。迄今为止,实现晶体和电子性能协同优化且能与硅相媲美或超越的晶圆级WS2仍然具有挑战性。
【成果介绍】
鉴于此,南京大学的黎松林教授,郝玉峰教授,邓昱教授团队合作发表了题为“Highly Oriented WS2 Monolayers for High-Performance Electronics”的文章在Advanced Materials期刊上。该工作报道了通过化学气相沉积(CVD)在台阶切向蓝宝石(α-Al2O3)衬底上外延生长晶圆级高度定向WS2单层。结构和光谱表征显示,所生长的单层具有高度晶体取向,表现出较低的缺陷密度(8 × 1012 cm−2)和晶圆级均匀性。电学测量表明,在SiO2/Si衬底上室温和8 K下的平均场效应迁移率分别为62和180 cm2V−1s−1。在六方氮化硼(hBN)衬底上,这些迁移率进一步提高到94和473 cm2V−1s−1。通过引入半金属锑(Sb)作为接触电极,实现了低至600 Ω·µm的接触电阻率,并在超短沟道长度(10 nm)下获得了创纪录的饱和电流密度675 µA µm−1(在0.8 V偏压下),这与最先进的硅基器件相当。本工作为使用宽带隙WS2单层开发未来低功耗电子器件提供了新的见解。
【图文导读】

图 1. WS2在C/A 1°蓝宝石(0001)衬底上的单向生长对齐。a) 蓝宝石晶体中C/A 1°切向面的示意图。b) 退火后C/A 1°表面的AFM形貌图。c) 切向衬底表面台阶及其上生长方向对齐的WS2晶畴示意图。d) 切向衬底上对齐良好的WS2晶畴的光学图像。e) 晶畴与裸衬底之间的AFM相位对比图。f) 单向对齐WS2晶畴的光致发光(PL)图谱。g) (e)中两个晶畴的二次谐波极坐标图。h) 高度定向WS2单层的PL光谱。插图:拉曼光谱。

图 2. 蓝宝石晶圆上高度定向WS2单层的表征。a) 2英寸蓝宝石(0001)衬底上高度定向WS2薄膜的照片。b) PL和c) 拉曼线扫描。d) WS2薄膜的PL峰值能量(红色)和拉曼峰位差的统计图。e) 拉曼E2g1峰强度图谱和f) A1g强度图谱(取自插图区域)。g) 取自(e)插图的PL峰值强度图谱。h) WS2薄膜的原子分辨HAADF-STEM图像。i) 包含硫空位(黄色虚线圆圈)的典型HAADF-STEM图像。比较j) CVD生长和k) 机械剥离(ME)的WS2单层原子空位的统计密度。
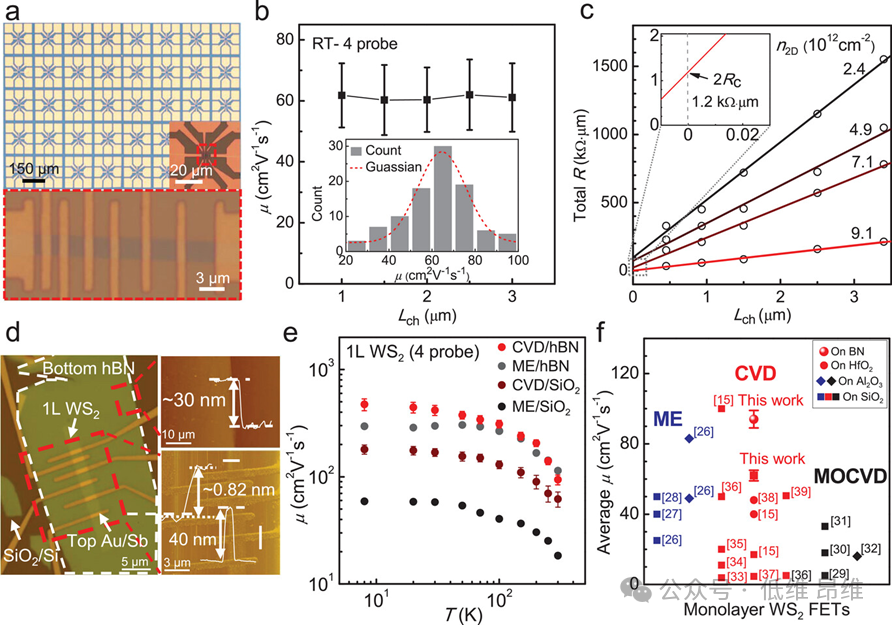
图 3. 高度定向单层WS2的电子性能。a) 上图:0.25 cm2面积上的FET阵列照片。b) 沟道长度与载流子迁移率的关系。c) 使用TLM方法从(a)中器件提取的接触电阻Rc. d) 制备的WS2/hBN/SiO2/Si FET的光学图像。e) 不同温度下,由hBN和SiO2衬底支撑的CVD和剥离WS2的迁移率比较。f) 各种制备方法(包括ME、CVD和MOCVD)报道的WS2单层FETs平均迁移率的比较。
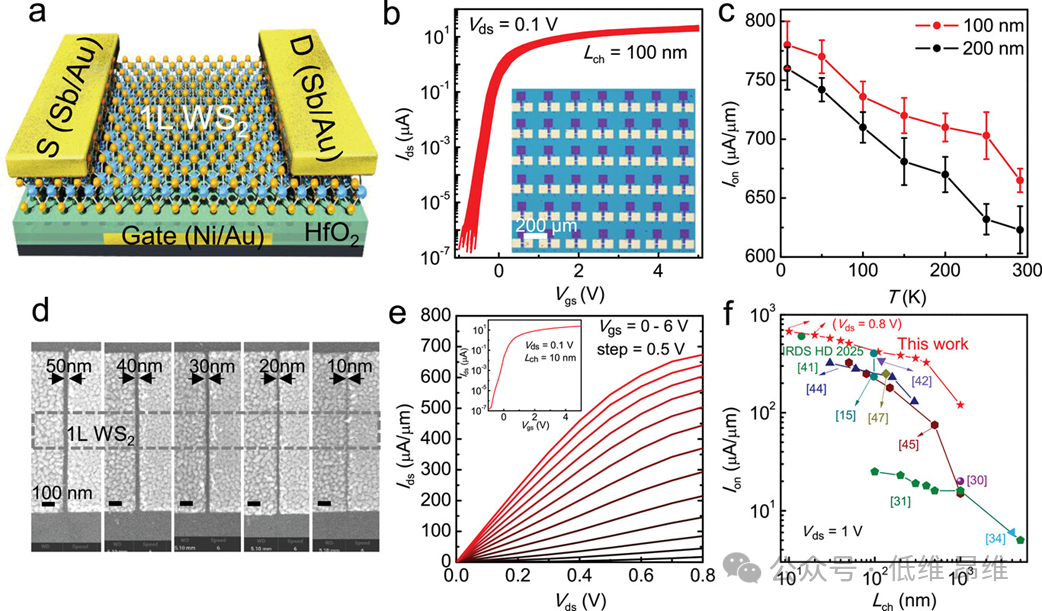
图 4. WS2单层短沟道FETs的电学性能。a) 埋栅WS2 FET的示意图。b) 沟道长度为100 nm的FETs在Vds = 0.1 V时的转移特性曲线。c) 导通电流随温度的变化关系。d) 实际沟道长度Lch从10到50 nm的短沟道FETs的SEM图像。e) 10 nm短沟道WS2 FET的输出特性。f) Vds = 1 V时WS2单层FETs的Ion基准比较。
【总结展望】
总之,本工作通过在C/A面蓝宝石衬底周期性台阶边缘上的模板生长策略,成功制备了高度定向的晶圆级WS2单层。晶体学、显微和光谱表征一致表明,WS2单层在整个晶圆范围内表现出优异的均匀性。详细的电学测量表明其具有优异的载流子迁移率和低接触电阻。更重要的是,在超短沟道长度(10 nm)的场效应晶体管中观察到创纪录的饱和电流密度675 µA/µm(Vds = 0.8 V)。本工作为WS2单层在高性能纳米电子器件中的产业化应用提供了重要参考。
【文献信息】
L. Zhan, X. Pei, J. Tang, S. Li, S. Li, Y. Li, L. Li, C. Wan, Y. Deng, Y. Shi, Y. Hao, S. Li, Highly Oriented WS2 Monolayers for High-Performance Electronics. Adv. Mater. 2024, 2414100.文献链接:https://doi.org/10.1002/adma.202414100上海昂维科技有限公司现提供二维材料单晶和薄膜等耗材,器件和光刻掩膜版定制等微纳加工服务,以及各种测试分析,欢迎各位老师和同学咨询,竭诚做好每一份服务。




















