微访谈:BroadPak首席执行官Farhang Yazdani
麦姆斯咨询 编译
据麦姆斯咨询报道,MEMS器件和3D集成技术等细分市场正在经历一个全新的时代。随着云计算和超级计算应用对移动数据带宽需求的增加,以性能驱动的市场逐渐走向了3D堆叠技术。
新功能如语音/图像识别、语言处理……所有这些新的需求都直接促进了深度学习、数据中心网络、AR/VR和自主驾驶应用程序的发展,而这些都基于3D集成技术。
根据Yole发布的报告
《3D硅通孔(TSV)和2.5D市场和技术趋势-2017版》
,未来五年,预计12英寸等效晶圆的复合年增长率可达20%,将从2016年的130万片增长至2022年的400万片。
我们有幸采访到BroadPak公司首席执行官Farhang Yazdani,就BroadPak公司的服务、行业地位和市场愿景进行了讨论。
Yole Developpement(以下简称YD):BroadPak公司提供2.5D和3D集成技术,您能就公司当前的状况和商业模式做更详细的介绍吗?
Farhang Yazdani(以下简称FY):作为一家2.5D和3D集成商,我们提供整体解决方案和技术来帮助客户开发并推出2.5D和3D产品。基本上,算是为客户提供从概念提出到交付2.5D和3D产品的一站式服务。采用垂直集成整体解决方案模式,就我们所知,这种成本模型是目前同行业中最具竞争力的。
我们为机器学习行业的客户特别是深度学习相关应用程序开发商提供解决方案和技术。BroadPak在基于异构IP晶片的集成方面也相当有经验。我们指导和帮助客户通过中介层(interposer)模块化集成将嵌入IPs做成2.5D或3D器件。我们为许多客户提供中介层和制造服务,如芯片级和中介层级的小间距铜柱凸块。我们还提供在200mm和300mm的晶圆上的铜大马士革镶嵌工艺(Cu Damascene)的中介层。
BroadPak是业界公认的端到端协同设计方法、信号/电源集成化的企业智囊。我们区别化的2.5D或3D集成以及系统级路径寻找和协同优化更是显得与众不同。我们独特的跨域协同设计方法集成了多种物理模拟和电-热-机械应力可靠性分析,以提供高良率的产品。这种完全集成的多物理协同仿真在2.5D和3D集成解决方案上已经成功地证明了其必要性。
详细的2.5D和3D集成解决方案可在公司官网www.broadpak.com上查询。

路径寻找(来源:BroadPak)
YD:自2007年您成立BroadPak公司,已经确立了BroadPak在2.5D和3D集成领域的领先地位。回顾过去,您会如何形容那些过去十年的2.5D和3D集成领域?
FY:回顾过去,2.5D和3D技术诞生并在应用和市场上激起了千层浪。过去,存储器逻辑带宽的限制成为阻碍发展的绊脚石,同样,在特殊节点上IP集成遇到前所未有的挑战而造成大量延误。因此,2.5D和3D异构集成是必须的。基于2.5D和3D异构集成,我成立了BroadPak公司。当摩尔定律到22nm节点以下,每个晶体管的成本增加很快,对2.5D和3D结构的咨询量也陡然上升。回头看过去的十年,很高兴看到我们的预测和投资是乐观的。
YD:3D集成电路技术经历了跌宕起伏的历程,要说服器件供应商接受TSV封装技术难度有多大?
FY:最初,我们收到诸如“还有谁在做呢?”的回应,然后就以“供应链分散、成本问题、缺乏可靠性数据的验证、ESD要求和测试”等借口被谢绝。一旦模块化整合效益出来,所有的问题被解决后,我们发现客户仍然缺乏2.5D和3D集成设计的专业知识并对风险和结果有所顾虑,因为这对他们来说是个全新的领域。因此,我们就2.5D和3D流程对客户进行全面详尽的指导、引导和互动交流。
YD:BroadPak的客户群有著名大公司,也有初创企业。当初创公司与你们合作一个项目,可能不会注意到2.5D集成?你们会怎么介绍和引导客户采用2.5D集成?
FY:一方面,许多客户到我们公司来,是带着集思广益,选择最佳的2.5D和3D解决方案目的而来。我们最大的优点之一就是为客户提供有竞争力的解决方案。在最初的集思广益过程中,初创客户经常实现一种全新的架构方法,获得新的市场和机会。在双方专家的团队合作中,一套有竞争力的解决方案逐渐形成。
多年来,我们已经意识到,客户寻求2.5D和3D路径需要贴心的支持,涵盖从IPs到协同设计/分区的全面解决方案,更重要的是有合适的供应链。我们提供的服务包括确定最优的2.5D和3D解决方案,并最终交付给客户2.5D和3D产品。很多客户就是冲着我们具有竞争力和低成本的中介层制造和凸块服务来的。
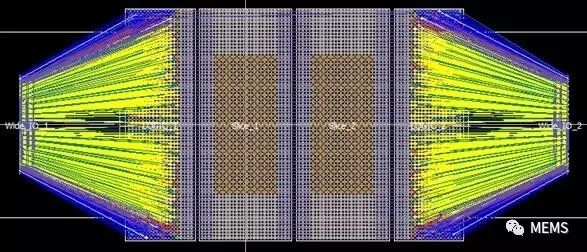
连接多器件和封装体实现路径寻找和成本优化(来源:BroadPak)
YD:BroadPak提供整体解决方案,覆盖了设计、IP、制造到封装。为客户提供完整的解决方案有多重要?
FY:不同于传统的产品仅涉及的一个或多个单芯片封装,整体解决方案是被授权提供2.5D和3D产品。2.5D和3D集成的许多方面是高度相关的,因此整体解决方案有助于减少风险,提升性能、降低成本和提高产量。一款有盈利能力的2.5D和3D产品需要智能规划、分区、路径寻找,几乎涉及到设计、晶圆制造、封装、凸块整个产业链。一家大公司成功推出2.5D和3D产品,这是因为他们拥有和管理IP、设计、供应链与物流等整个流程。BroadPak就能为不具备这种能力的客户提供类似的整体解决方案。
YD:主要的TSV晶圆代工厂都是蓝筹股公司,要说服他们为初创企业和中型企业这些需求量有限的客户提供3D TSV制造供应链的服务有多难?你相信中型TSV晶圆代工厂会有光明的未来吗?
FY:没有产量大的产品,初创企业和中型企业是很难得到中介层技术和相关的供应链服务。2.5D和3D供应链会做筛选且不会接纳所有企业,这不是什么秘密。一流代工厂只为量大的一流客户提供服务,不会支持初创企业。并非所有TSV产品都要在大型代工厂里完成,事实上中小型TSV代工厂也具有TSV制造的专业能力,Damascene图形能力是至关重要的,对TSV产品的发展起着非常重要的作用。通常,许多中低需求量的TSV产品在中小型代工厂往往能得到非常有力的支持。
YD:在报告
《3D硅通孔(TSV)和2.5D市场和技术趋势-2017版》
中,Yole回顾了3D IC和2.5D在应用上做出了创新。其中,机器学习采用深度学习算法是未来大趋势,3D IC和2.5D在此找到了“甜蜜点”。深度学习和2.5D和3D硬件彼此受益。超级计算使用深度学习已经成为可能,因为高带宽硬件和基于TSV的硬件也为这个新领域而问世。您认为机器学习和高性能计算会不会成为3D IC和2.5D技术的细分市场?Broadpak公司是否对这个市场感兴趣?
FY:在互联世界里,大数据管理和云计算确实成上升态势。对于深度学习应用程序,尤其是在训练阶段,需要大量的存储带宽。在许多深度学习平台内插HBM2。Broadpak在深度学习市场和应用十分活跃,为我们许多客户提供定制的深度学习平台。我们认为机器学习和高性能计算市场不仅是可持续的,而且是一个相当可观的市场。















