
文章链接:https://pubs.acs.org/doi/10.1021/acs.nanolett.4c02616
亮点:
1.揭示接触尺寸对应变和接触电阻的影响:长接触引入较少的接触电阻,与短接触相比性能显著提升,为优化接触电阻提供了新方法。
2.热退火调控应变:热退火可以有效缓解接触诱导应变,提高长接触器件的接触电阻,展示了热处理在器件调控中的潜力。
3.探索热机械现象对2D材料的影响:通过应变与电性能的关联研究,展示了纳米制造与热预算在优化2D半导体器件中的重要作用。
摘要
二维(2D)电子器件需要低接触电阻(RC)以接近其性能极限。WS₂是一种有前景的2D半导体,通常配合Ni接触使用,但由于Ni功函数与WS₂导带之间的非理想对齐,其工作机制尚不完全清楚。在此研究中,我们研究了接触尺寸对纳米级单层WS₂晶体管的影响,并发现Ni接触引入的应变会影响WS₂器件的性能。WS₂上的应变取决于接触尺寸,其中长接触(1 μm,RC ≈ 1.7 kΩ·μm)相较于短接触(0.1 μm,RC ≈ 7.8 kΩ·μm),接触电阻降低了78%。我们还发现,热退火可缓解长接触器件中WS₂的应变,导致接触电阻增加至8.5 kΩ·μm。结果表明,热机械现象对2D半导体-金属接触具有显著影响,揭示了通过纳米制造和热处理优化器件性能的机会。
研究背景和主要内容
二维(2D)半导体,例如过渡金属二硫属化物(TMD),由于其原子级薄的特性和亚纳米薄膜中良好的电荷迁移率,引起了下一代电子产品的极大兴趣。单层二硫化钨(WS2)具有预测迁移率最高和带隙最大的TMD之一,可能实现良好的低功耗性能。然而, WS2基场效应晶体管(FET)的高接触电阻(RC)限制了其进一步发展。有多种技术已被证明可以将RC降低到n型 TMD,例如沉积半金属(例如 Bi 和 Sb),使用低熔点金属(例如 In 和 Sn),或转移接触,尽管其中许多方法被认为与工业不兼容。此外,n型 WS2接触落后于 MoS2,需要付出更多努力来研究亚微米尺寸下的性能。
原则上,金属-半导体界面处的RC取决于:(1)金属-半导体能带排列(包括费米能级钉扎),其中金属功函数(φm )影响肖特基接触势垒,以及(2)金属沉积过程中产生的缺陷数量,该数量往往随着金属熔点的升高而增加或反应性,从而导致额外的费米能级钉扎。镍(Ni)通常用作n型 WS2的金属接触,已报道的 Ni 的最低RC在室温下低于 1 kΩ·μm。在我们的器件中,我们发现 Ni(图 1 a、b)与其他金属(如 Au、In、Sb(图 S1 ))相比,表现出最低的
RC。然而,WS2上 Ni 的低R C的原因尚不清楚,事实上,由于两个原因,这是违反直觉的:(1)Ni 具有较大的功函数(ϕ Ni ≈ 5.15 eV),与单层WS2的导带不太一致(图 1c);(2)Ni 的高熔点(1455°C)表明 Ni 接触可能在物理气相沉积过程中在WS2中产生更多缺陷。

图 1. (a)单层 (1L) WS2器件示意图,其局部背栅上具有薄 HfO2和 Ni 触点,顶部覆盖有 Au。(b) (a) 中示意图的放大视图,显示了 Ni 沉积导致的 WS2中的应变。(c) 单层 WS2的带隙与某些块体金属和半金属的功函数 (ϕ m ) 的近似关系。EC表示导带边缘,EV表示 1L WS2的价带边缘。(d) 测量所有Lch = 200 nm 器件的I D与V GS曲线,其中LC = 1 μm(8 个器件)和L C = 0.1 μm(4 个器件),显示长接触时I D明显改善。箭头表示电压扫描方向,显示顺时针磁滞。
与金属功函数排列和金属诱导间隙状态对RC 的影响研究得较为深入不同,接触的机械效应研究得相对较少。薄金属膜在沉积时通常含有大量残余应力,尤其是 Ni。众所周知,二维半导体的能带结构对应变很敏感,最近的研究表明拉伸应变可以增加单层 MoS2和 WS2的电子迁移率。可以通过弯曲基板来施加应变,通过覆盖层,或在接触处。此外,这种薄膜中的应力可以通过热处理来改变,这可能会影响 2D 晶体管制造的整体热预算。因此,有必要探索应变在接触工程中的潜在作用,特别是在沉积 Ni 等高应力金属时(图 1 a、b)。
本研究揭示了应变在 Ni- WS
2界面起着重要作用,以及它如何影响器件跨导(gm = ∂ID / ∂VGS )和RC。我们观察到电子束沉积的 Ni 对 WS2 沟道施加了高拉应力(图1b )。这些应力与接触长度(LC)大致成正比,当沟道长度( Lch )为 50nm 时,长接触( LC =1μm)的导通电流比短接触(LC =0.1μm)的导通电流增加约 2.64 倍(Lch = 1μm时增加约 1.37 倍)。长接触还会在 WS2 接触区域附近产生显著应变,导致 RC 降低 78% 。但是,我们观察到热退火会导致未封装器件中的应变松弛,导致退火后长接触和短接触器件的RC值几乎相同。这些观察突出了提高设备性能的新策略,并强调了热机械效应在评估不同接触材料中的重要作用。
我们研究了几种几何形状的单层 WS2器件,主要使用具有低等效氧化物厚度 (EOT) 绝缘体的局部背栅(见方法)。局部背栅(图 1a)通过从 2 nm/8 nm Ti/Pt(Pt 在顶部)剥离,然后进行 6 nm HfO2的热原子层沉积而形成图案。WS2在蓝宝石上单独生并转移到 HfO2上。通过 XeF2蚀刻对WS2沟道进行图案化,并使用电子束 (e-beam) 光刻技术定义L ch从 30 nm 到 1 μm 的转移长度法 (TLM) 结构。通过电子束蒸发在 ∼10 –8 Torr下沉积覆盖有 Au (20 nm) 的 Ni (15 nm)以形成接触。Ni/Au 薄膜的总应力为 160–175 MPa(表 S1 )。电气测量在真空(∼
10 –4 Torr)下在 296 K 下进行。
由于接触所施加的应力随 LC 的增加而增加,对LC值为 0.1 和 1 μm 的接触进行图案化,以检查接触施加应力对器件性能的影响。如后面所述,短LC (0.1 μm) 是电流传输长度的两倍多,这表明电流拥挤不会影响器件行为。图1d 比较了在Lch = 200 nm 处测量的短 ( LC = 0.1 μm) 和长 ( LC = 1 μm) 接触器件的传输 ( ID与VGS ) 曲线。接触较长的器件具有更高的漏极电流、更大的负阈值电压 ( V T ) 和更大的gm。对于Lch = 200 nm的器件,我们发现,增加LC (0.1 至 1 μm) 会使中值ID,max (定义为所施加的VGS范围内的最大漏极电流I D )加倍,从 35.1 μA/μm 增加至 70.2 μA/μm,使中值V T负移 −0.1 V (从 0.9 增加至 0.8 V),并使中值峰值g m从 32.7 μS/μm 增加至 54.3 μS/μm ( V DS = 1 V)。
为了理解这些变化,我们进行了有限元分析方法模拟,以揭示应力金属接触对 WS2沟道上应变分布的影响,该应变分布与L C和
L ch均有关。图 2a显示了LC = 1 μm 和不同Lch的 WS2器件中的面内应变分布。对于长沟道器件(L ch = 1 μm),WS2中的拉伸应变在接触边缘附近最高,并向通道中心衰减。随着Lch 的减小,接触边缘处的最大 WS2拉伸应变从 0.18%(L ch = 1 μm)增加到 0.49%(Lch = 30 nm)。支持信息第 3 部分对模拟进行了更详细的描述,其中还显示 WS 2中的应变主要是单轴的,沿电流流动的方向。
图2b 显示了当LC减小至 0.1 μm时 WS2中的应变。显然,最大拉伸应变比LC = 1 μm 时要低一个数量级,范围从 0.017% 到 0.03% 应变。这是因为触点中的应力主要由沉积条件决定,因此与触点几何形状无关。L C的总(压缩) 变化(触点对通道的拉力) 大约与标称L C成正比。因此,我们发现L ch和L C都会显著影响 WS 2沟道中的拉伸应变。L ch和L C之间的比率将决定整体应变曲线:即使在较短的LC下,随着L ch的缩小,通道中的应变也会增加。
我们利用光致发光 (PL) 光谱法验证了 WS2
沿沟道的应变分布(见支持信息第 4 部分)。由于 WS2中的拉伸应变通过降低导带来减少直接带隙,因此 PL 峰会随着拉伸应变而红移。为了探测远离接触边缘的 WS2 中的应变分布,我们沿 WS2 绘制了 PL 光谱,像素间距为 200 nm。图2c 显示了光学图像和 1.7–2.2 eV 范围内的积分强度,以准确确定接触位置(深蓝色)。测试设备是在 100 nm SiO2(在 Si 上)而不是金属局部背栅上制造的,以准确绘制共焦 PL 响应。对 PL 光谱进行了拟合(具有加权高斯-洛伦兹线形),并绘制了中性 A 激子峰相对于接触边缘的距离(图 2d )。靠近接触边缘的WS2的 A 激子峰降低了 20 meV,与基于先前实验工作的 ∼0.5% 拉伸应变一致。WS2 PL峰值位置在距接触边缘约 1.5μm 处恢复到其标称值,说明了应力金属在WS2上施加的应变的横向衰减长度的上限。我们注意到这些测量受到衍射极限的限制,PL 无法探测金属触点下的 WS2。标称接触区域产生的信号是由于有限的激光光斑尺寸,它会从触点外部区域收集一些信号。
在图 2 e,f 中,我们还对L ch = 1 μm 和L C = 1 μm的器件进行了 PL 映射。通道中的 PL 峰值比标称 PL 峰值低 30 meV,这对应于材料中产生的 ∼0.7% 应变。图2f中 A 激子峰位置的轮廓与图 2a中通过模拟获得的沟道内和接触外部的预期应变轮廓相匹配,支持了我们的结论,即金属接触会在 WS2中引起应变(图 S4a、b)。
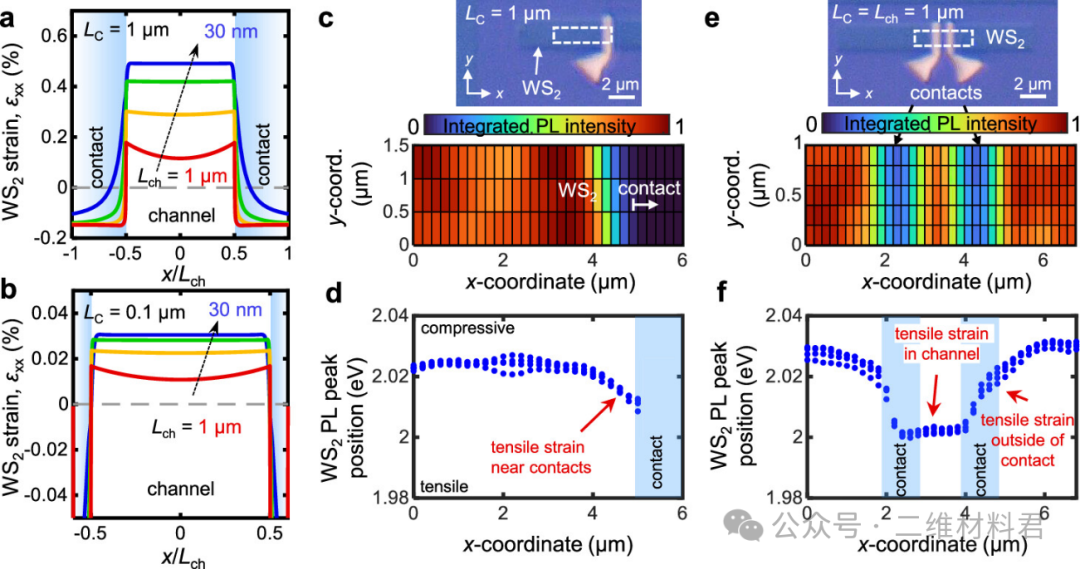
图 2. (a) 模拟沿着接触长度L C = 1 μm 和通道长度L ch = 1 μm、300 nm、100 nm 和 30 nm的器件的水平应变分布。为便于观察,位置x已通过L ch标准化。(b) 模拟沿着L C = 0.1 μm 和L ch = 1 μm、300 nm、100 nm 和 30 nm 的器件的水平应变分布。(c) 远离接触边缘的积分光致发光 (PL) 光谱强度图(右侧)。(d) 针对 (c) 中的图,测量 WS 2中的 A 激子峰与x坐标的关系。(e) L ch = 1 μm 和L C
= 1 μm的器件的积分 PL 光谱强度图,显示了接触的位置(深蓝色)。 (f) 测量(e) 图中WS 2的 A 激子峰与x坐标的关系。对于图 (d、f),我们注意到,由于激光光斑尺寸有限(约 500 nm),绘制在接触区域下方的数据代表接触边缘外侧的 WS 2区域。由于顶部有金属层,因此无法探测到位于接触正下方的WS 2 。
如图1 d所示,g m和I D均强烈依赖于接触和沟道尺寸。图 3 a,b 中测量的转移曲线分别比较了Lch = 1 μm 和 50 nm 的长接触( LC = 1 μm)和短接触(LC = 0.1 μm)器件。在所有Lch下,我们一致观察到长接触表现出更高的I D,max。对于长沟道(Lch = 1 μm),在固定过驱动电压(V ov = V GS – V T )1.1 V 下,从L C = 0.1 μm 切换到L C = 1 μm时,导通电流( I on )的平均增加量为 1.35 倍(图 3 a、c)。相比之下,对于短沟道(L ch = 100 nm),长接触器件的I on增加了 2.67 倍(图 3 b、c)。图3c 总结了LC
对I on ( V ov = 1.1 V 时) 和L ch之间非线性关系的强烈影响:即,当具有长接触时,较短的沟道会显示出更大的I on增幅。这与图 2a中的模拟一致,其中较短沟道器件在WS2中表现出较大的拉伸应变。图3d 绘制了每个L ch处实验测得的中值峰值gm ,显示具有长接触的器件的峰值 gm 明显增加。当L ch很长( L ch = 1 μm)时,长接触的中值峰值gm会增加1.74倍(即应变更高)。在具有长 L ch 的器件中,其主要由沟道电阻R ch (例如,R ch > 10 R C )决定,因此可以合理地预期gm主要受迁移率的影响。因此, g m的增加归因于这种长沟道状态下迁移率的增加。这与最近的研究结果一致,这些研究发现拉伸应变可以减少单层 MoS2或 WS2导带中的谷间散射,从而提高迁移率。
根据我们的 TLM 结构,我们还使用两个L C值估算了R C(图 3e),发现长接触导致的RC明显低于短接触。对于我们的最佳 TLM 结构,较长的
LC在V ov = 2.3 V 时产生1.73 kΩ·μm 的RC。这与文献中现有的一些最佳 Ni 与单层 WS2接触一致,范围在 0.72 至 2.6 kΩ·μm 之间(参见表S3)。就其标称接触结构而言,这些研究相当于我们的“应变”长接触情况,其中 Ni 厚度 >15 nm,L C约为 1 μm。我们注意到,TLM 提取RC的方法假设所有L ch的薄层电阻相同,但这可能表现出对应变的某种依赖性。但是,确保 TLM 数据是在相同的V ov下获取的,并且在 TLM 中具有短沟道器件(此处,L ch < 100 nm)似乎足以估计R C,因为短沟道器件几乎完全受接触限制。
与长接触相比,我们的短接触在Vov = 1.8 V时具有7.8 kΩ·μm 的R C。我们注意到,我们的短L C(0.1 μm)远大于估计的传输长度L T ≈ 37 nm(支持信息第 6 部分),这表明较高的R C不是由于电流拥挤造成的,而是由于较短接触引起的 WS2 应变较低。R C的改善很可能源于接触附近区域的电子浓度较高。接触附近的高拉伸应变(图 2a)降低了导带,从而增加了电子浓度。长接触器件的V T也较低(低 −0.27 V)(图 S10b ),这与 WS2通道中的较大拉伸应变相一致,降低了导带边缘并增加了通道和接触中的电子密度。我们可以看到L C的差异显著影响了
R ch和R C,长接触使g m增加了 1.74 倍(我们将其归因于增强的迁移率)并使R C降低了 78%。
WS2等 TMD 中的拉伸应变会降低导带边缘,降低接触点处电子注入的肖特基势垒高度(SBH)。我们采用与温度相关的测量方法(图 S11、S12)量化了接触引起的应变对长(L C = 1 μm)和短(L C = 0.1 μm)接触的 SBH 的影响(图 3f )。SBH 从短接触的 ϕ B ≈ 400 meV 降低到具有更大应变的长接触的 ϕ B ≈ 170 meV(对于图3f中绘制的单个器件)。比较三个长接触器件和三个短接触器件的测量结果显示,由于长接触引起的应变,平均势垒高度降低了 170 meV。这种大幅降低说明应变可以独立于金属功函数改变金属-2D 界面处的有效 SBH。R C 对应变和接触尺寸的这种依赖性经常被忽视,并且可能直接影响文献中报道的各种接触的表面性能。我们预计这些结果与其他 TMD 在质量上相似例如MoS2 和WSe2 这是因为它们的电子迁移率随着拉伸应变而提高。

图 3. (a) LC = 1 μm 和LC = 0.1 μm 器件(L ch = 1 μm )的I D vs V GS曲线。箭头表示电压扫描方向,显示顺时针回滞。(b) L C = 1 μm 和L C = 0.1 μm 器件(L ch = 50 nm)的I D vs V GS曲线。(c)固定过驱动V ov













