Fan-Out: Technologies and Market trends 2017
购买该报告请联系:
麦姆斯咨询 王懿
电话:17898818163
电子邮箱:wangyi#memsconsulting.com(#换成@)
扇出型(Fan-Out)封装市场的增长趋势已然确立,谁能挑战TSMC(台积电)的市场份额?面板型技术对其有何影响?
扇出型封装证明了自己的成功,但也带来了一个相对复杂的市场
扇出型封装产业还面临着许多重要的问题有待解决。增长趋势能否延续?谁能挑战TSMC?面板型技术会兴起吗?下一个杀手级应用是什么?本报告将一一为您解答。总体来看,扇出型晶圆级封装(FOWLP)以及非晶圆级扇出型封装解决方案,是过去两年来先进封装产业最火热的话题,未来也会如此。
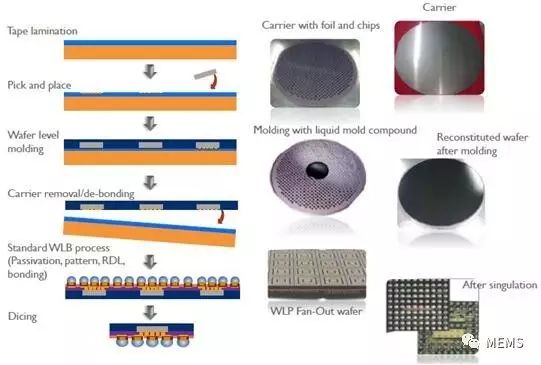
扇出型封装技术原理
2016年,TSMC的InFO FOWLP(集成扇出型晶圆级封装)解决方案被用于Apple(苹果)iPhone 7智能手机A10应用处理器的封装。这引起了市场对该平台的广泛关注,并证明了其大规模解决复杂应用的能力。2017年,苹果公司再次为其下一代处理器A11选择InFO解决方案,进一步肯定了该平台的潜力。这是否意味着扇出型封装即将席卷整个市场?是否意味着每家扇出型封装供应商都能从中获益?一如既往,对于先进封装产业来说,事情永远没有这么简单。
扇出型封装市场可以划分为两种类型:
- 扇出型封装“核心”市场,包括基带、电源管理及射频收发器等单芯片应用。
- 扇出型封装“高密度(High-Density, HD)”市场,始于苹果公司的应用处理器引擎(APE),包括处理器、存储器等IO(input-output, IO)引脚量更大的应用。
尽管两个市场都具有巨大的潜力,并且预计都将获得快速增长,但是它们的增长驱动力和供应厂商各不相同。对于扇出型晶圆级封装解决方案,“核心”市场是有一定历史的主线,早在2009年便应用于解决Intel(英特尔)的移动应用需求。现在,该技术已经获得了业内多家重量级厂商的认可,例如Qualcomm(高通),应用于大量小尺寸/低IO的应用,如音频解码器、电源管理IC、基带、雷达等。大型外包半导体封测厂商(OSAT)在该市场已经很成熟,已经稳定供应该技术多年,例如JCET/STATs ChipPAC(江阴长电/星科金朋)、ASE(日月光)、Amkor(安靠,尤其是在其并购Nanium之后)等。扇出型晶圆级封装凭借在降低产品尺寸、芯片嵌入灵活性以及电气性能方面的优势,预计该市场将在未来几年保持稳定的增长趋势,尤其是在移动应用领域。

按扇出型市场类型细分的市场营收预测
而“高密度”扇出型市场则有显著差异,相对于“核心”市场,高密度扇出型技术的目标应用更高端,能够处理数千IO。目前来看,其主要应用为应用处理器,如苹果公司的A10和A11处理器,凭借高密度扇出型封装,获得了超薄的封装和卓越的性能。目前,苹果是高密度扇出型封装的唯一客户,但是,预计其它厂商(高通?三星?)很有可能即将跟进。未来,必定还会出现其它追求扇出型封装高带宽性能的高端应用,例如高性能计算和网络应用。
目前,高密度扇出型封装市场主要源自应用处理引擎,其供应商格局和核心扇出型市场完全不同。当前仅有TSMC一家供应商,OSAT厂商可能还要再等待几代技术的发展,才能进入该市场。
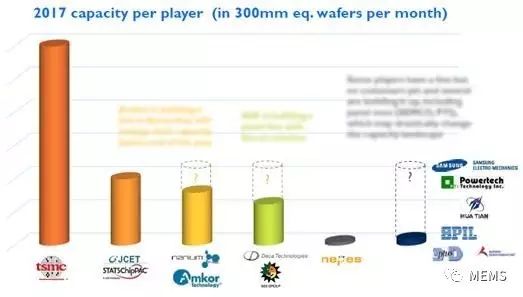
市场主要厂商的扇出型封装产能
2017年,高密度扇出型市场规模已经达到5亿美元,未来如果苹果以外的其它厂商也相继转投扇出型封装,那么市场规模或将很快超过10亿美元。
高密度扇出型封装具有如此高的增长潜力,同时,核心扇出型封装也将保持稳定的增长趋势,本报告预计扇出型封装的供应链仍将持续发展变化。本报告详细介绍并诠释了每位厂商的定位和战略,以及两类市场的要求和相关的供应链。
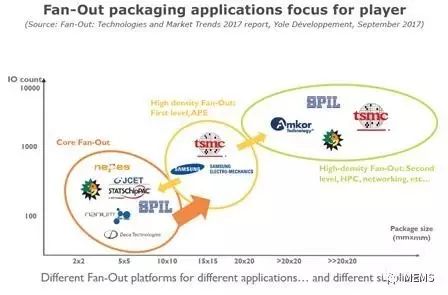
主要厂商的扇出型封装应用
基于面板型技术的扇出型封装
本报告给出了扇出型封装技术的发展路径图和供应链分析,详细解释了这个极具前景的市场的复杂性和潜在趋势,除此之外,还深入分析了制造层面所面临的挑战。对于制造来说,成本是永恒的话题。

扇出型封装面临的主要技术挑战
目前,各厂商主要通过提升晶圆尺寸来尝试降低成本。从晶圆载具(carrier)向面板型载具的转换,或能大幅降低成本。NEPES宣称,它们已经能够在面板载具上生产扇出型封装。ASE等众多厂商也正在努力实现基于面板型载具的扇出型封装,以在该市场分得一杯羹。在可预见的未来,晶圆载具将保持稳定地增长,但面板型载具预计将很快兴起。

按面板/圆形晶圆分解的扇出型封装产量预测
尽管面板型扇出型封装仍处于早期阶段,但是,市场已经在调研各种不同的解决方案以提供具有成本效益的产线。被调研的面板型技术包括那些用于印刷电路板和液晶显示的面板,但是它们的尺寸还没有标准化,还有待很多其它方面的开发。此外,还面临着许多挑战,包括良率、翘曲、财务可持续性等。本报告分析并解释了涉及扇出型面板制造的厂商的现状。
百花齐放的扇出型封装技术
扇出型封装市场是如此的纷杂,市场上许多技术都被标以“扇出型”,但是其实它们之间的区别很大,甚至有些技术并不属于扇出型封装。为了不被市场迷惑,需要对扇出型技术进行清晰的定义和细分。
本报告详细分析了涉及扇出型封装的厂商的战略、产品和服务,并提供了对这些厂商未来发展的预判。市场上除了已经比较成熟的嵌入式晶圆级球栅阵列技术,许多其它技术都采用了不同的技术方案,例如芯片先装、芯片后装、面朝上或面朝下等。采取各种不同的技术方案,是由于每位厂商都希望自己的解决方案能够成为市场主导。同样的,许多应用都有机会采用扇出型封装,这意味着特定的应用会有特定的需求。例如,汽车雷达相比智能手机应用,往往要求更高的可靠性和更长的使用寿命,因此会需要针对性改良的扇出型封装技术。
















