从Foundry厂得到圆片进行减薄、中测打点后,即可进入后道封装。封装对集成电路起着机械支撑和机械保护、传输信号和分配电源、散热、环境保护等作用。
随着集成电路的迅速发展,IC封装技术也随着提高,IC行业应用需求越来越大,集成度也越来越高,技术指标一代比一代先进,芯片面积与封装面积比例越来越接近1,电器性能以及可靠性也逐渐提高,体积更加小型化和薄型化。
半导体行业对芯片封装技术水平的划分存在不同的标准,目前国内比较通行的标准是采取封装芯片与基板的连接方式来划分,总体来讲,集成电路封装封装技术的发展可分为四个阶段:
第一阶段:
20世纪80年代以前(插孔原件时代)
封装的主要技术是针脚插装(PTH),其特点是插孔安装到PCB上,主要形式有SIP、DIP、PGA,它们的不足之处是密度、频率难以提高,难以满足高效自动化生产的要求。

TO(晶体管外形封装)
TO是晶体管外形封装,一类是晶体管封装类,这种能够使引线被表面贴装,另一类是圆形金属外壳封装无表面贴装部件类。这种封装应用很广泛,很多三极管、MOS管、晶闸管等均采用这种封装。
DIP(双列封装)
DIP封装也叫双列直插式封装或者双入线封装,绝大多数中小规模集成电路均采用这种封装形式,其引脚数一般不超过100,采用这种封装方式的芯片有两排引脚,可以直接焊在有DIP结构的芯片插座上或焊在有相同焊孔数的焊位中。其特点是可以很方便地实现PCB板的穿孔焊接,和主板有很好的兼容性。包括CerDIP(陶瓷双列直插式封装)、PDIP(塑封)
SIP(单列直插封装)
单列直插式封装引脚从封装一个侧面引出,排列成一条直线。通常它们是通孔式的,引脚从封装一个侧面引出,排列成一条直线。当装配到印刷基板上时封装呈侧立状。引脚中心距通常为2.54mm,引脚数从2 至23,多数为定制产品。封装的形状各异。
PGA(引脚栅阵列)
陈列引脚封装。插装型封装之一,其底面的垂直引脚呈陈列状排列。封装基材基本上都采用多层陶瓷基板。用于高速大规模逻辑LSI电路。管脚在芯片底部,一般为正方形,引脚中心距通常为2.54mm,引脚数从64到447左右。一般有CPGA(陶瓷针栅阵列封装)以及PPGA(塑料针栅阵列封装)两种。
第二阶段:
20世纪80年代中期(表面贴装时代)
表面贴装封装的主要特点是引线代替针脚,引线为翼形或丁形,两边或四边引出,节距为1.27到0.4mm,适合于3-300条引线,表面贴装技术改变了传统的PTH插装形式,通过细微的引线将集成电路贴装到PCB板上。主要形式为SOP(小外型封装)、PLCC(塑料有引线片式载体)、PQFP(塑料四边引线扁平封装)、J型引线QFJ和SOJ、LCCC(无引线陶瓷芯片载体)等。
它们的主要优点是引线细、短,间距小,封装密度提高;电气性能提高;体积小,重量轻;易于自动化生产。它们所存在的不足之处是在封装密度、I/O数以及电路频率方面还是难以满足ASIC、微处理器发展的需要。

SOP(小型封装)
SOP封装是一种元件封装形式,常见的封装材料有:塑料、陶瓷、玻璃、金属等,现在基本采用塑料封装.,应用范围很广,主要用在各种集成电路中。后面就逐渐有TSOP(薄小外形封装)、VSOP(甚小外形封装)、SSOP(缩小型SOP)、TSSOP(薄的缩小型SOP)、MSOP(微型外廓封装)、 QSOP(四分之一尺寸外形封装)、QVSOP(四分之一体积特小外形封装)等封装。
LCC(带引脚或无引脚芯片载体)
带引脚的陶瓷芯片载体,表面贴装型封装之一,引脚从封装的四个侧面引出,是高速和高频IC用封装,也称为陶瓷QFN或QFN-C。有CLCC(翼形引脚)、LDCC、PLCC
QFP (四方扁平封装)
这种封装是方型扁平式封装,一般为正方形,四边均有管脚,采用该封装实现的CPU芯片引脚之间距离很小,管脚很细,一般大规模或超大规模集成电路采用这种封装形式,其引脚数一般都在100以上。因其其封装外形尺寸较小,寄生参数减小,适合高频应用。这类封装有:CQFP(陶瓷四方扁平封装)、 PQFP(塑料四方扁平封装)、SSQFP(自焊接式四方扁平封装)、TQFP(纤薄四方扁平封装)、SQFP(缩小四方扁平封装)
第三阶段:
20世纪90年代出现了第二次飞跃,进入了面积阵列封装时代
该阶段主要的封装形式有焊球阵列封装(BGA)、芯片尺寸封装(CSP)、无引线四边扁平封装(PQFN)、多芯片组件(MCM)。BGA技术使得在封装中占有较大体积和重量的管脚被焊球所替代,芯片与系统之间的连接距离大大缩短,BGA技术的成功开发,使得一直滞后于芯片发展的封装终于跟上芯片发展的步伐。CSP技术解决了长期存在的芯片小而封装大的根本矛盾,引发了一场集成电路封装技术的革命。

MCM(多芯片组件)
其实这是一种芯片组件,是一种最新技术,它是将多块半导体裸芯片组装在一块布线基板上的一种封装技术,因此它省去了IC的封装材料和工艺,从而节省了材料,同时减少了必要的制造工艺,因此严格的是一种高密度组装产品。
CSP (芯片规模封装)
CSP封装是一种芯片级封装,我们都知道芯片基本上都是以小型化著称,因此CSP封装最新一代的内存芯片封装技术,可以让芯片面积与封装面积之比超过1:1.14,已经相当接近1:1的理想情况,被行业界评为单芯片的最高形式,与BGA封装相比,同等空间下CSP封装可以将存储容量提高三倍。这种封装特点是体积小、输入/输出端数可以很多以及电气性能很好,有CSP BGA(球栅阵列)、LFCSP(引脚架构)、LGA(栅格阵列)、WLCSP(晶圆级)等。
BGA (球栅阵列)
球形触点阵列,表面贴装型封装之一。在印刷基板的背面按陈列方式制作出球形凸点用以代替引脚,在印刷基板的正面装配LSI 芯片,然后用模压树脂或灌封方法进行密封。也称为凸点陈列载体(PAC)。BGA主要有:PBGA(塑料封装的BGA)、CBGA(陶瓷封装的BGA)、CCBGA(陶瓷柱状封装的BGA)、TBGA(载带状封装的BGA)等。目前应用的BGA封装器件, 按基板的种类,主要CBGA(陶瓷球栅阵列封装)、 PBGA(塑料球栅阵列封装)、TBGA(载带球栅阵列封装)、FC-BGA(倒装球栅阵列封装)、EPBG(增强的塑胶球栅阵列封装)等。
第四阶段:
进入21世纪,迎来了微电子封装技术堆叠式封装时代,它在封装观念上发生了革命性的变化,从原来的封装元件概念演变成封装系统。
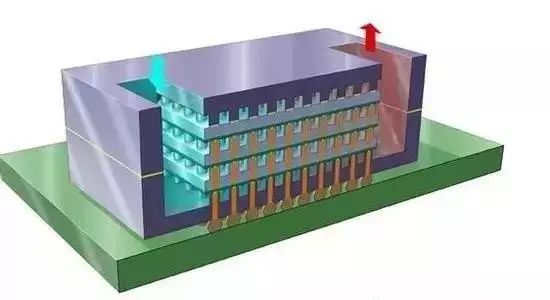
3D晶片堆叠技术

堆叠式存储模块
目前,以全球半导体封装的主流正处在第三阶段的成熟期,PQFN和BGA等主要封装技术进行大规模生产,部分产品已开始在向第四阶段发展。
-END-





