本文介绍了新加坡南洋理工大学刘政教授团队在二维半导体晶体管栅极电介质制造方面的新突破。他们通过挤压打印和表面张力驱动方法,将自然形成的超薄原生氧化镓(Ga2O3)层集成到二硫化钼(MoS2)表面。该Ga2O3层具有高介电常数和低等效氧化物厚度,显著提高了晶体管的性能。文章还提供了图文介绍和文献信息。
新加坡南洋理工大学刘政教授团队成功集成了自然形成的超薄原生氧化镓(Ga2O3)层到二硫化钼(MoS2)表面,解决了沉积技术的问题。
使用挤压打印和表面张力驱动方法,将Ga2O3层集成到MoS2上。Ga2O3层具有高介电常数和低等效氧化物厚度,显著提高了晶体管的性能。
带有Ga2O3栅极电介质的MoS2晶体管的亚阈值摆幅低至60 mV dec-1,开关比高达108,栅极漏电流低至约4×10-7 A cm-2。此外,该研究还为二维晶体管的其他潜在应用提供了有价值的参考。
本文已被发表在自然电子期刊上,并提供文献链接。此外,上海昂维科技有限公司提供相关二维材料耗材、微纳加工服务和测试分析服务。
为了方便各位同学交流学习,解决讨论问题,我们建立了一些微信群,作为互助交流的平台。
2.告知:姓名-课题组-研究方向,由编辑审核后邀请至对应交流群(生长,物性,器件);
欢迎投稿欢迎课题组投递中文宣传稿,免费宣传成果,发布招聘广告,具体联系人:13162018291(微信同号)

成果介绍
具有良好介电性能的金属氧化物层的沉积是制造基于二维半导体的晶体管栅极电介质的关键步骤。然而,当前在二维半导体上沉积超薄金属氧化物层的技术存在质量问题,可能会损害晶体管性能。
有鉴于此,新加坡南洋理工大学刘政教授团队
通过
挤压打印和表面张力驱动方法,
将
在环境中自然形成于液态金属表面
的
超薄、均匀的原生氧化镓(Ga
2
O
3
)
层集成到
二硫化钼(MoS
2
)表面。
该
Ga
2
O
3
层具有约 30 的高介电常数和约 0.4 纳米的等效氧化物厚度。由于良好的介电性能和范德华
集成
,带有 Ga
2
O
3
栅极电介质的 MoS
2
晶体管的
亚阈值
摆幅低至 60 mV dec
-1,开关
比为 10
8
,栅极漏电流低至约 4 × 10
-7
A cm
-2
。
图文介绍
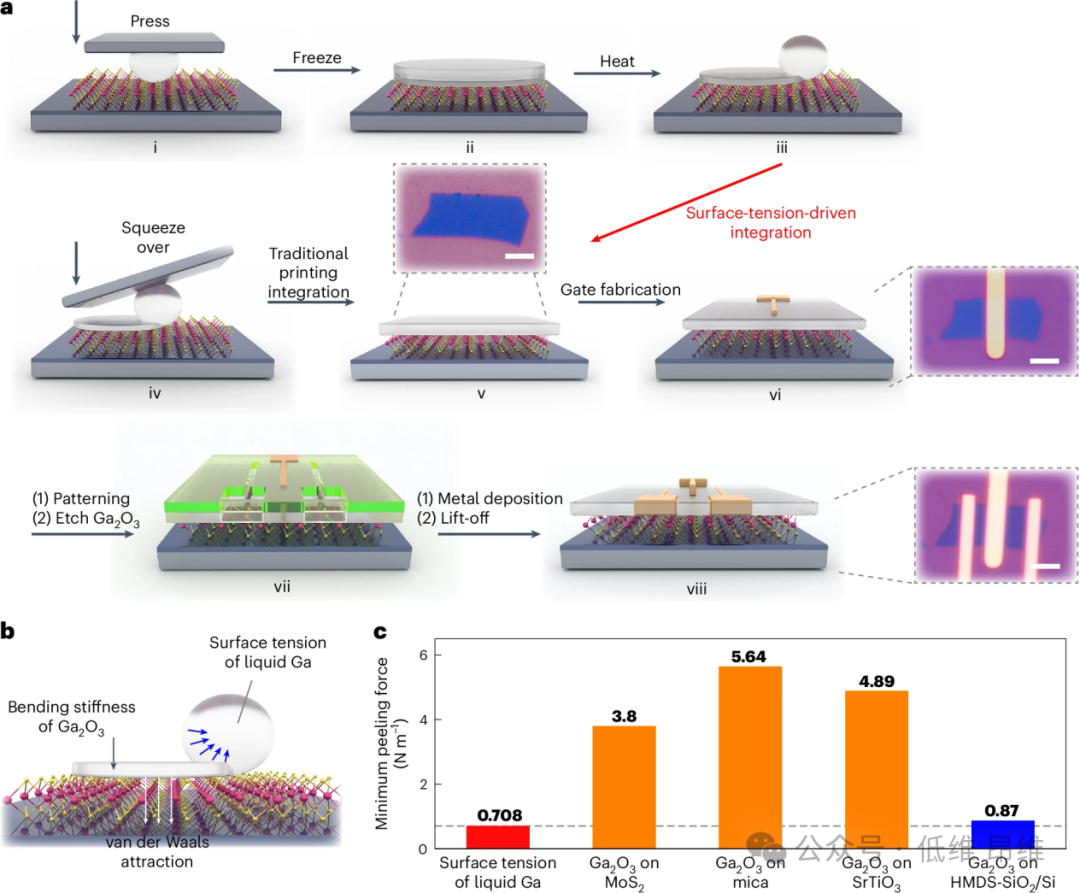
图1. Ga
2
O
3
作为介电层的集成
。
a,用于顶栅场效应晶体管的Ga
2
O
3
在二维半导体上的表面张力驱动集成和传统印刷集成示意图,以及相应的光学显微镜图像。
b,集成过程中液态镓的表面张力将Ga
2
O
3
从基底拉出、Ga
2
O
3
的弯曲刚度以及基底与Ga
2
O
3
之间的范德华吸引力之间的竞争示意图。
c,液态镓的表面张力与DFT计算的不同基底上的最小剥离力之间的比较。虚线为0.708 N m
-1
,即液态镓的表面张力值。比例尺为4μm。
HMDS
:六甲基二硅氮烷。

图2. 带有Ga
2
O
3
介电层的顶栅MoS
2
FET器件配置。
a,顶部栅极MoS
2
FET的示意图。
b,顶部栅极MoS
2
FET栅极区域的横截面STEM图像。
c,(b)中红色虚线方框标记的横截面样品的EDS图谱。
d,三层MoS
2
和Ga
2
O
3
接口的原子分辨率横截面ADF图像。比例尺:30 nm(b)、3 nm(c)、1 nm(d)。
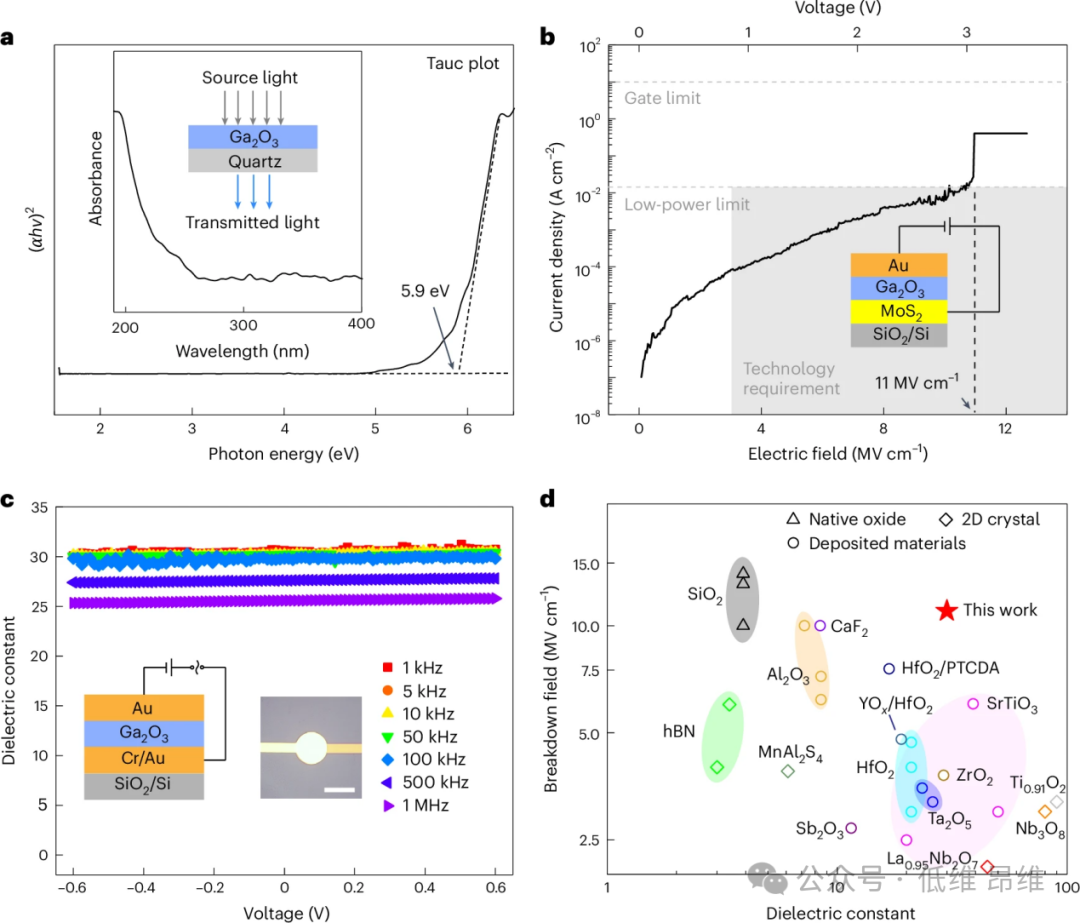
图3. Ga
2
O
3
的介电性能
。
a,根据紫外-可见光谱法捕捉到的石英上Ga
2
O
3
的吸收光谱计算出的陶克图,其中α为吸收系数,h为普朗克常数,ν为频率。插图:在石英上制备的Ga
2
O
3
的吸收光谱和测量示意图。
b,Ga
2
O
3
的漏电流和击穿特性。电流密度和击穿场强的技术要求、低功率限制和栅极限制来自2022
年
IRDS。
c,根据不同频率下的电容测量计算得出的介电常数与偏置电压的关系。
d,与其他常用介电材料相比,击穿场强与介电常数的关系。比例尺为5μm。
PTCDA
:
苝四羧酸二酐。

图4.带有Ga
2
O
3
介电层的MoS
2
FET性能
。 a,
带有Ga
2
O
3
介电层的顶部栅极MoS
2
FET的输出曲线(漏源电流Ids与漏源电压Vds的关系)。
b,
带有Ga
2
O
3
介电层的顶部栅极MoS
2
FET的转移曲线。插图:相应场效应晶体管的光学显微镜图像。
c,从转移曲线中提取的
亚阈值摆幅(
SS
)
与Ids的关系。虚线为60 mV dec
-1
。
d,19个带有Ga
2
O
3
介电层的基于剥离MoS
2
的场效应晶体管的SS分布。
e,使用不同介电材料的二维晶体管的SS与EOT的最新结果比较
。
f,二维晶体管中使用的不同介电材料的漏电流密度J与EOT的比较。虚线为1.5×10
-2
A cm
-2
。
g,MoS
2
与不同介电材料之间的界面态密度与EOT的比较
。
h,在带有Ga
2
O
3
介电层的CVD MoS
2
单晶上制造的25个顶部栅极场效应晶体管的扫描电子显微镜图像
。
i,h中虚线方框标记区域的放大
伪
彩色扫描电子显微镜图像
。
j,25个器件的转移曲线和漏电流。插图:红色虚线方框标出的放大区域,显示SS的狭窄分布和狭窄偏移。
k,基于3英寸晶圆上的晶圆级CVD MoS
2
的缩放器件图片。比例尺:10μm(b,插图),100μm(h),10μm(i)。
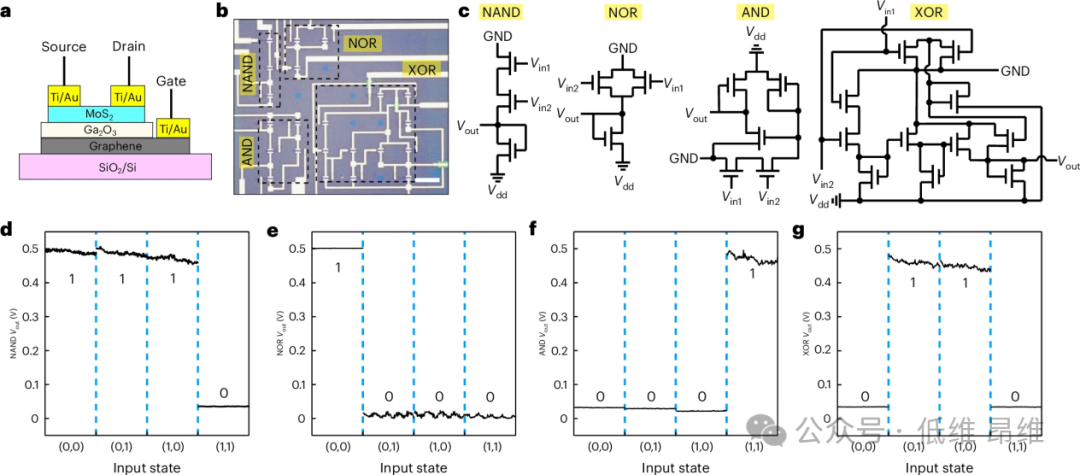
图5. 带有Ga
2
O
3
介电层的逻辑门
。a
,用于制造逻辑门的场效应晶体管配置示意图。
b
,用黑色虚线标记的逻辑门光学显微镜图像。
c
,NAND、NOR、AND和XOR门的等效电路图。
d-g
,NAND(d)、NOR(e)、AND(f)和XOR(g)门在四个典型输入状态下的输出电压,用蓝色虚线分隔。Vdd=0.5 V。刻度线,10微米。Vdd,器件电源电压;Vin1,输入电压1;Vin2,输入电压2。
文献信息
Integration of high-κ native oxides of gallium for two-dimensional transistors
(
Nat.Electron.
,2024,
DOI:
10.1038/s41928-024-01286-x
)
文献链接:https://www.nature.com/articles/s41928-024-01286-x
上
海
昂
维
科
技
有
限
公
司
现
提
供
二
维
材
料
单
晶
和
薄
膜
等
耗
材
,
器
件
和
光
刻
掩
膜
版
定
制
等
微
纳
加
工
服
务
,以及各种测试分析,
欢
迎
各
位
老
师
和
同
学
咨
询
,
竭
诚
做
好
每
一
份
服
务
。







