为了方便各位同学交流学习,解决讨论问题,我们建立了一些微信群,作为互助交流的平台。
2.告知:姓名-课题组-研究方向,由编辑审核后邀请至对应交流群(生长,物性,器件);
欢迎投稿欢迎课题组投递中文宣传稿,免费宣传成果,发布招聘广告,具体联系人:13162018291(微信同号)

研究背景
自CVD石墨烯在Cu上生长的首次演示以来,在对该过程的理解、控制和规模化方面取得了许多进展。开创性的研究通过同位素标记和原位监测等技术提供了对生长过程的理解,并证明了对成核密度和生长速度等关键因素的控制。该工艺的初步演示作为规模化制造的途径引起了极大的兴趣,随后的进展包括卷对卷加工的发展,晶体衬底上的外延生长,原位Cu沉积和折叠/褶皱的控制。最近的研究表明,石墨烯表面非晶碳的积累是影响石墨烯性能的关键因素。尽管有了这些和许多其他的进展,对CVD生长过程的基本理解和控制仍然缺乏。例如,虽然实验已经确定生长速率随CH
4
浓度增加而增加,随H
2
浓度增加而降低,但目前还没有一个公认的生长动力学的定量模型来指导合成。同样,影响石墨烯质量的基本过程仍不清楚。更广泛地说,结果的可重复性仍然是该领域的一个重大挑战,这表明存在影响石墨烯合成的隐藏变量,这些变量既不能在实验中得到很好的控制,也不能在理论模型中得到理解。
成果介绍
有鉴于此,近日,
美国哥伦比亚大学James Hone,Katayun Barmak和加拿大蒙特利尔大学Richard Martel(共同通讯作者)等合作发现微量氧是决定低压CVD生长的石墨烯的生长轨迹和质量的关键因素
。无氧化学气相沉积(OF-CVD)合成速度快,可重复性高,动力学可以用紧凑的模型来描述,而添加微量氧会抑制成核和缓慢/不完全生长。本文通过表面污染、拉曼D峰的出现和电导率的降低来评估氧对石墨烯质量的影响。在无氧条件下生长的外延石墨烯是无污染的,没有可检测到的D峰。经过干法转移和氮化硼封装后,其室温电输运行为接近于剥离的石墨烯。石墨栅控器件表现出良好的整数和分数量子霍尔效应。通过强调消除微量氧的重要性,本工作为今后CVD系统的设计和运行提供了指导。OF-CVD合成所带来的可重复性和质量的提高将广泛影响石墨烯的基础研究和应用。文章以“
Reproducible graphene synthesis by oxygen-free chemical vapour deposition
”为题发表在顶级期刊
Nature
上。
图文导读

图1. OF-CVD系统设计,微量氧的影响和高重复性。(a)系统概述突出了关键部件,以减少氧化性杂质。(b)P
CH4
=10 mTorr,t
g
=10 s,30 s,90 s和120 s时无氢石墨烯生长的晶粒演化光学图像。(c)有无微量氧时石墨烯覆盖率与t
g
的关系。(d)8个不同合成过程中石墨烯晶粒的代表性图像。(e)平均石墨烯晶粒成核密度(ND)和晶粒面积(GA)与样品数量的关系。
图1a显示了本研究中使用的CVD反应器的示意图。该系统基于实验室研究中最常用的热壁设计,并在低压下运行,以最好地保持系统清洁度。通过分子泵送实现高真空,CH
4
、H
2
、O
2
和Ar的流量由流量控制器控制。所有气体管道都是电镀抛光的不锈钢,带有氦检漏的金属配件。由于研究级气体通常含有ppm范围内的氧杂质,因此本文使用超大规模集成(ULSI)级气体(纯度为6N)和净化器,可将杂质(H
2
O,O
2
,CO
2
,CO)去除到<100万亿分之一(10
-12
)的水平。每条气体管道在打开之前都要进行净化,以避免瞬态压力峰值(在CH
4
的情况下,这可能导致不受控制的石墨烯成核)。微量气体分析证实含氧污染物(H
2
O、O
2
、CO
2
、CO)的分压小于1 μTorr。石墨烯CVD合成采用的典型工艺是,将Cu衬底在富氢气氛中加热到生长温度T
g
≈1000 ℃,随后在CH
4
中生长t
g
,然后冷却到室温。图1b为在没有H
2
的情况下石墨烯合成后基底的光学显微镜图像。在t
g
=10 s时出现了间距约为20 μm的孤立晶粒,然后在t
g
=120 s时生长并合并形成无针孔的连续薄膜。四重晶粒对称性与底层Cu(100)相匹配,表明生长受供给限制而非粘附限制。在生长阶段加入微量氧(P
O2
/P
CH4
=10
-6
),晶粒先长大,然后在较高t
g
时收缩消失。为了量化每种情况下的生长轨迹,本文使用光学图像处理来计算每个样品的石墨烯覆盖率,结果绘制在图1c中。无氧时,覆盖率随t
g
平稳增加。对于微量氧,最初的生长是相似的,但随后覆盖率下降,石墨烯消失。这些发现支持了早期工作的结论,并通过展示在微量氧存在下的OF-CVD生长速度和生长/刻蚀轨迹来扩展它。为了测试OF-CVD的可重复性,本文合成了t
g
=120 s的石墨烯,实现了良好分离的晶粒,并测量了大范围内的平均成核密度和晶粒面积。这个过程最初重复了12次,9个月后又重复了8次。图1d显示了8次迭代得到的石墨烯晶粒的光学图像。如图1e所示,成核密度和晶粒面积非常一致,变化系数为13%,不受环境条件的影响。

图2. 石墨烯晶粒生长的动力学。(a)横向晶粒尺寸L与生长持续时间的关系。(b)生长前期L与t
g
呈线性相关。(c)晶粒生长速率Ĺ与T
g
的关系。(d)Ĺ和P
CH4
的关系。(e)Ĺ和P
H2
的关系。(f)Ĺ和P
CH4
/
P
H2
0.5
的关系。
OF-CVD合成的高速度和可重复性使得能够通过跟踪几个样品的晶粒形态来研究生长动力学,这些样品的给定参数(t
g
,T
g
,P
CH4
,P
H2
)被调节。如上所述,发现OF-CVD的生长始于快速的晶粒形核,然后是晶粒扩张以实现完全覆盖。成核的数量不随t
g
增加而增加。图2a显示了晶粒生长的典型轨迹,晶粒尺寸最初随着t
g
迅速增大,当薄膜接近全覆盖时,晶粒生长减慢。为简单起见,本文把重点放在早期生长阶段,在这个阶段,晶粒分离得很好。如图2b所示,在三种不同的生长条件下,L最初随t
g
线性增加。因此,只需要一个样品就可以确定图2c-f中每个点的晶粒生长速率Ĺ。如图2c所示,Ĺ与活化温度的关系与E
app
的特征能(表观活化能)=1.7±0.06 eV有关。在固定T
g
下,Ĺ与P
CH4
呈线性关系(图2d)。再加上四重晶粒形状,这些发现支持了一种观点,即生长速度受到碳供给的限制,而碳供给反过来又受到Cu表面CH
4
催化脱氢的控制。接下来,本文探讨了P
H2
≫P
CH4
范围中Ĺ与P
H2
的关系。如图2e所示,Ĺ随P
H2
增加而减小。Ĺ∝P
H2
-0.5
的相关性表明CH
4
脱氢过程中至少有一个步骤处于平衡状态。图2f证实了Ĺ与P
CH4
/
P
H2
0.5
的线性关系,与该模型一致。
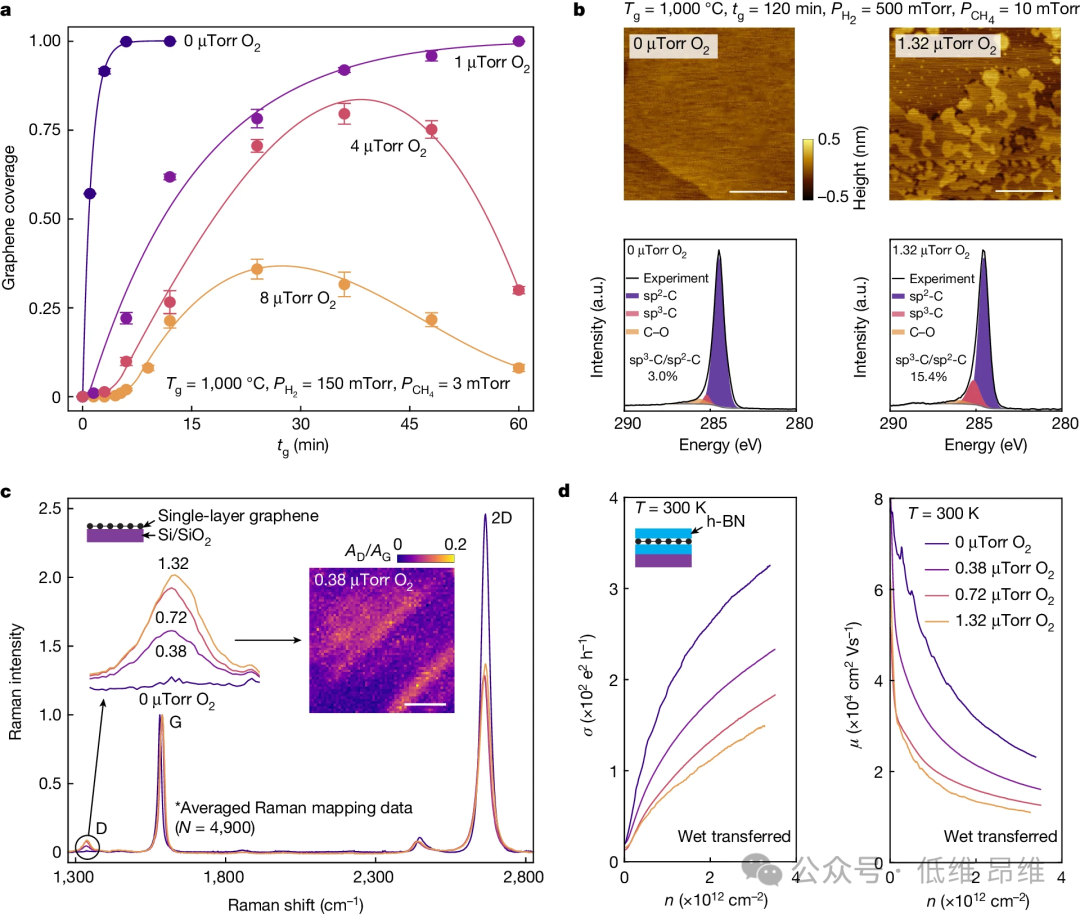
图3. 在典型(富氢)CVD条件下,微量O
2
对石墨烯生长的影响。(a)不同P
O2
下石墨烯覆盖率随t
g
的变化。(b)微量氧合成的石墨烯的表面清洁度表征。(c)不同P
O2
合成的Gr/SiO
2
样品的平均拉曼光谱。(d)室温电导(左)和霍尔迁移率(右)随载流子密度(n)的变化。
微量氧在控制生长结果中起着关键作用,即使在典型(富氢)CVD条件下,还原气氛应该抵消氧刻蚀。在图3中,本文在P
H2
=150-500 mTorr和P
CH4
=3-10 mTorr的条件下生长石墨烯。图3a显示了P
O2
=0 μTorr、1 μTorr、4 μTorr和8 μTorr时石墨烯覆盖率与t
g
的关系。在没有氧气的情况下,完全覆盖在12分钟内实现,遵循与图2a相似的轨迹,但由于氢气的加入,速度较慢。添加1 μTorr的氧气会使生长减慢大约5倍,但仍然可以实现完全覆盖。当P
O2
=4 μTorr和8 μTorr时,刻蚀在大t
g
下接管,并且无法实现全覆盖。生长的开始也被推迟了。如果氧只与甲烷一起引入,则不会发生这种延迟,因此可能反映了Cu表面氧化时的抑制成核,这与先前的发现一致。因此,尽管氢确实增加了刻蚀的阈值,但微量氧仍然强烈地改变了成核和生长速度,并可以阻止完整薄膜的生长。此外,本文发现即使实现完全覆盖,微量氧在降低石墨烯质量方面也起着尚未确定的作用。为了研究氧对质量的影响,本文合成了四种相同t
g
=120 min和不同P
O2
的样品。对于这些样品,评估了三个质量指标:表面清洁度(图3b),晶格缺陷(图3c)和电子输运(图3d)。P
O2
=0 μTorr生长的样品是平坦的,而P
O2
=1.32 μTorr生长的样品显示出一层薄薄的污染,这可以通过Au的选择性吸附进一步观察到。XPS光谱显示,在285.2 eV处的峰值有很大的增加,表明有O
2
的样品是sp
3
键合的碳。因此,可以得出结论,CVD生长过程中微量氧的存在导致非晶碳的积累,这是最近被确定为石墨烯质量的关键指标。图3c显示了四种样品湿法转移到SiO
2
后的代表性拉曼光谱。当P
O2
=0 μTorr时,D峰可以忽略不计,随着P
O2
增加而增大,而2D峰则缩小,这两种趋势都表明石墨烯晶格中出现了缺陷。对于电输运测量,本文使用湿法转移从四种石墨烯薄膜中组装h-bn封装的器件。图3d显示了所有四种样品的室温电导率和霍尔迁移率与电子密度的关系。在固定密度下,电导率和迁移率随着P
O2
增加而下降,这证实了微量氧会降低石墨烯的性能。
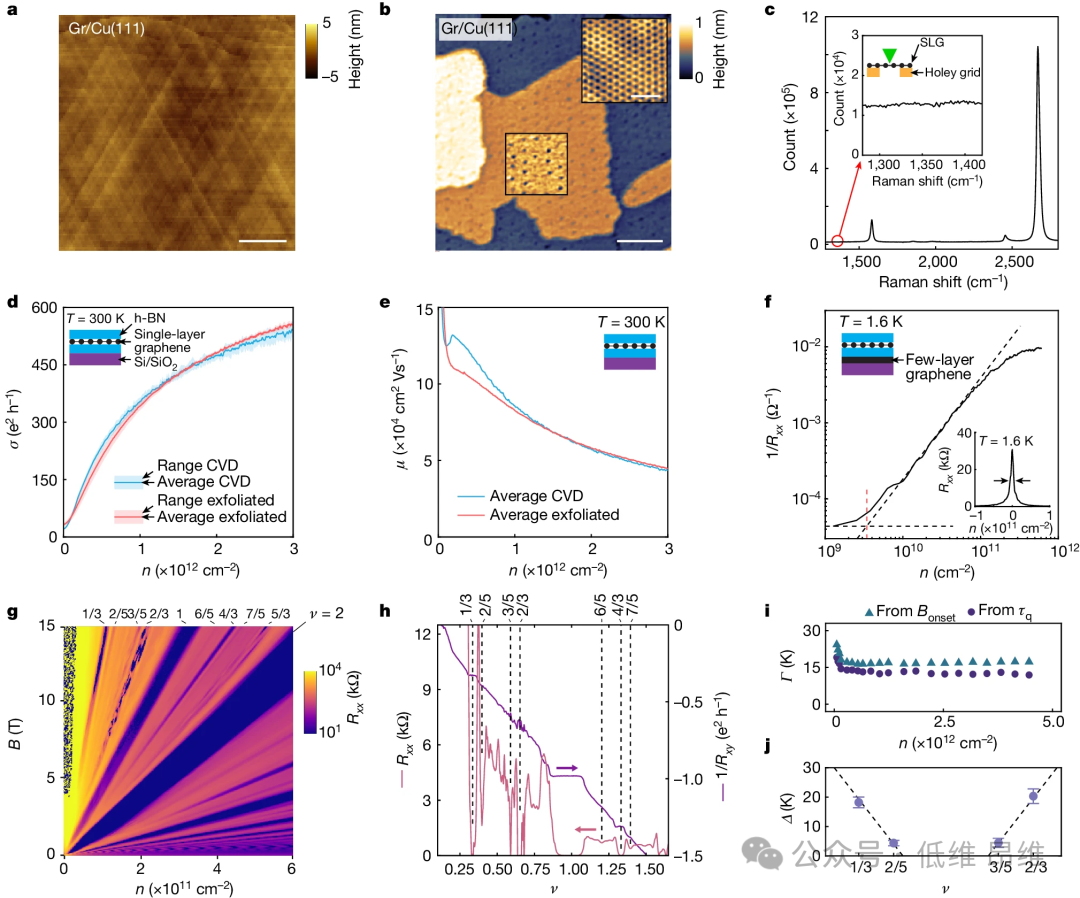
图4. 高质量OF-CVD石墨烯。(a)Gr/Cu表面的AFM形貌显示表面平坦,几乎没有折叠/褶皱,没有可检测到的表面污染。(b)石墨烯表面的STM图像。(c)在532 nm激发下收集的悬浮石墨烯的拉曼光谱。(d)三种CVD和剥离石墨烯器件的室温电导率(σ)与密度的关系。(e)室温迁移率(μ)与密度的关系。(f)低温(1.6 K)逆四端电阻(1/R
xx
)与密度的关系。(g)朗道扇形图。(h)对于ν<2,在15 T时测得的R
xx
和1/R
xy
。(i)朗道级展宽Γ。(j)在N=0能级观察到的分数量子霍尔态的激活间隙随填充分数的变化。
本文使用扫描探针成像、拉曼光谱和电输运测量相结合的方法来评估OF-CVD石墨烯的质量。由于铜箔上的CVD生长会导致褶皱和折叠,因此在这些实验中,本文在蓝宝石(0001)支持的Cu(111)薄膜上生长石墨烯,其生长是外延的,褶皱被抑制。石墨烯通过刻蚀Cu后的湿法转移或氧化Cu表面后的干法转移从生长衬底转移。图4a显示了石墨烯/Cu(111)样品的AFM形貌图像。Cu原子的台阶清晰可见,没有发现无定形碳污染的证据。扫描隧道显微镜(STM)成像清晰地分辨出石墨烯原子晶格(图4b),更大面积的STM扫描显示了原子级平坦的Cu台阶,以及Cu和石墨烯之间莫尔图案产生的周期约为10 nm的超晶格。在几个STM图像上没有观察到无定形碳。因此,可以得出结论,OF-CVD石墨烯没有表面污染。在没有衬底效应的情况下,为了测量OF-CVD石墨烯的本征拉曼光谱,通过湿法转移到多孔碳网格来制造悬浮膜。图4c中测量的光谱显示出高的2D/G峰面积比(A
2D
/A
G
≈13.75),表明了高的电子质量。没有可见的D峰。在噪声水平的基础上,估计A
D
/A
G
=0.01。这意味着缺陷间距L















