为了方便各位同学交流学习,解决讨论问题,我们建立了一些微信群,作为互助交流的平台。
2.告知:姓名-课题组-研究方向,由编辑审核后邀请至对应交流群(生长,物性,器件);
欢迎投稿欢迎课题组投递中文宣传稿,免费宣传成果,发布招聘广告,具体联系人:13162018291(微信同号)
 成果介绍
成果介绍
2D半导体过渡金属二硫化物(TMDCs)因其原子级厚度、无悬挂键的表面和高载流子迁移率,受到了广泛关注,有望将摩尔定律的应用扩展到硅以外的材料。特别是,单层TMDCs通常具有比硅更大的带隙值。已有研究表明,使用宽带隙半导体通道(如GaN、SiC和
金刚石
)可以有效降低静态漏电流、提高击穿场强,并改善电子电路的耐偏压特性,这是由于高界面能障和低量子隧穿率(即优良的绝缘特性)。这些优点对于构建低功耗、长期稳定的电子电路至关重要。在典型的TMDCs单层中,二硫化钨(WS
2
)具有最高的电子带隙(2.3 eV),使其成为开发低功耗、高可靠性电子设备的杰出宽带隙通道材料。此外,WS
2
是最稳定的2D半导体之一,具有较大的氧化反应障碍和良好的环境稳定性,这使其在制造过程中具有很好的兼容性。
但是,关于同时具有高晶体取向和优异电子性能(即晶体质量、载流子迁移率(μ)和电流承载能力)的高质量WS
2
单层晶圆的合成相关报道仍然较为稀少。实现既具备良好晶体性能又具备优异电子性能的晶圆级WS
2
材料,且其性能与硅相当或超越硅,仍然是一个难以解决的难题。有鉴于此,南京大学邓昱老师、施毅老师、郝玉峰老师和黎松林老师通过化学气相沉积(CVD)在倾斜蓝宝石(α-A
l
2
O
3
)基板上外延生长晶圆级、高度定向的WS
2
单层材料。结构和光谱表征结果表明,所生长的单层材料具有良好的晶体取向,通常表现出较低的缺陷密度(8×10¹²cm⁻²)和晶圆级的均匀性。电子测量显示,在SiO
2
/Si基板上,室温和8 K下的场效应迁移率分别为62和180 cm²∙V⁻¹∙s⁻¹。在六方氮化硼(hBN)基板上,这些迁移率进一步提高,分别达到94和473 cm²∙V⁻¹∙s⁻¹。通过引入半金属锑(Sb)作为接触电极,我们成功地实现了600Ω·μm的接触电阻,从而在超短10 nm通道长度下达到了创纪录的饱和电流密度675μA∙μm⁻¹(在0.8 V下),这一值与最先进的硅材料相媲美。这项工作为未来低功耗电子器件中使用宽带隙WS
2
单层材料提供了重要的启示。
图文导读

图1.在C/A 1°蓝宝石(0001)衬底上生长的WS₂
畴
单向取向对齐情况。a)蓝宝石晶体中错切C/A 1°平面的示意图。b)退火后C/A 1°表面的AFM形貌图像。c)错切衬底表面台阶的示意图以及上方WS₂
畴
沿对齐生长方向分布的示意图。d)在错切衬底上良好对齐的WS₂
畴
的光学图像。e)
畴
与裸衬底之间的AFM相位对比
图
。f)单向对齐WS₂
畴
的PL(光致发光)
图
。g)(e)中两个
畴
的二次谐波发生极坐标图。h)高度取向的WS₂单层的PL光谱。插图:典型的拉曼光谱。

图2.蓝宝石晶圆上高度取向WS₂单层的表征。a)直径2英寸蓝宝石(0001)衬底上高度取向WS₂薄膜的实物照片。b)PL光致发光和c)拉曼线扫描。d)WS₂薄膜的PL峰值能量(红色)以及拉曼峰位差异的统计图。e)拉曼E1 2g峰强度
图
,f)A1g峰强度
图
(来自插图)。插图:带有划痕的生长单层WS₂的光学图像。g)(e)中插图区域的PL峰强度
图
。h)WS₂薄膜的原子分辨率HAADF-STEM图像。插图显示相应的衍射图案。i)典型的HAADF-STEM图像,其中包含硫空位(虚线黄色圆圈)。j)CVD生长的单层WS₂与k)机械剥离(ME)单层WS₂之间原子空位统计密度对比。直方图以及30个(CVD)和25个(ME)局部区域的空位密度泊松拟合。CVD
(ME)单层WS₂的空位密度泊松拟合的平均值
([
 ]
)
和标准差(D)分别为8.0(30)和7.8(27.3)(×10¹²cm⁻²)。
]
)
和标准差(D)分别为8.0(30)和7.8(27.3)(×10¹²cm⁻²)。
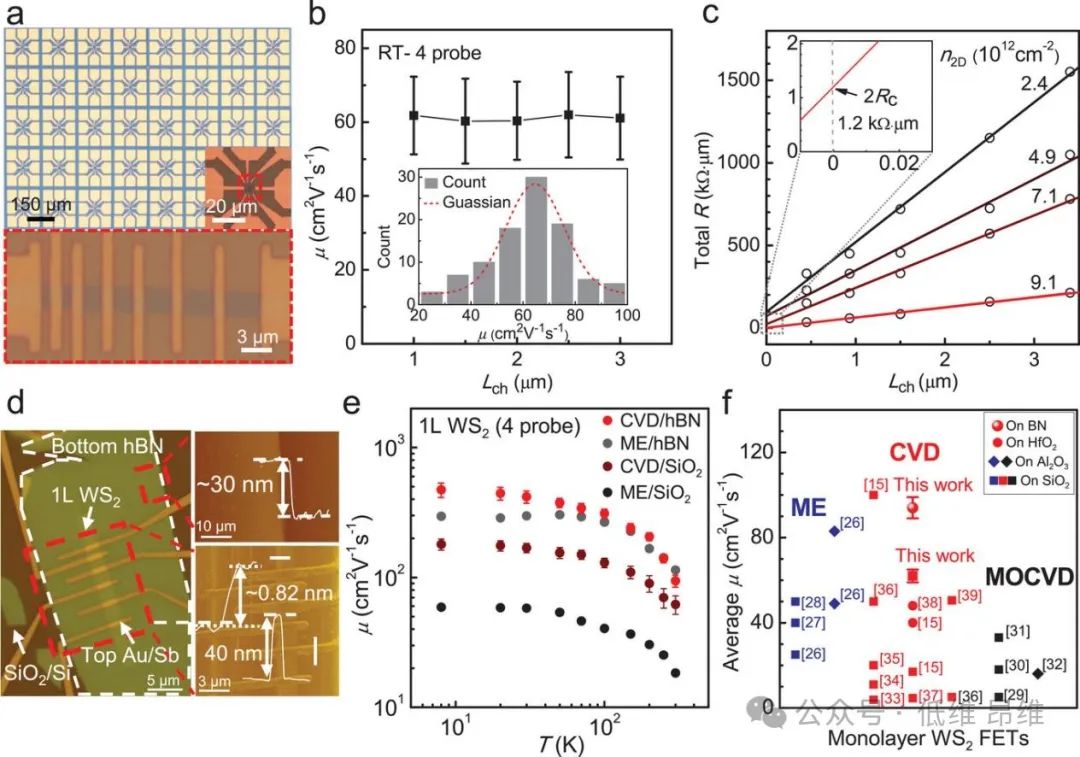
图3. 高度取向WS₂单层的电子性能。a) 顶部:覆盖0.25 cm²区域的FET阵列实物照片。插图:单元
格
放大图像。底部:TLM结构的放大视图。b) 载流子迁移率随沟道长度的变化。插图:WS₂ FET迁移率值的统计分布。c) 利用TLM方法从(a)中器件提取接触电阻Rc。从上到下,n2D分别为2.4 × 10¹² cm⁻²、4.9 × 10¹² cm⁻²、7.1 × 10¹² cm⁻²和9.1 × 10¹² cm⁻²。d) 制备的WS₂/hBN/SiO₂/Si FET的光学图像。右侧:hBN、单层WS₂和Sb/Au电极的高度剖面图。e) 在不同温度下,CVD与剥离的WS₂在hBN和SiO₂衬底上的迁移率对比。f) 在不同制备方法(ME、CVD和MOCVD)下,各种工作中报道的单层WS₂ FET的平均迁移率对比。
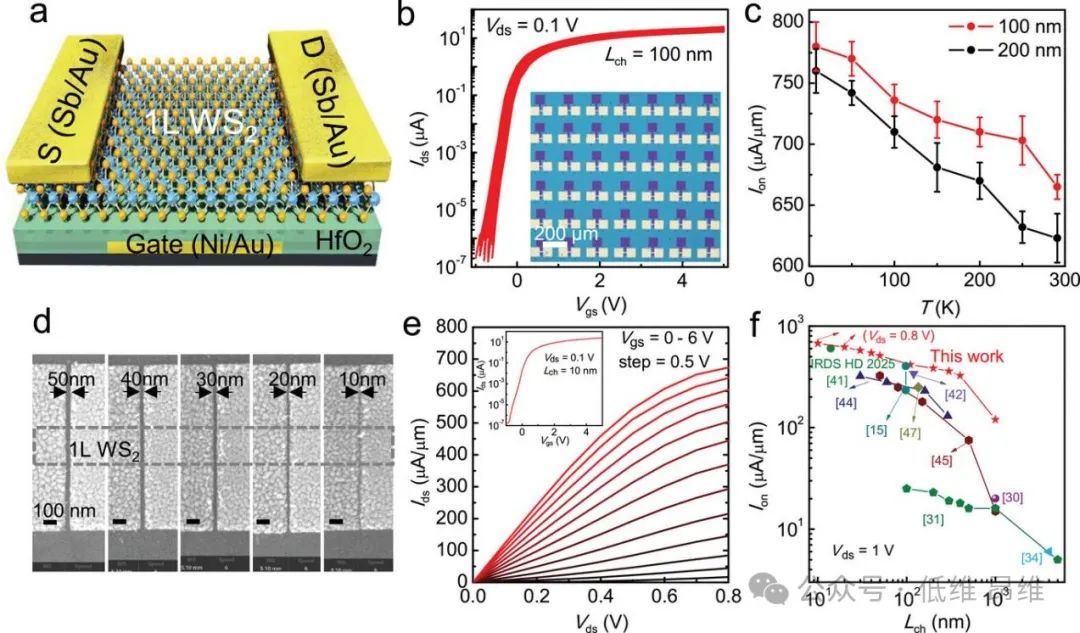
图4. 短沟道单层WS₂ FET的电学性能。a) 埋栅WS₂ FET的示意图。b) 沟道长度为100 nm的FET转移曲线,在Vds = 0.1 V下测量。插图为器件阵列的放大图像。c) 随温度变化的开启态电流。d) 短沟道FET的SEM图像,实际沟道长度Lch范围为10至50 nm。e) 沟道长度10 nm的短沟道WS₂ FET的输出特性。插图显示相应的转移曲线。f) 单层WS₂ FET在Vds = 1 V下的Ion基准对比。
文献信息
Highly Oriented WS
2
Monolayers for High-Performance Electronics
(
Adv. Mater.
, 202
4
, DOI:
10.1002/adma.202414100
)
文献链接:https://onlinelibrary.wiley.com/doi/full/10.1002/adma.202414100
上





