
三菱电机开发了首款6.5kV全SiC(Silicon Carbide)功率模块,采用高绝缘耐压HV100标准封装(100mmÍ140mm)。通过电磁仿真和电路仿真,优化了HV100封装的内部设计,并通过实际试验验证了稳定的电气特性。6.5kV HV100全SiC功率模块为了提高功率密度,将SiC SBD(Schottky Barrier Diode)与SiC MOSFET芯片集成在一起。在续流时,集成的SiC SBD会导通,而SiC MOSFET的寄生体二极管不会导通,所以避免了双极性退化效应发生。本文对比了Si IGBT功率模块(Si IGBT芯片和Si二极管芯片)、传统全SiC MOSFET功率模块(SiC MOSFET芯片,无外置SBD)和新型全SiC MOSFET功率模块(SiC MOSFET和SiC SBD集成在同一个芯片上),结果表明新型全SiC MOSFET功率模块在高温、高频工况下优势明显。
SiC
材料具有优异的物理性能,由此研发的
SiC
功率模块可以增强变流器的性能
[1-2]
。相对
Si
芯片,全
SiC
芯片可以用更小的体积实现更高耐压、更低损耗,给牵引变流系统和电力传输系统的研发设计带来更多便利。
3.3kV
全
SiC
功率模块已经在牵引变流器中得到应用,有着显著的节能、减小变流器体积和重量等作用
[3-4]
。
6.5kV Si IGBT
模块已经用于高铁和电力传输系统,这些市场期待
6.5kV SiC
功率模块能带来更多好处。基于此,三菱电机开发了
6.5kV
全
SiC MOSFET
功率模块
[5-7]
,其采用
HV100
标准封装
[8]
,如图
1
所示。这个封装为方便并联应用而设计,电气稳定性显得尤为重要。

本文介绍了
6.5kV
新型全
SiC MOSFET
功率模块的内部结构和电气特性,相对于传统的
Si IGBT
模块、传统全
SiC MOSFET
功率模块,新型全
SiC MOSFET
功率模块在静态特性、动态特性和损耗方面优势明显。
2、6.5kV新型SiC MOSFET功率模块特性
2.1 集成SiC SBD的SiC-MOSFET芯片特性
HV100
封装
6.5kV
新型全
SiC MOSFET
功率模块采用
SiC MOSFET
和
SiC SBD
一体化芯片技术,最高工作结温可达
175
℃。
模块设计中的一个重要难点是避免
SiC MOSFET
的寄生体二极管(
PIN
二极管)导通,一旦
PIN
二极管中有少子(空穴)电流流向二极管的阴极(
SiC MOSFET
的漏极),因为
SiC
芯片外延层特性,双极性退化效应发生的可能性就会增加。在续流状态下,
SiC SBD
的正向饱和压降在全电流范围内比
SiC MOSFET
的寄生体二极管要低。独立放置的
SiC MOSFET
和
SiC SBD
芯片如图
2
(
a
)所示,
SiC SBD
的面积是
SiC MOSFET
芯片面积的
3
倍;如果将
SiC SBD
集成在
SiC MOSFET
芯片上面,如图
2
(
b
)所示,总面积是单个
SiC MOSFET
芯片面积的
1.05
倍。集成在
SiC MOSFET
芯片上面的
SiC SBD
采用垂直元胞结构,在续流时承载全部反向电流,同时使
SiC MOSFET
芯片的寄生体二极管不流过电流,从而消除双极性退化效应。如图
2
所示,由于芯片面积减小,模块整体体积就可以减小。相对于传统的
Si IGBT
模块和传统全
SiC MOSFET
功率模块,采用相同
HV100
封装的新型全
SiC MOSFET
功率模块可以实现业界最高的功率密度。

2.2 新型SiC MOSFET功率模块的优化设计
6.5kV
新型全
SiC MOSFET
功率模块内部采用半桥拓扑,一般的大功率应用可以采用并联连接来提高输出功率。高电压功率模块在高频下运行,需要考虑模块自身的寄生电容、寄生电感和寄生阻抗等。
3D
电磁仿真是验证内部封装结构和芯片布局的一种有效方法。电磁干扰可能带来三种不良的影响:一是开关过程中的电流反馈;二是上、下桥臂开关特性不一致;三是栅极电压振荡。电磁干扰会增加模块内部功率芯片布置、绑定线连接及其他电气结构设计的复杂性。
我们构建了
6.5kV
新型全
SiC MOSFET
功率模块的内部等效电路和芯片模型,通过
3D
电磁仿真和电路仿真,验证了功率模块设计的合理性。
如果在模块封装设计时没有考虑电磁干扰,在实际工况中,就会产生开关过程中的电流反馈,使芯片的固有开关速度发生变化,进而可能造成上桥臂和下桥臂的开关速度不一致。负的电流反馈可以降低芯片的开关速度,导致芯片的开关损耗增加,因此开关速度的不平衡可以导致模块内部各个芯片的热分布不一致。图
3
显示了
6.5kV
新型全
SiC MOSFET
功率模块在有电磁干扰和无电磁干扰下的仿真开通波形,从图中可以看出,通过优化内部电气设计,电磁干扰对
6.5kV
新型全
SiC MOSFET
功率模块没有影响。图
4
为
6.5kV
新型全
SiC MOSFET
功率模块上桥臂和下桥臂的仿真开通波形,两者的波形几乎完全一样,在实际测试时也验证了这一点。

在高电流密度功率模块中,内部有很多功率芯片并联,寄生电容和寄生电感可能组成复杂的谐振电路,从而可能造成栅极电压振荡。栅极电压振荡幅度过大,可能损坏栅极。通常可以增大芯片内部的门极电阻来达到抑制振荡的目的,但是增大内部门极电阻会造成开关损耗增加,在设计模块时,我们希望内部栅极电阻尽可能小。借助仿真手段,在保持小的栅极电阻的情况下,我们通过优化内部电气布局很好地抑制了栅极电压振荡。

图
5
为
6.5kV
新型全
SiC MOSFET
功率模块在优化内部设计之前和优化之后的栅极电压仿真波形。优化之前,有一个比较大的振荡,振幅可达
13V
。优化之后,栅极电压振荡得到抑制,幅度只有
2V
,在实际测试中也验证了这一点。
图
6
为
400A IGBT
模块(从额定电流
1000A IGBT
转换而来)、
400A
传统全
SiC MOSFET
功率模块(不含
SiC SBD
)和
400A
新型全
SiCMOSFET
功率模块通态压降对比。在
150
℃时,
SiIGBT
的通态电阻比较低,这是因为
Si IGBT
是双极性器件,而
SiC MOSFET
属于单极性器件。
400A
传统全
SiC MOSFET
功率模块(不含
SiC SBD
)和
400A
新型全
SiCMOSFET
功率模块芯片面积几乎相同,所以在全温度范围内其通态电阻也几乎相同。二极管正向压降对比如图
7
和图
8
所示。图
7
是各模块件在非同步整流状态(
MOSFET
不导通)下二极管电流特性的对比,图
8
为各模块在同步整流状态(
MOSFET
导通)下二极管电流特性的对比。从图中可以看出,在非同步整流状态下,传统
SiC-MOSFET
功率模块的表现呈非线性特性;而新型全
SiC MOSFET
功率模块,无论在同步整流还是非同步整流时,都呈线性特征。由上,无论在
MOSFET
导通状态,还是在二极管导通状态,全
SiC MOSFET
功率模块都表现出单极性器件的特性。
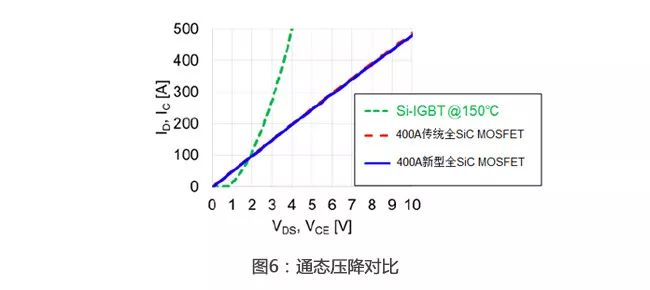
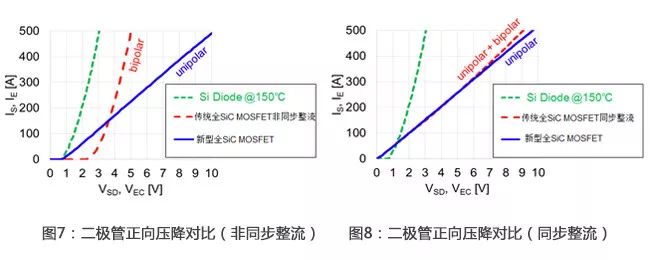
图
9
为新型全
SiC MOSFET
功率模块在
3600V/400A
在室温和高温下(
175
℃)的开通波形对比,从图中可以看出,经过内部结构优化的新型全
SiC MOSFET
功率模块上桥臂和下桥臂在室温和高温下的开关速度几乎完全一样,所以其室温和高温下的损耗也几乎一样。一般来说,随着温度的增加(载流子寿命增加),反向恢复电流也会随之增加,但是如图
9
所示,高温下的反向恢复电荷(
Q
rr
)相对常温增加很少。与静态特性一样,新型全
SiC MOSFET
功率模块在动态特性上表现出单极性器件的特性。
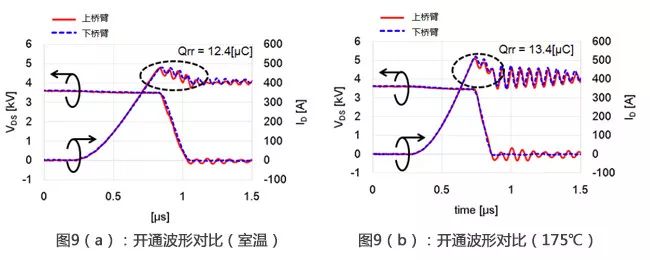
图
10
为传统全
SiC MOSFET
功率模块和新型全
SiC MOSFET
功率模块的开通波形在室温和
175
℃下对比,从图中可以看出在室温下,两者波形很接近,但是在
175
℃下,传统全
SiCMOSFET
功率模块反向恢复电流更大,
V
DS
下降速度更慢。而新型全
SiC MOSFET
功率模块因为反向恢复电流小,所以其
V
DS
下降速度更快。同时这些特性表明两者的开通损耗和反向恢复损耗在室温下非常接近,但是在高温下,新型全
SiC MOSFET
功率模块的开通损耗和反向恢复损耗相对更小,主要原因是反向恢复时,新型全
SiCMOSFET
功率模块的寄生体二极管不导通。

在
175
℃时,传统全
SiC MOSFET
功率模块在开通时会有一个比较大的振荡,而振荡可能造成电磁干扰,进而影响模块的安全工作。实际应用中,希望这个振荡越小越好,为了抑制振荡,可以减缓模块开关速度或者增加外部吸收电路。但是对于新型全
SiC MOSFET
功率模块,在高温下振荡非常小,无需采取额外措施来抑制振荡。
在高压全
SiC MOSFET
功率模块中,造成以上差异的主要原因是传统全
SiC MOSFET
功率模块有一层厚的外延层,在反向恢复时会产生比较大的反向恢复电流。
图
11
为
Si IGBT
模块、传统全
SiC MOSFET
功率模块和新型全
SiC MOSFET
功率模块的开关损耗对比(
Si IGBT
模块与全
SiCMOSFET
功率模块分别设置在最佳开关速度)。从图中可以看出,全
SiC MOSFET
功率模块损耗明显小于
Si IGBT
模块。并且,在
175
℃时,新型全
SiC MOSFET
功率模块比传统全
SiC MOSFET
功率模块开通损耗低
18%
,反向恢复损耗低
80%
。
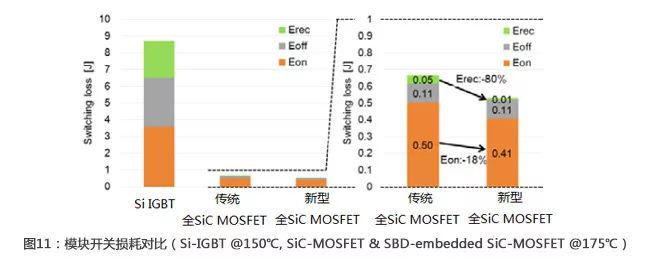
在开关频率
f
s
=0.5kHz
、
2kHz
和
10kHz
,
PF=0.8
,调制比
M=1
,母线电压
V
CC
=3600V
,输出电流
I
O
=200A
的工况下,对比了采用
Si IGBT
模块(
150
℃)、传统全
SiC MOSFET
功率模块(
175
℃)和新型全
SiC MOSFET












