
随着摩尔定律发展趋缓,先进封装越来越成为延续和拓展摩尔定律的重要手段;同时,在集成电路应用的多元化发展趋势下,满足系统微型化、多功能化的先进封装技术成为产业发展的新的引擎。在人工智能、自动驾驶、
5G
网络、物联网等新兴产业的加持下,三维(
3D
)集成先进封装的需求越来越强烈,技术发展迅猛。
先进封装发展背景
封装技术伴随集成电路发明应运而生,主要功能是完成电源分配、信号分配、散热和保护。伴随着芯片技术的发展,封装技术不断革新。封装互连密度不断提高,封装厚度不断减小,三维封装、系统封装手段不断演进。随着集成电路应用多元化,智能手机、物联网、汽车电子、高性能计算、
5G
、人工智能等新兴领域对先进封装提出更高要求,封装技术发展迅速,创新技术不断出现。
60
年来,由于集成电路技术按照摩尔定律飞速发展,封装技术跟随发展。进入
2010
年后,高性能芯片需要高性能封装技术。中道封装技术崭露头角,例如晶圆级封装(
WLP
,
Wafer Level Package
)、硅通孔技术(
TSV
,
Through Silicon Via
)、
2.5D Interposer
、
3DIC
、
Fan-Out
等技术的产业化,极大地提升了先进封装技术水平。
当前,随着摩尔定律趋缓,封装技术重要性凸显,成为电子产品小型化、多功能化、降低功耗,提高带宽的重要手段。先进封装向着超高密度、三维堆叠、高带宽、系统集成方向发展。
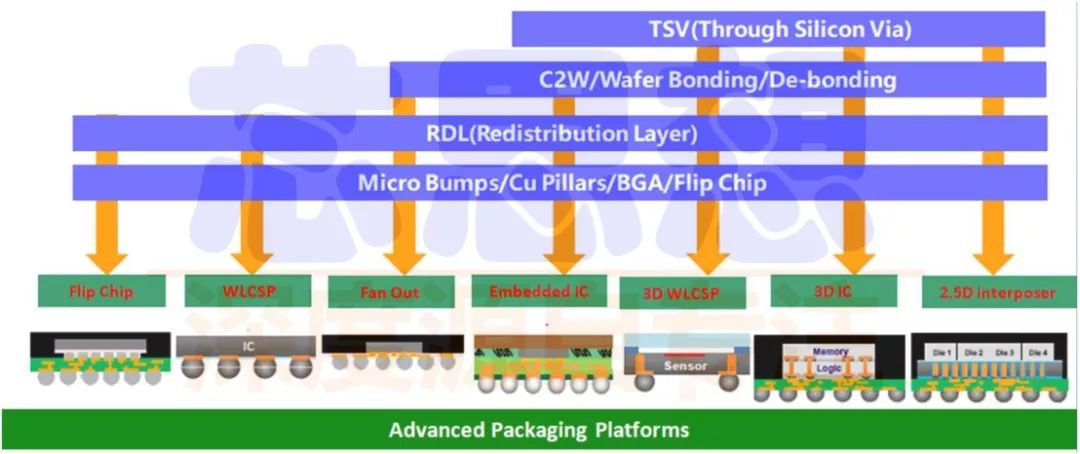
先进封装技术平台与工艺
上图(先进封装技术平台与工艺)
展示了当前主流的先进封装技术平台,包括
Flip-Chip
、
WLCSP
、
Fan-Out
、
Embedded IC
、
3D WLCSP
、
3D IC
、
2.5D interposer
等七个重要技术。其中绝大部分和晶圆级封装技术相关。支撑这些平台技术的主要工艺包括微凸点、再布线、植球、
C2W
、
W2W
、拆键合、
TSV
工艺等。先进封装技术本身不断创新发展,以应对更加复杂的三维集成需求。当前,高密度
TSV
技术
/Fan-Out
扇出技术由于其灵活、高密度、适于系统集成,而成为目前先进封装的核心技术。
封装技术的发展得益于互连技术的演进和加工精度的显著提高。目前三种主要用于集成电路(
IC
)芯片封装的互连技术分别为:引线键合技术(
Wire Bond
,
WB
)、倒装芯片技术(
Flip Chip
,
FC
)和硅通孔技术(
Through Silicon Via
,
TSV
)。由于现代微电子晶圆级加工能力的大幅度提升,晶圆级封装的布线能力已达到微米量级。从线宽互连能力上看,过去
50
年,封装技术从
1000µm
提高到
1µm
,甚至亚微米,提高了
1000
倍。微凸点互连节距也从几百微米,发展到当前
3D IC
的
40µm
节距,很快将发展到
5µm
以下节距无凸点互连。
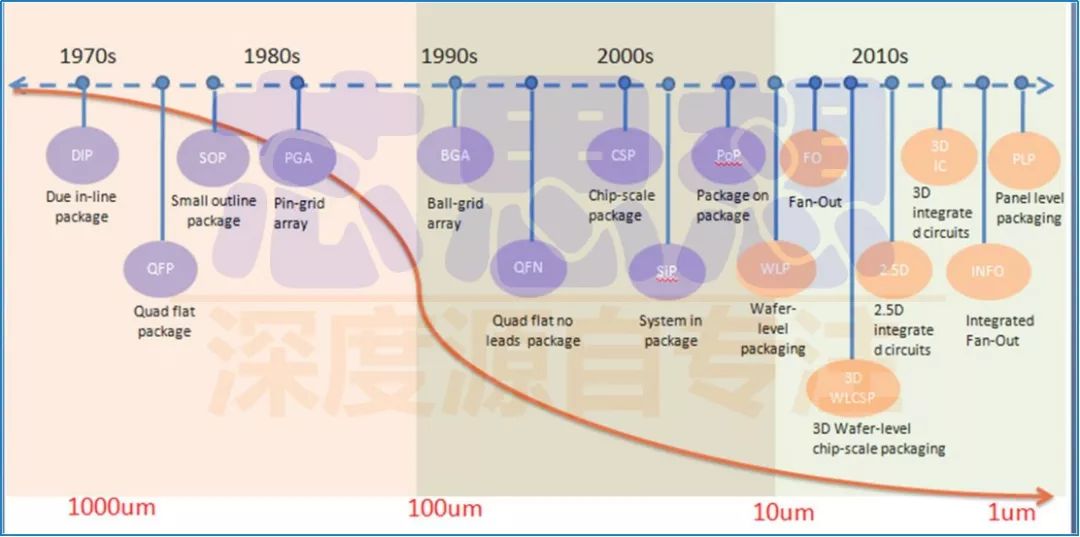
主要封装技术发展

三维封装技术发展
一、
2.5D
封装技术
1
、台积电
CoWoS
为解决有机基板布线密度不足的问题,带有
TSV
垂直互连通孔和高密度金属布线的硅基板应运而生。连接硅晶圆两面并与硅基体和其他通孔绝缘的电互连结构,采用
TSV
集成,可以提高系统集成密度,方便实现系统级的异质集成。
带有
TSV
的硅基无源平台被称作
TSV
转接板(
Interposer
),应用
TSV
转接板的封装结构称为
2.5D Interposer
。在
2.5D Interposer
封装中,若干个芯片并排排列在
Interposer
上,通过
Interposer
上的
TSV
结构、再分布层(
Redistribution Layer
,
RDL
)、微凸点(
Bump
)等,实现芯片与芯片、芯片与封装基板间更高密度的互连。其特征是正面有多层细节距再布线层,细节距微凸点,主流
TSV
深宽比达到
10:1
,厚度约为
100µm
。
台积电
2008
年底成立集成互连与封装技术整合部门,
2009
年开始战略布局三维集成电路(
3D IC
)系统整合平台。
2010
年开始
2.5D Interposer
的研发,
2011
年推出
2.5D Interposer
技术
CoWoS
(
Chip on Wafer on Substrate
)。第一代
CoWoS
采用
65
纳米工艺,线宽可以达到
0.25µm
,实现
4
层布线,为
FPGA
、
GPU
等高性能产品的集成提供解决方案。
第一个采用
CoWoS
封装的产品是
2012
年赛灵思(
Xilinx
)推出“
Virtex-7 2000T FPGA
”的
FPGA















