
大家好!今天来了解一项金属氧化物增材制造研究——《Ultra-high precision nano additive manufacturing of metal oxide semiconductors via multi-photon lithography》发表于《nature communications》。在现代电子信息领域,金属氧化物半导体至关重要。但传统制造工艺繁琐且成本高。利用多光子光刻技术,通过特殊的固态前驱体光刻胶,成功实现了金属氧化物半导体的超高精度纳米增材制造。这项研究成果有望解决诸多难题,为芯片和微器件制造带来新的曙光,让我们一起深入了解这一创新技术的魅力与潜力。
*
本文只做阅读笔记分享
*
一、研究背景
在现代电子信息产业中,金属氧化物作为多功能半导体器件的基本组成部分发挥着关键作用。然而,传统的金属氧化物超高精度纳米图案化通常涉及多步光刻和转移过程,这不仅耗时而且成本高昂。
随着半导体芯片遵循摩尔定律不断发展,光刻技术也需要与时俱进。当前,先进的深紫外(DUV)和极紫外(EUV)光刻技术虽能实现纳米结构的高通量制造,但昂贵的掩模和重复的曝光转移过程不可避免,这对初步的科学探索形成了阻碍。多光子光刻(MPL)作为一种替代策略,具有无需掩模、能制造任意2D/3D纳米结构、成本较低且原子经济性高等优点,尤其适用于高精度、小批量制造。不过,MPL仍面临诸多挑战,其中临界尺寸(CD)不理想和光刻胶库稀缺是两个关键问题。大多数用于MPL的光刻胶为液态有机聚合物,其CD极限通常在80-100nm,难以承受苛刻的图案转移过程,这对芯片和器件应用而言可能是致命的缺陷。
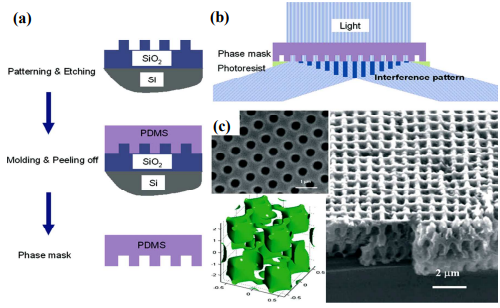
为解决这些问题,一些科研先驱尝试开发前驱体光刻胶,通过MPL直接实现目标半导体和其他功能材料的纳米增材制造,从而完全消除复杂的转移过程。在众多材料中,金属-氧化物半导体(MOS)因其在下一代微电子器件(如晶体管、忆阻器、光电子器件和传感器)中的广泛应用而备受关注。前驱体光刻胶对通过光刻技术实现MOS的增材制造至关重要,目前主要有金属氧化物前驱体、金属离子前驱体和金属有机化合物(MOCs)三类。金属氧化物前驱体中纳米颗粒与活性树脂混合存在诸多问题;金属离子前驱体虽解决了部分问题,但也带来了新的弊端,如金属离子含量低、易导致聚合问题等;MOCs虽有优势,但现有MOS前驱体光刻胶多为液态,难以实现超高分辨率MOS图案。由于自由基迁移速度对CD有影响,且当前成熟光刻技术中的光刻胶多为固态薄膜,因此固态前驱体光刻胶可能更有利于形成高分辨率MOS图案。
二、研究成果
(一)使用固态前驱体光刻胶图案化金属氧化物
1、制备原理与过程
固态前驱体光刻胶由丙烯酸金属配合物、引发剂(DETC)和自由基捕获剂(BTPOS)组成。制备时,将它们溶解在溶剂中,然后旋涂在基底上,形成约30nm厚的光刻胶膜。在MPL过程中,曝光区域的DETC通过多光子吸收产生大量自由基,引发前驱体光刻胶中碳-碳双键的聚合,使曝光区域与未曝光区域的溶解度产生显著差异,经显影后得到目标图案。

2、实验结果
分别使用Zn、Cu、Zr基的丙烯酸金属配合物,经MPL、显影和烧结后,成功制备出ZnO、CuO、ZrO₂的二维微图案。从图中可以看出,制备的汉字图案清晰可辨、致密且无孔隙,烧结过程未导致线阵列发生明显变形或扭曲,表明该策略具有通用性,有望实现高精度MOS制造。

通过EDS、TEM和XRD对微图案的组成进行表征。例如,烧结前Zn基前驱体光刻胶生成的微图案主要含Zn、O、C元素,烧结后C元素难以识别,EDS谱显示烧结后Zn和O的原子比为1.00,与ZnO晶体的原子比一致。TEM选区电子衍射(SAED)图案和高分辨率透射电子显微镜(HRTEM)图像表明烧结后的主要成分是ZnO,XRD谱与标准多晶ZnO卡片(JCPDSNo.36-1451)一致,证明最终微图案由ZnO组成。同样,Cu或Zr基前驱体光刻胶制备的CuO和ZrO₂微图案也通过EDS和XRD得到确认。

(二)金属氧化物的超高精度纳米制造
1、提高精度的方法
为提高制造精度,除使用固态前驱体光刻胶减少自由基迁移外,还引入自由基捕获剂BTPOS,将自由基限制在很小的空间内,从而实现超高精度增材制造。

2、实验结果与分析
在固定扫描速度为1000μms⁻¹时,CuO、ZrO₂和ZnO的线宽随激光功率降低而逐渐变小。CuO线宽可达36nm,52nm时表面形貌更好;ZrO₂的CD只能达到58nm,72nm时能获得高质量线条;ZnO线宽在54nm甚至35nm时都能实现高质量线阵列。
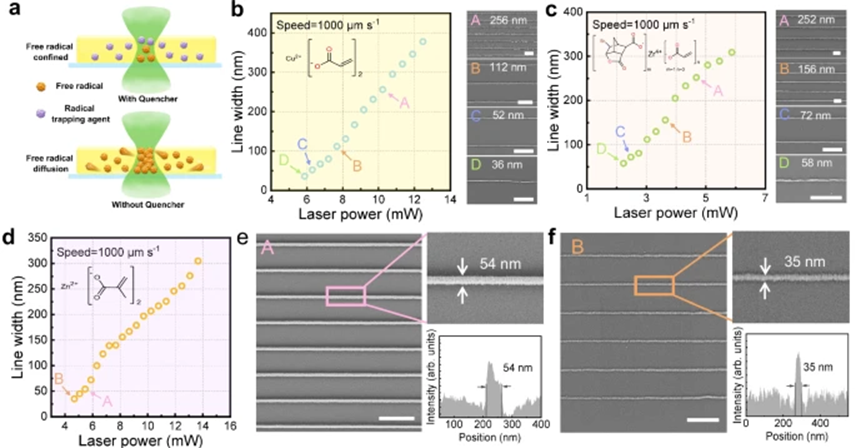
CD取决于光刻胶的非线性吸收指数(N)等因素。根据相关理论,计算出Zn基前驱体光刻胶的N最高(3.76),Cu基次之(3.52),Zr基最低(2.76),这与它们的CD顺序(ZnO(35nm)

与其他增材制造技术相比,本研究通过固态前驱体光刻胶与自由基捕获剂的结合,超越了光学衍射极限,达到了35nm的惊人CD,为MOS增材制造设定了新的基准。

(三)原子掺杂和异质金属氧化物
1、原子掺杂
以ZnO为例探索原子掺杂的可能性,将丙烯酸铝混入光刻胶,制备Al掺杂的ZnO图案。
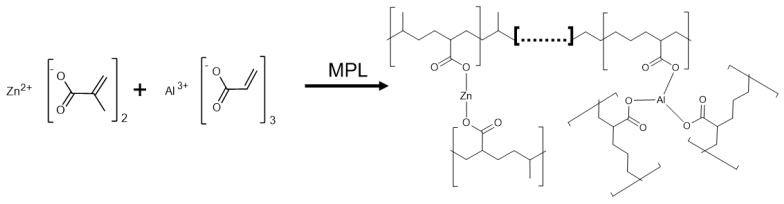
EDS映射结果显示烧结图案主要含Zn和O元素,Al元素因掺杂量低难以识别。
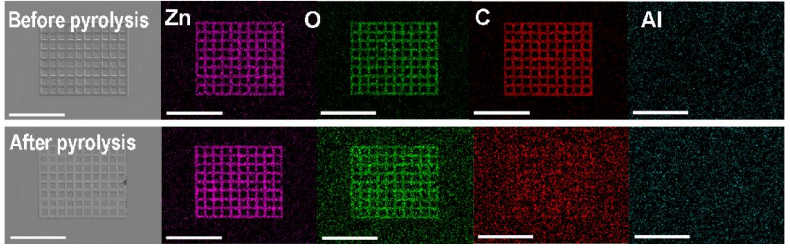
EDS谱表明Al与Zn的原子比为0.028,HRTEM图像和XRD结果证实Al成功掺杂到ZnO晶体中,且使晶格常数减小,表明通过类似策略可实现其他掺杂。

2、异质结构制造
设计了由ZnO(黄色部分)、CuO(蓝色部分)和ZrO₂(绿色部分)组成的二维码图案,经多次涂覆-曝光-显影和烧结成功制备。由于三种MOS的折射率不同,在光学显微镜下呈现不同亮度。EDS谱和元素映射证实了其组成,选择性元素成像可得到彩色二维码。此外,还成功制备了三层多MOS结构,表明该策略可实现异质MOS的逐层制造,满足半导体器件的各种需求,且固态前驱体光刻胶适用于大规模增材制造(LS-AM)。

(四)光电探测器的制备与性能提升
1、制备过程
基于纯ZnO和Al掺杂ZnO通过该策略制备紫外光电探测器。首先将Zn基前驱体光刻胶旋涂在表面氧化的硅片上,用MPL曝光后显影、烧结得到矩形ZnO样品,再通过MPL和剥离工艺制备ITO电极,得到光电探测器单元。
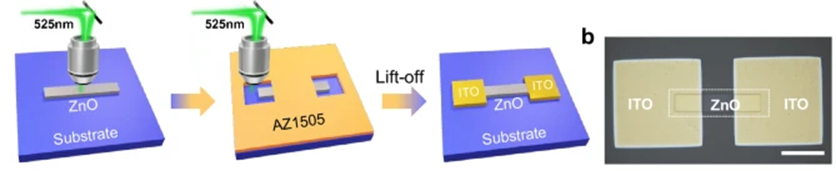
2、性能测试与结果分析
在365nm光照下(0.8mWcm⁻²),ZnO紫外光电探测器的衰减时间为62s,光暗电流比(PDCR)在3.0V外部偏压下高达10,500;Al掺杂的ZnO紫外光电探测器衰减时间缩短至24s,PDCR显著增加至16,000,证明了Al掺杂的有效性。















