
文章链接:https://pubs.acs.org/doi/10.1021/acsnano.4c04316
摘要
在这项工作中,我们报道了一种使用化学气相沉积(CVD)生长的单层WS2场效应晶体管(FET)制成的n型金属氧化物半导体(nMOS)反相器。我们的CVD生长的大面积单层WS2 FET展示了卓越的电学性能,包括高开关比、小亚阈值摆幅和优异的漏致势垒降低特性。这些特性通过使用AlOx/Al2O3进行的n型掺杂以及采用高介电常数HfO2的双栅结构得以实现。由于优越的亚阈值特性,单层WS2 FET在亚阈值模式下表现出高跨导和高输出电阻,从而相比传统硅MOSFET显著提高了内在增益。因此,我们成功实现了在亚阈值操作下的单层WS2 nMOS反相器,在1 V和2 V电源电压(VDD)下分别实现了564和2056的极高增益,并在VDD = 1 V时实现了约2.3 pW·μm–1的低功耗。此外,单层WS2 nMOS反相器进一步扩展应用于逻辑电路的演示,如AND、OR、NAND、NOR逻辑门和SRAM。这些发现表明单层WS2在高增益低功耗逻辑电路中的潜力,并验证了其在大面积实际应用中的可行性。
研究背景和主要内容
过去几年,大量研究致力于将二维(2D)过渡金属二硫属化物(TMD)用作金属氧化物半导体场效应晶体管(MOSFET)的沟道材料。由于原子级厚度的 2D TMD 可以有效抑制短沟道效应,因此 2D TMD 具有在超大规模 MOSFET 中取代 Si 的巨大潜力。在 2D TMD 系列中,二硫化钼(MoS2)和二硫化钨(WS2)已被研究用于高性能 n 沟道 MOSFET(nMOSFET),而单层二硒化钨(WSe2)已显示出作为 p 沟道 MOSFET(pMOSFET)的潜力。随着生长技术的进步,O'Brien 等人和 Sebastian 等人已经展示了晶圆级 MoS2和 WS2 nMOSFET,表现出优异的器件性能。此外,Hung 等人还提出了采用晶圆级生长的 WSe2的 pMOSFET ,并通过 WOx间隔掺杂处理以提高性能。晶圆级生长的 2D TMD n/pMOSFET 的这些进步可以实现高性能互补金属氧化物半导体 (CMOS) 器件和系统,并增强可扩展性和可制造性。
2D TMD 在低功耗应用方面也得到了广泛探索。在当今的移动时代,对电子设备低功耗的需求日益增长。由于原子级厚度特性对短沟道效应具有极强的免疫力,以及相当大的带隙带来极低的关断电流,2D TMD 可以为低压和低功耗电路提供极好的平台。从低功耗角度来看,工作在接近关断状态的深亚阈值区域的晶体管可用于实现在低电源电压 ( V DD ) 下工作的逻辑电路。最近,Tang 等人的研究提出了具有优异亚阈值特性的单层 MoS2 nMOSFET,并展示了在V DD
= 1 和 2 V时峰值增益分别为 397 和 1000 的 nMOS 反相器,在V DD = 1 V时功耗仅为 10.3 pW·μm –1 。除了 2D TMD 之外,人们还在探索其他沟道材料,以实现高增益和低功耗 nMOS 反相器。Lee 等人和 Pradhan 等人采用基于氧化铟镓锌 (IGZO) 的深亚阈值工作薄膜晶体管,在V DD = 2 V 时分别实现了超过 220 和 285 的高增益。Li 等人还介绍了一种基于氧化铟锡 (ITO) 的 nMOS 反相器,在V DD = 0.5 V时其增益为 178。成功展示了在深亚阈值范围内工作的肖特基势垒有机薄膜晶体管,在V DD = 2 V时实现了 260 的电压增益。
在本文中,我们介绍了一种基于化学气相沉积 (CVD) 生长的单层 WS2 FET的高增益低功耗 nMOS 反相器,该 FET在亚阈值范围内工作。为了改善单层 WS2 FET 的亚阈值和超阈值特性,我们采用了 AlOx/Al2O3 n 型掺杂,该掺杂针对各种厚度的 AlOx和 Al2O3进行了优化。此外,还采用了双栅极 (DG) 结构来进一步提高性能。我们的单层 WS2 FET 表现出陡峭的亚阈值摆幅 ( SS )、较小的漏极诱导势垒降低 (DIBL) 和高开/关比,阈值电压 ( V TH ) 几乎为零。因此,我们在亚阈值工作单层 WS2 nMOS 反相器中实现了V DD = 1 和 2 V时极高的增益 564 和 2056,以及V DD = 1 V时约 2.3 pW·μm –1的低功耗。
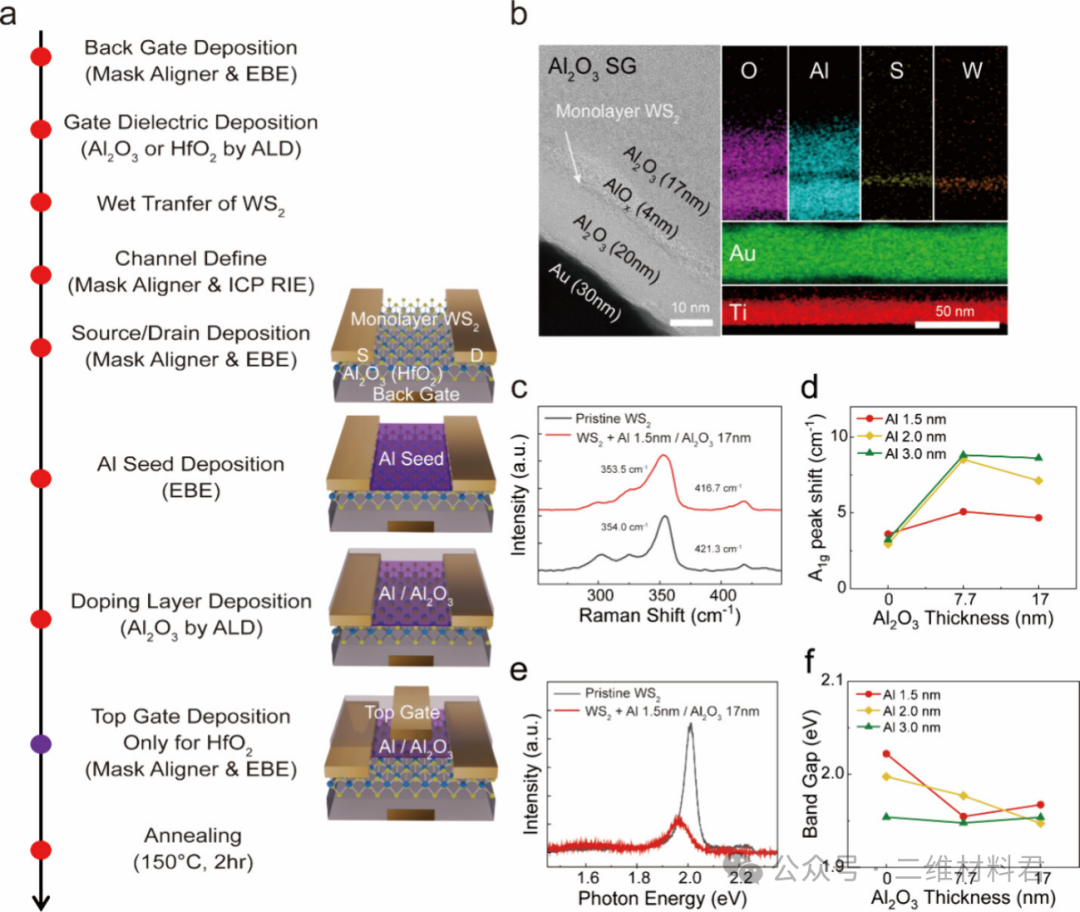
图 1. 掺杂AlOX/Al2O3的 WS2 FET 的器件结构、制造工艺和材料特性。 (a) 单层 WS2 FET 的器件结构示意图和制造工艺:带有 Al2O
3背栅电介质的原始 SG WS2 FET、通过 EBE 沉积 Al 种子层后的 SG WS2 FET、通过ALD 沉积Al 种子层和 Al2O3后的 SG WS2 FET以及带有 HfO2背栅电介质和 AlOx/Al2O3顶栅电介质的 DG WS2 FET。 (b)具有 1.5 nm Al 种子层和 17 nm Al2O3的 SG WS2 FET横截面的 TEM 和 EDS 图像。 (c) 原始单层 WS2和具有 1.5 nm Al 种子层和 17 nm Al2O3的单层WS 2的拉曼光谱分析。(d) 具有 1.5、2 和 3 nm Al 种子层的单层WS2的拉曼峰位移。(e) 原始单层 WS2和具有 1.5 nm Al 种子层和 17 nm Al2O3的单层 WS2的 PL 光谱。(f)具有 1.5、2 和 3 nm Al 种子层的单层 WS2的带隙。

图 2.具有不同 AlOX/Al2O3掺杂条件的单层 WS2 FET的电学特性。 (a) 具有不同 Al2O3厚度的Al2O3 SG 器件在V GS = V TH
+ 5 V 时的ION、log( ION/IOFF )、SS和V TH的统计分布。除原始 WS2器件外,Al 种子层厚度固定为 1.5 nm。沟道长度 ( LC ) 为 2、4、6、8、10、12、14、16、18 和 20 μm 的Al2O3 SG 器件均一起显示。通道宽度 ( L W ):100 μm。如图S12所示,log( ION/IOFF ) 和SS对沟道长度没有明显的依赖关系。 (b)具有不同 Al 种子层厚度的Al2O3 SG 器件在V GS = V TH + 5 V时的I ON 、log( ION/IOFF )、SS和VTH的统计分布。除原始 WS2器件外, Al2O3厚度固定为 17 nm。LC为 2、4、6、8、10、12、14、16、18 和 20 μm 的 Al 2 O 3 SG 器件全部一起显示。L
W为100 μm 。 ( c) HfO2 DG 器件(紫色)、具有最佳掺杂(Al 1.5 nm/Al2O3 17 nm)的 Al2O3 SG器件(红色)和未掺杂的 Al2O3 SG器件(黑色)的转移特性(IDS – VGS)。 log(ION/IOFF ) 和SS的统计分布。Al2O3 SG 器件的LC为 2、4、6、8、10、12、14、16、18 和 20 μm,LW为 100 μm。HfO2 DG 器件的LC为4、5、6、7 和 8 μm,L W为 25、50 和 100 μm。(d)在不同V DS = 0.5、1.0、1.5 和 2.0 V下进行最佳掺杂的代表性 HfO2 DG 和 Al2O3 SG 器件的IDS – VGS 。两个器件的LC均为 6 μm,L
W均为 100 μm。

图 3. 温度相关测量。(a)原始 WS2器件中不同VGS的阿伦尼乌斯图。(b)具有最佳掺杂的Al2O3 SG 器件中不同VGS的阿伦尼乌斯图。(c)原始 WS2器件中有效势垒 (Φ Eff ) 与V GS的关系。(d)具有最佳掺杂的Al2O3 SG 器件中 Φ Eff与V GS的关系。(e) 示意图,说明原始 WS2 (上) 和 Al2O3 SG (下) 器件在平带电压 ( V FB )下单层 WS2上 Ti 接触的肖特基结。 (f) VGS = VON + 3 V时原始 WS2和 Al2O3 SG 器件的归一化迁移率。 (g) VGS = VON + 6 V时原始 WS2 和 Al2O3 SG 器件的归一化迁移率。 (h)原始 WS2和 Al2O3 SG 器件的活化能 ( Ea ) 与VGS – VON的关系。 (i) 原始 WS2和 Al2O3 SG 器件的界面陷阱密度 ( Dit ) 。 两种器件的沟道长度均为 2 μm,沟道宽度均为 100 μm。

图 4.具有 AlOX /Al2O3掺杂的 Al2O3 SG 器件的接触电阻。 (a) 总电阻 ( RTotal ) 与 2D 沟道 ( n 2D )中载流子密度的关系。 (b) 具有最佳掺杂的Al2O3 SG 器件的接触电阻 ( RC )与栅极过驱动电压 ( V GS –













