
文章链接:https://www.nature.com/articles/s41563-024-01989-8
摘要
二维过渡金属二硫属化物具有原子级薄的几何形状和无悬键的表面,引起了各种技术应用的强烈兴趣,包括亚纳米级的超小型晶体管。一种简单的剥离和重新堆叠方法已被广泛用于几乎任意组装各种二维 (2D) 异质结构、超晶格和莫尔超晶格,为奇异物理现象的基础研究和概念验证设备演示提供了一个多功能的材料平台。虽然这种方法对最近蓬勃发展的 2D 材料研究做出了重要贡献,但它显然不适合实际技术。要充分发挥 2D 过渡金属二硫属化物的潜力,需要对这些原子级薄的材料及其异质结构进行稳健且可扩展的合成,并对化学成分和电子结构进行可设计的空间调制。原子级薄晶体的极端纵横比、缺乏本征基质和高度脆弱的性质给材料合成带来了根本性的困难。在这里,我们总结了关键挑战,强调了当前的进展,并概述了基于过渡金属二硫属化物异质结构、超晶格和莫尔超晶格的可扩展合成的机会。
研究背景和主要内容
人类文明面临的挑战显著地受到材料创新的影响,并根据每个时期所使用的关键材料将人类文明划分为不同的时代——如石器时代、青铜时代和铁器时代。20 世纪 60 年代硅基集成电路的发明标志着硅时代的开始。在过去的半个世纪里,我们目睹了硅基集成电路的巨大进步(和利润),它为信息技术革命和人工智能的快速发展奠定了物质基础。硅基集成电路的进步主要得益于持续的微型化,而制造技术的持续创新和器件架构设计的根本性突破则推动了这一进步。然而,尽管(并且由于)这些非凡的进步,硅基电子器件的进一步缩小面临着越来越大的挑战,这是由于接近原子厚度(例如,亚5纳米或亚3纳米范围)的硅中的电子特性(例如载流子迁移率)的快速退化,这促使人们付出巨大努力来寻找可以满足未来计算能力需求的替代材料 。
在这方面,二维原子晶体(2DAC),特别是层状过渡金属二硫属化物(TMD),引起了人们的浓厚兴趣。这些晶体具有原子级薄的厚度(单层厚度 <1 纳米)和无悬挂键表面,这些独特属性使 2DAC 能够在极端物理尺度上保持优异的电子特性(例如,载流子迁移率),使它们成为超越硅技术范围的终极晶体管微缩的有吸引力的候选者。此外,凭借这些原子级薄的几何形状和广泛变化的化学成分和物理性质(例如,半导体、超导体、金属、外尔半金属、拓扑绝缘体和铁磁体),2D TMD 还提供了一个令人兴奋的材料平台,用于探索原子厚度极限下的奇异物理性质。丰富的 2D TMD 家族还可以实现高度不同的化学成分和电子结构的原子级集成,以创建不同的异质结构。这可以精细地调节势能景观,以控制电荷的产生、分离、传输、关联或复合,并通过设计合理地调整其电子、光学和新兴量子特性。因此,2DAC 是过去十年新兴电子材料领域研究最深入的材料系统。
许多原子级薄的二维 TMD 和异质结构通常通过简单的机械剥离和重新堆叠过程制备而成 。这种方法极大地促进了该领域的快速扩展,导致了许多令人兴奋的奇异物理现象的发现以及具有卓越性能或前所未有功能的新设备的概念验证演示 。然而,尽管取得了这些非凡的进步,剥离薄片和重新堆叠异质结构对于现实世界技术的可扩展性和实用性仍然具有挑战性。虽然剥离二维薄片和重新堆叠异质结构的可获得性极大地加速了该领域的初步进展,但具有讽刺意味的是,它减缓了对二维材料及其异质结构的合理合成的努力,特别是在研究的早期阶段。
与以往对新材料系统(例如半导体及其异质结构、量子点、碳纳米管或半导体纳米线)的研究不同,精细的合成控制是系统研究物理性质和有意义的设备演示的先决条件,而早期对 2D 材料的研究很大程度上绕过/避开了材料开发阶段。尽管在材料生长方面人们的努力越来越多,并且取得了显着进展,但这种独特材料系统的合成控制通常落后于该领域的整体发展,成为进一步发展的限制因素。要充分发挥 2D TMD 的潜力,需要可控合成大单晶及其异质结构和超晶格,并精确控制化学成分和电子结构的空间调制 。这类似于传统半导体异质结构和超晶格中采用的方法,它们定义了所有现代电子和光电子器件的基本材料基础。在这篇评论中,我们旨在讨论 2D TMD、其异质结构和超晶格的合成控制面临的基本挑战、最新进展以及我们的观点。
材料合成的基本挑战
2D 材料的厚度以单个(或几个)原子为单位,横向尺寸延伸到宏观尺度(例如,12 英寸晶圆的 300 毫米),其极端纵横比高达 10 9或更大。这种特殊的纵横比需要高度各向异性的生长,在此期间,横向(平行于 2D 基面)和垂直(垂直于 2D 基面)尺寸的生长速率相差数百万或数十亿倍,这对合成提出了根本性的挑战。化学气相沉积 (CVD) 工艺是实现 2DAC 可扩展生产最引人注目的生长方法之一。该方法受前体材料的蒸气压和温度以及基材特性和温度等因素的协同控制。
由于大多数 2D TMD 缺乏本征衬底,因此生长通常在具有与目标材料不同的化学成分和晶格结构的异质衬底上进行。因此,2D TMD 的成核和生长过程与晶格匹配衬底上的传统垂直外延生长有着根本的不同。通常,2D 晶体的生长是通过气相中的均质成核或在异质衬底上的异质成核来启动的。当化学前体的蒸汽压超过某个阈值时,小的 2D 核可能会开始在气相中形成,随后沉淀在衬底上。或者,核可以直接在所选衬底的表面上形成,其中特定的表面缺陷可以作为首选的成核位置。在这种情况下,精确控制表面缺陷可以促进成核过程的调整。一旦在基底表面形成晶核,生长就可以以给定的横向生长速率(RL)横向进行,从而促进晶核在横向维度上的持续延伸,以产生大面积的2D TMD,也可以以一定的垂直生长速率(RV)垂直进行,从而产生多层材料。
在给定条件(温度、蒸汽压、大气场和基底)下,可能会发生几种竞争过程(图1a):(1)蒸汽相中均匀形成核,最终沉淀在裸露的基底上,形成新的生长中心(RV > 0)或现有 2DAC 的顶部(RV > 0);(2)在裸露的基底上或现有 2DAC 的顶部异质形成新核(RV
> 0);(3)向现有核的生长前沿(边缘)添加原子(RL > 0);(4)现有 2D TMD 边缘的组成原子汽化(负横向生长,RL < 0);(5)2D TMD 基面汽化(负垂直生长,RV < 0)。要生长均匀的 2D TMD 薄膜,需要对过饱和度进行精确控制,以使前体原子继续添加到现有 2D 域的边缘(生长前沿)(R L > 0),但不足以使新的 2DAC 核( R V = 0) 均质或异质成核 。在这方面,存在一个内在的权衡:过饱和度过低可能导致横向生长非常低,而过饱和度过高可能导致新的 2D 域成核,并且厚度均匀性控制不佳。
在实际的生长装置中,局部条件的细微变化(例如,温度梯度或蒸汽压梯度)(图1b、c)也可能导致不同位置的过饱和度在空间上发生波动,从而导致一个位置的生长率为正,而另一个位置的生长率为负。这种负增长对于原子级薄的 2D TMD 尤其令人担忧,因为 2D TMD 通常由易发生解吸/蒸发的挥发性硫族元素组成,并且极易受到化学环境中哪怕是最轻微的波动的影响。合成条件的微小变化,例如局部蒸汽压、基底温度或流动动力学,都可能导致不良的空位,从而损害电子特性,或者导致负生长率,从而迅速消耗(蚀刻掉)单层晶体的整个厚度(图1a)。
因此,确保单层TMDs的均匀生长需要通过调节关键的热力学和动力学因素来精确控制垂直或横向的生长速率(图1c)。这对于大面积生长尤其具有挑战性。为了保证大面积的稳定生长,通常需要过度的过饱和以在整个区域提供高效、持续的横向生长,这可能导致新晶体层不可避免的成核和某些位置的垂直生长,从而导致厚度分布不均匀(图1a)。此外,异质结构或超晶格的生长需要改变化学环境或加工条件(因此需要过饱和),这可能导致现有TMD层的负生长速率(横向或垂直蚀刻)(图1a),使异质结构的稳健生长成为一项持续的挑战。根据生长条件,所得到的异质结构也可能受到原子扩散、离子交换和原子置换的影响,导致异质结构界面控制不佳(图1a)。
尽管起步缓慢,但我们看到,最近在实现 2D TMD 合成控制方面的努力出现了巨大的增长。这里,我们将这些努力分为四个密切相关的主题:(1) 大面积单层 TMD 膜和单晶的 CVD 合成;(2) 横向异质结构和超晶格的合成;(3) 垂直异质结构和莫尔超晶格的合成;(4) 垂直超晶格的合成;(5) 位置选择性生长。最后,我们概述了 2D TMD 材料合成控制方面的潜在未来挑战和方向。

图 1:2D TMD 和异质结构的 CVD 合成面临的挑战。a、2DAC 及其异质结构在合成中面临的四个挑战:(i) 平面内和平面外生长之间的竞争(2L,双层;3L,三层);(ii) 生长和蚀刻之间不受控制的竞争;(iii) 随机和不受控制的成核;(iv) 非理想异质界面。b 、用于制备晶圆级 2DAC 的 CVD 系统示意图。c 、影响 2DAC 及其异质结构的成核、生长和异质外延的工艺参数。
大面积单层 TMD 薄膜和单晶的 CVD 合成
过去 5 到 10 年间,人们投入了大量精力来精确控制成核和生长动力学,以实现可扩展的 CVD 合成 TMD,从而定制厚度、单晶尺寸和晶相,系统地调节其电子、化学、量子和其他新兴特性。根据前体材料的不同,合成过程可分为三大类:(1) 过渡金属或金属氧化物薄膜的硫属化,(2) 固源热 CVD 和 (3) 金属有机 CVD (MOCVD) 过程。过渡金属或金属氧化物薄膜的硫属化通常涉及过渡金属(例如 Mo)或过渡金属氧化物(如 MoO3)薄膜的物理气相沉积 (PVD),然后进行高温硫化/硒化反应。受益于完善且可扩展的 PVD 工艺,可以使用这种方法轻松生产晶圆级和图案化的 TMD 薄膜。固体源热 CVD 工艺通常涉及金属前体、硫族元素前体或块状固体 TMD 本身的独立固体源的汽化,产生气相反应物,这些反应物通过载气输送到生长基底,在那里成核并生长成原子级薄的 TMD 晶体。该工艺相对通用,是迄今为止研究最广泛的 2D TMD 生产方法。利用金属有机气相前体,MOCVD 方法通常用于化合物半导体工业以生产半导体薄膜、异质结构和超晶格。为了提高大面积生长的均匀性和可控性,已经探索了多种策略来控制成核密度和缝合过程,包括控制金属或非金属前体的供应(例如,多源设计 、 “面对面” )和设计基底。在这些改进的推动下,在尺寸范围为 2 至 12 英寸的 晶圆级单层 MoS2薄膜的生产方面取得了相当大的进展。
采用 CVD 生长的单层 TMD 薄膜通常具有多晶结构,具有丰富的晶界,这会极大地影响其电子性能的整体质量和均匀性。在实用技术中,在晶圆规模上合成单晶 2D 薄膜对于确保器件间均匀性至关重要。获得大规模单晶 2DAC 有两种可行途径:晶圆规模单籽晶横向生长和取向多籽晶生长与无缝拼接。在熔融玻璃基板上生长了单晶畴尺寸高达 2.5 毫米的大面积 MoSe2,并通过单籽晶诱导相变和再结晶过程实现了 1英寸单晶 2H MoTe2。更大规模的方法涉及在单晶基板上取向生长多个畴,然后将其无缝合并为晶圆级单晶。多畴的单向生长很大程度上依赖于衬底和二维材料的表面对称性及其间的耦合作用。目前已有两种典型的策略被证明可有效实现TMD畴的单向生长:台阶边缘引导外延和表面对称性引导外延。台阶边缘可以降低表面对称性并打破反向平行畴晶粒的能量简并,从而实现TMD畴的单向排列,有利于大面积单晶的形成。例如,具有较大错切角的c面蓝宝石晶片,沿(10 {1}0)方向形成高度为0.4nm的表面台阶,从而实现MoS2畴的单向生长,最终生产出具有晶片级均匀性的2英寸单层MoS2单晶。类似地,在邻位a面蓝宝石表面生长了2 英寸单晶 WS2单层 。最近也有人提出,2D TMD 晶粒与暴露的氧铝原子平面(而不是暴露的台阶边缘)的相互作用是实现蓝宝石衬底上这种单向 MoS2畴生长的更主要因素。
二维横向异质结构和超晶格的合成
TMD-TMD 异质结构具有高度相似的结构和相对较小的晶格失配,可通过横向外延工艺制备 。例如,通过原位切换化学气相供应的两步热 CVD 工艺可以合成 WS2 -WSe2和 MoS2 -MoSe2横向异质结构。具体而言,为了制备 WS2 -WSe2异质结构,首先通过热汽化固体 WS2源在 SiO2 衬底上生长 WS2畴;接下来,在不将 WS2畴暴露于环境条件下原位切换化学气相源为 WSe2,使 WSe2在外围活性生长前沿继续横向异质外延生长,形成 WS2 -WSe2横向异质结构。与此同时,通过一步或两步 CVD 方法成功实现了一系列具有特定组合的双块 TMD 横向异质结构,包括 MoSe2 –WSe2、WS2 –MoS2和 MoS2 –WSe2。
原则上,这种横向外延生长过程可以重复多次,以实现多异质结构或超晶格的逐块生长。
然而,仅包含一个原子层或几个原子层的二维晶体通常非常脆弱,对高温下合成条件的变化几乎没有耐受性。在多异质结构或超晶格的连续生长中,反复切换不同的化学气相源和/或生长条件很容易导致原子层的严重退化或完全蚀刻。因此,原子级薄的二维异质结构的生长从根本上比具有更多原子层的其他块或纳米级异质结构的生长更具挑战性。为了应对这一挑战,设计了一种改进的热 CVD 工艺(图2a),在连续生长步骤之间的温度波动阶段,从基底到源有反向氩气流,以冷却和保护现有块。在此过程中,仅在特定的生长温度和条件下施加来自化学气相源的正向流。在温度变化过程中,反向流动不断用冷氩气冲洗生长基底上现有的单层材料,以减少高温暴露并最大限度地减少热降解。温度上升阶段的反向流动还可以防止在非所需温度下意外供应化学蒸汽源,并消除不受控制的均质成核。由于每个步骤都具有这种高度可控性,因此可以在多个连续生长步骤后保持单层异质结构的完整性和质量,从而建立了一种通用可靠的策略,用于生长各种异质结构、多异质结构和超晶格(图2b-d),具有原子级清晰和干净的界面(图2e)。

图 2:二维横向异质结构和超晶格的合成。a 、用于横向异质结构和超晶格稳健外延生长的改进 CVD 系统示意图。b - d、合成的 WS2 –WSe2 –MoS2(b)和 WS2 –MoSe2 –WSe2(c)横向异质结构以及 WS2 –WSe2 –WS2 –WSe2 –WS2横向超晶格(d)的拉曼映射。350 cm −1、250 cm −1、405 cm −1和 240 cm −1分别是 WS2、WSe2、MoS2和 MoSe2的特征拉曼峰。e 、WS2 –WSe2异质结构的高分辨率 STEM 图像(顶部)。上图(左下图)红框中标记的放大 STEM 图像和相应的原子模型图(右下图)。f,用于生长横向超晶格的一锅 CVD 系统示意图。g – i ,MoSe2 –WSe2 ( g )、MoS2
–WS2 ( h )和合金 MoS0.64Se1.36 –WS0.68Se1.32 ( i )横向超晶格的光致发光映射。单层 WSe2、MoSe2、WS2、MoS2、合金 MoS0.64Se1.36和 WS0.68Se1.32的带隙分别为 1.6 eV、1.52 eV、1.97 eV、1.84 eV、1.61 eV 和 1.71 eV . j,MOCVD 生长的 TMD–TMD 横向超晶格示意图。k , WS2 –WSe2横向超晶格的扫描电子显微镜图像. l ,WS2 –WSe2 MMH横向内外延生长示意图。m – p ,单层 WS2 –WSe2的光致发光映射(m代表 WS2和n代表 WSe2 ) 和 WS2 –MoS2 ( o代表 WS2而p代表 MoS2
) MMHs 。
与此同时,报道了一种用于生长二维横向超晶格的“一锅生长法” 。在这种情况下,使用由 MoX2和 WX2组成的混合固体源,并且每个 TMD 的选择性生长由载气控制(图2f )。N2 /H2O混合物促进 MoX2的生长;而 Ar/H2促进 WX2的生长并抑制 MoX2的生长。因此,只需在生长过程中切换载气即可合成超晶格,而无需更换固体源或反应器(图2g-i)。然而,很难立即切换化学源,因此所得异质结构通常表现出合金界面,而不是原子级锋利界面。
MOCVD 工艺也已用于合成相干横向 WS2 -WSe2超晶格(图2j、k)。与固体源 CVD 相比,MOCVD 在更好地控制多种化学前体的引入和快速切换方面具有内在优势。值得注意的是,超晶格中每个组件的宽度可以精确调整到纳米级尺寸,从而能够精确设计具有可调应变和光学特性的 2D 异质结构和超晶格。
除了典型的同心异质结构或超晶格之外,单层 TMD 横向异质结构阵列的生长代表着朝着在集成电子和光电子器件阵列中采用 2D 异质结构迈出的关键一步。异质结构阵列可以通过将光刻图案化与横向外延生长工艺相结合来实现。为此,以原子级精度可扩展地制备 2DAC 模板是生产单层横向异质结构阵列的重要先决条件。然而,传统光刻通常会导致相对粗糙的边缘配置,这与具有原子级锋利界面的异质结构不兼容,并且很容易在 2DAC 表面造成不良残留物或损坏,这些残留物或损坏可能成为多层材料高度异质生长的不良成核位点。为了应对这一挑战,我们开发了一种激光图案化和各向异性热蚀刻工艺,以生产图案化的 2DAC 阵列,以实现单层镶嵌异质结构 (MMH) 阵列48的可扩展生长(图2l)。在该方法中,通过激光图案化工艺产生的点缺陷处的受控热蚀刻,在单层 TMD 中产生具有原子级清晰边缘的周期性三角形孔。这些边缘作为第二个 TMD 内外延生长的专用成核位点,产生具有原子级清晰异质结界面的各种横向 MMH(如 WSe2 –WS2、MoS2 –WS2和 MoS2 –WSe2)。系统的微观结构和光谱表征揭示了整个镶嵌异质结构中的化学成分、晶格应变和电子带隙的周期性调制(图2m-p )。还通过将图案化 MoSe2中的 Se 原子替换为 S 原子,制备了图案化 MoS2 –MoSe2横向异质结构阵列(参考文献49)。
垂直异质结构和莫尔超晶格的合成
除了横向集成的异质结构和超晶格外,大规模垂直堆叠的范德华 (vdW) 异质结构 (vdWH) 和具有高质量界面的超晶格也引起了人们的极大兴趣,因为它们可用于调整电子和光电特性以及创建功能设备
。尽管已经使用剥离和重新堆叠工艺制备了各种各样的垂直异质结构,但开发一种基于 TMD 的垂直异质结构的更大规模合成方法将是将其潜在地集成到实际技术中的重要一步。
采用由 W-Re 合金箔支撑的单晶 Au (111) 箔组成的设计衬底,实现了 100% 重叠的ReS 2 /WS 2垂直异质结构的一步式 CVD 合成。这种孪生生长可归因于由不同前体分子和外延衬底之间的吸附能差异引起的选择性外延。连续两步 CVD 生长法也已用于制备尺寸高达 169 μm 的 WSe2/MoSe2 vdWH。CVD 生长过程通常可产生具有明确 vdW 外延关系和干净 vdW 界面的 vdWH,从而产生具有强层间耦合和高效层间电荷传输的0° 或 60°(定义为 AA 或 AB)堆栈。最近的研究表明,衬底缺陷可能在六方氮化硼 (hBN) 衬底上 TMD 的单向生长中起着重要作用55 , 56。例如,使用高角度环形暗场扫描透射电子显微镜 (HAADF-STEM) 直接观察到单个 W 原子稳定地被捕获在单个空位上的 hBN 表面,这与缺陷辅助成核模型一致。
总的来说,2D TMD 的原子级光滑表面使其成为生产大面积超薄 2D 材料的优良模板,包括金属碲化物、半导体 SnS2、铁磁 CrSe2和非层状材料(NiSe,这些材料在常规 SiO2 /Si 衬底上很难获得,并且可以提供高质量的垂直 vdWH。例如,在相同的生长条件下,在 WSe2衬底上生长的金属 NbTe 2纳米片是均匀的单层(~1.0 纳米),而在 SiO2 /Si 衬底上的金属 NbTe 2 纳米片显示出相对较宽的厚度分布,范围从几纳米到几百纳米。在 vdW 外延过程中,WSe2的原子级光滑、无悬挂键的表面可以有效削弱吸附原子和生长衬底之间的相互作用。这确保了表面扩散的较低能垒,从而导致迁移系数高于SiO2/Si基底上的迁移系数,有利于超薄二维纳米片的快速横向生长。
除固源热CVD外,过渡金属或金属氧化物薄膜的硫属元素化提供了另一种制备大面积垂直TMD异质结构的方法。具体而言,制备通常包括多步连续沉积不同的金属膜,然后进行一步硫化/硒化。然而,高温硫化/硒化过程中热刻蚀和界面合金化是不可避免的。为此,最近有报道称采用逐层生长模式,通过硫化(或硒化)薄金属膜来生长多层垂直范德华金(图3a -c)。在该设计中,连续进行多个两步生长循环(沉积一层金属膜,然后进行硫化/硒化过程),以制备多层范德华金薄膜。为避免热刻蚀和合金形成,生长顺序必须遵循2DAC的生长温度,严格遵循从高温到低温的温度顺序。通过这种方法,可以精确控制 vdWH 中 2DAC 的层数,从而产生一系列双块、三块、四块甚至五块 vdWH 薄膜。

图 3:二维垂直异质结构和莫尔超晶格的合成。a、高低温策略引导下多块 vdWH 堆叠生长示意图。b 、晶圆级五块 vdWH(PtTe2 /NbSe2 /MoSe2 /MoS2 /WS2)的光学显微镜图像。c 、蓝宝石上堆叠生长的双块 vdWH 的光学显微镜图像,由底部的单层(1L)MoS 2和顶部的3L NbSe2组成。插图显示了相应的原子模型图。d 、
由晶格失配层堆叠产生的莫尔超晶格示意图。e – g,由外延生长的 vdW 异质双层 SnS2 /WSe2(3.34 nm;e)、CrSe2 /WSe2(3.63 nm;f)和 VSe2 /WSe2(14.7 nm;g )产生的莫尔超晶格。e – g中的黄色虚线表示 2×2 莫尔周期,其中一个莫尔周期( L )的值分别为 3.4 nm、3.63 nm 和 14.7 nm 。h ,扭曲双层 (TB)-MoS2的原子结构示意图。i,原生 TB-MoS2的光学显微镜图像,扭曲角从0° 到120 °。比例尺,10 μm。j、 相称超晶格(顶部)和相应的 86.9°-TB-MoS2原子模型(底部)的原子分辨率 HAADF-STEM 图像。插图是相应的快速傅里叶变换图案。白色菱形表示莫尔周期为 0.7 纳米。k 、 欧几里得和非欧几里得几何示意图。左:对于欧几里得曲面上的三角螺旋,在每个顶点处边缘方向改变 120°;因此,在三个顶点之后,它会旋转 360°,这使得边缘与其原始方向平行。右:对于展开的非欧几里得圆锥曲面上的三角螺旋,每三个顶点之后,边缘就会与虚线相交一次,因此它需要额外旋转一个角度才能保持笔直。l 、在平坦的 SiO2 /Si 基底上生长的取向 WS 2螺旋的原子力显微镜(左上和左下)和光学显微镜(右下)图像。m,在 SiO2 /Si 基底上,围绕 WOx粒子生长的具有扭转角的代表性 WS 2超扭转螺旋的原子力显微镜(左上和左下)和光学显微镜(右下)图像。n , 超扭转 WS2板的 HAADF 图像,不同层的边缘以不同的灰色突出显示。o ,从n 中的三层区域收集的高分辨率 HAADF 和选区电子衍射图像。PACBED,位置平均会聚束电子衍射。
垂直堆叠两个或多个具有晶格失配或扭曲角的原子级薄层可形成周期性超晶胞;即莫尔超晶格。莫尔超晶格提供了一种高度可调的策略,可以在比原子晶格大得多的规模上定制周期性电位调制,从而可实现可调的电荷相关性和奇异的物理特性——正如在扭曲双层魔角石墨烯中观察到的非常规超导性所强调的那样 。类似地,在异质双层或扭曲 TMD 中形成的周期性莫尔超晶格也在调节电子能带结构和产生一系列有趣的物理现象方面发挥着关键作用 。通过CVD 方法直接生长的异质双层 TMD 通常不扭曲,但从热力学上讲有利于 2H 或 3R 堆叠。尽管如此,具有不同晶格参数的各种 TMD 可以在外延生长的 vdW 异质双层中容易地产生超晶胞尺寸差异很大的莫尔超晶格(图3d-g),包括 SnS
2 /WSe2(3.63 nm)(图3e)、CrSe2 /WSe2(3.63 nm)(图3f)和 VSe2 /WSe2(14.7 nm)(图3g)。有趣的是,通过生长具有不同 S/Se 比和可控晶格失配的 WSy Se2- y /WSx Se2- x vdWH,最近的一项研究实现了超晶胞尺寸从 10 到 45 nm 的广泛可调的莫尔超晶格。
由于夹层的旋转,形成扭曲双层 TMD 存在相当大的能量壁垒。为了解决这一挑战,最近的一项研究将元素锡 (Sn) 引入 CVD 系统以降低夹层旋转能量,从而生成扭曲双层 WS2和WSe2。随后,提出了一种重构成核 CVD 策略,用于直接合成扭曲双层 MoS2,其扭曲角范围从 0° 到 120°(图3h 、i)。可以清楚地观察到扭曲角相关的莫尔超晶格,并且层间耦合与扭曲角表现出很强的关系(图3j)。然而,双层 TMD 尚未实现设计的扭曲生长。
超扭曲螺旋生长为制备扭曲多层TMDs 提供了另一种有前途的方法。螺位错是一种线缺陷,它沿特定方向剪切部分晶格。在层状材料中,剪切通常发生在面外方向,并将各层连接成一个连续的层。当螺位错螺旋发生在具有欧几里得表面的平面基板上时,会形成边缘对齐的非扭曲三角螺旋形状(图3k左图和图3l)。有趣的是,一旦采用具有弯曲几何空间的非欧几里得表面,就可以产生WS2的超扭曲螺旋(图3k右图和图3m)。具体而言,当vdW晶体在具有非欧几里得几何形状的圆锥表面上生长时,它会沿着圆锥的曲率弯曲。对于每个周期,新边缘都会相对于上一个周期的边缘扭转一个角度。通过设计非欧几里得表面的形状,也可以实现具有较大且可变扭转角度的连续扭转超结构,正如莫尔超晶格的形成所证实的那样(图3n-o)。
垂直超晶格的合成
由于需要在新原子层的生长和先前层的热蚀刻之间建立微妙的平衡,因此直接 CVD 生长具有三个或更多组成块的高阶垂直异质结构或超晶格是一项相当大的挑战。为此,MOCVD 工艺已显示出直接生长由 MoS2、WS2和 WSe2单层异质外延堆叠而成的范德华超晶格 (vdWSL) 的潜力。
在每个生长步骤拍摄的一系列横截面 STEM 图像展示了 WS2和 MoS2的精确单层堆叠(图4a)。然而,由于金属有机前体的可用性有限,目前 MOCVD 方法仅限于 MX2(M = Mo,W;X = S,Se)体系。
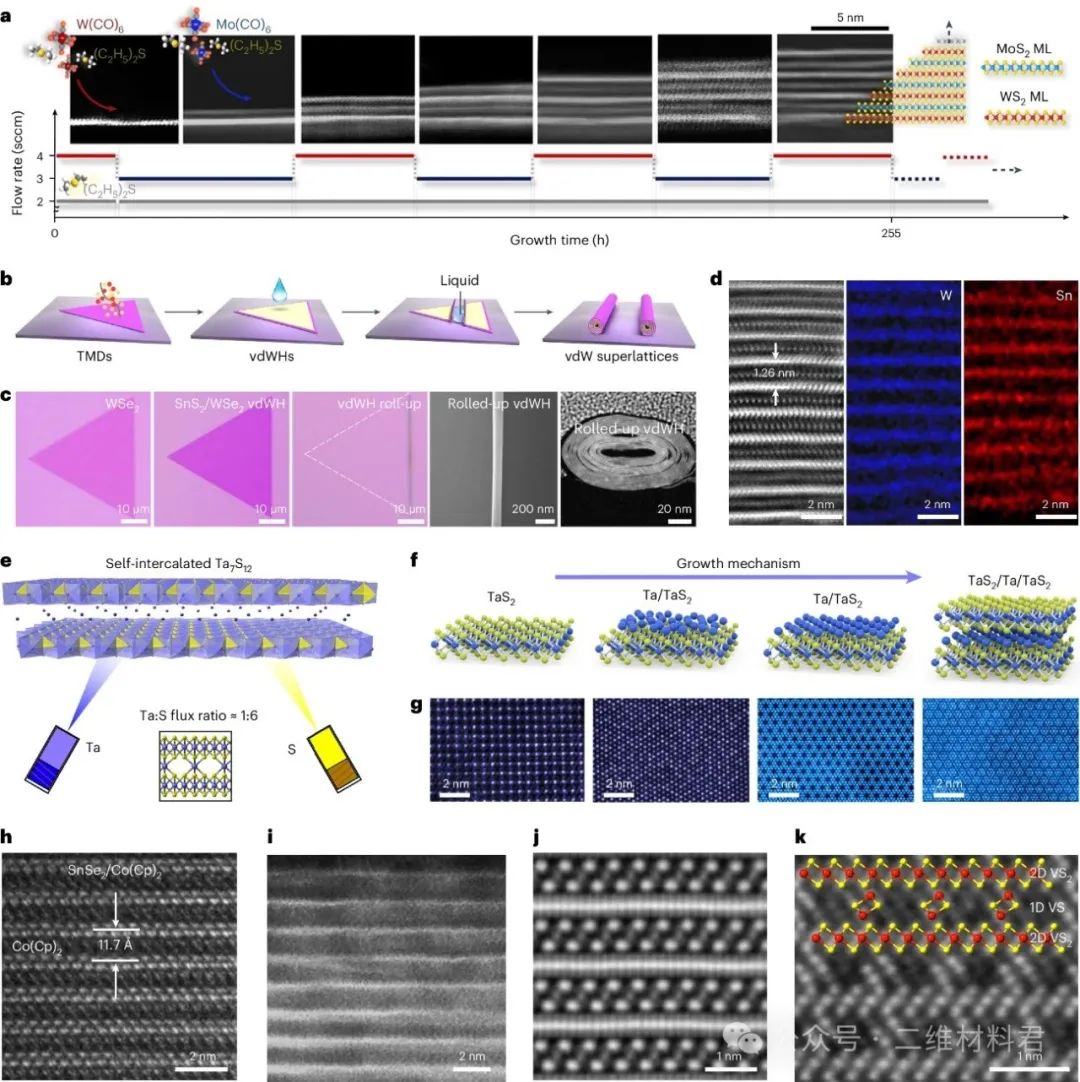
图 4:二维垂直超晶格。a、顶部:MOCVD 生长的 MoS2 /WS2超晶格(右)和一系列来自 1 至 7 ML 堆栈的 MoS2/WS2 超晶格的横截面 HAADF-STEM 图像(左)。底部:用于生长 MoS2/WS2超晶格的 MO 前体的流速调节b、c、卷起的 vdW 超晶格制造过程的示意图。d 、卷起的 SnS2 /WSe2 vdWSL 的结构表征,包括横截面 STEM 图像(左)和相应的 W(中)和 Sn(右)能量色散谱。e 、显示在高 Ta 通量环境中通过分子束外延生长自插层 Ta7S12的示意图。 f、 示意图描绘了 2D 晶体集成电路的逐层生长。g 、 2D 晶体的原子分辨率 STEM 图像(从左到右)25% Ta 插层 Ta9 S16、50% Ta 插层 Ta10S16、66.7% Ta 插层 Ta8Se12和 100% Ta插层 Ta9Se12。h 、 SnSe2 /Co(Cp)2超晶格纳米薄片的 HAADF-STEM 图像。i 、 TaS2 /MBA 超晶格的高分辨率横截面 STEM 图像。明亮区域对应于 H-TaS2单层。j、 NbS2/Ba3NbS5超晶格的 HAADF-STEM 图像。k 、2D VS2 –1D VS 超晶格的横截面 ADF 图像。
与逐层生长的方法不同,卷起大面积 vdWH 提供了一种生产具有更多交替单元的高阶 vdWSL 的替代方法(图4b、c)。例如,当 CVD 生长的 SnS2 /WSe2 vdWH 暴露于乙醇-水-氨溶液时,2D 异质结构和基底之间的溶剂分子插入使 vdWH 从基底上剥离,并驱动自发卷起过程,形成由单层 WSe2和单层 SnS2 交替层组成的卷起结构(图4d)。vdWSL 中单层 SnS2和单层 WSe2之间的距离(0.63nm)与本征层间距离基本相同,表明 vdW 界面质量高,层间污染很少。这种卷起策略可以扩展以产生各种 2D/2D vdWSL 和更复杂的三组分 2D/2D/2D vdWSL,以及由 2D 与 3D 或 1D 材料混合组成的多维 vdWSL。由此产生的具有可变尺寸和成分的高阶 vdWSL 具有高度可调的能带排列和手性,为基础研究和技术应用提供了一个有趣的材料平台。
实现高阶二维超晶格的另一种策略是将选定的原子或分子物种插入层状晶体。例如,可以通过 CVD 或分子束外延79直接实现天然原子自插入层状 TMD(图 4e)。富金属化学势为金属自插入层状材料提供了驱动力。通过改变插入原子的比例,可以生长具有不同插入 Ta 浓度的 Ta




